Применение ионизирующего излучения для ускоренных испытаний на надежность моп интегральных микросхем
На правах рукописи
Чжо Ко Вин
ПРИМЕНЕНИЕ ИОНИЗИРУЮЩЕГО ИЗЛУЧЕНИЯ
ДЛЯ УСКОРЕННЫХ ИСПЫТАНИЙ НА НАДЕЖНОСТЬ
МОП ИНТЕГРАЛЬНЫХ МИКРОСХЕМ
05.27.01. – «Твердотельная электроника, радиоэлектронные компоненты, микро- и наноэлектроника, приборы на квантовых эффектах»
Автореферат
диссертации на соискание ученой степени
кандидата технических наук
Автор:
МОСКВА – 2013 г.
Диссертация выполнена в Национальном исследовательском ядерном университете «МИФИ»
Научный руководитель:
доктор технических наук
Попов Виктор Дмитриевич
профессор кафедры «Микро- и наноэлектроники»
НИЯУ «МИФИ», г.Москва
Официальные оппоненты: доктор технических наук,
профессор кафедры «Полупроводниковая электроника» Национального исследовательского университета «МЭИ»
Гуляев Александр Михайлович
кандидат технических наук,
ведущий специалист,
ОАО «Научно-исследовательский институт молекулярной электроники и завод «Микрон»
Вавилов Владимир Алексеевич
Ведущая организация:
ОАО «Научно-исследователький институт космического приборостроения»
Защита состоится ________________ г. в _______час______мин на заседании диссертационного совета Д 212.130.02 в Национальном исследовательском ядерном университете «МИФИ» по адресу: 115409, Каширское шоссе, 31. Телефоны: 8 499 84 98, 8 499 323 91 76.
С диссертацией можно ознакомиться в библиотеке Национального исследовательского ядерного университета «МИФИ».
Ученый секретарь
диссертационного совета,
доктор технических наук,
профессор Скоробогатов П.К.
Общая характеристика работы
Актуальность темы диссертации. В настоящее время остро стоит проблема обеспечения нормального функционирования бортовой аппаратуры космических объектов в течение 10 - 15 лет, а в перспективе 20 лет при воздействии ионизирующего излучения космического пространства. При этом значительную долю электронной компонентной базы (ЭКБ) составляют МОП приборы и МОП интегральные микросхемы (ИМС). Надо отметить, что наибольшее распространение получили комплементарные МОП ИМС (КМОП ИМС), которые построены на МОП транзисторах с п-каналом и р-каналом и которые обладают рядом существенных достоинств (низкая потребляемая мощность при достаточно высоком быстродействии, помехоустойчивость, масштабируемость). Поэтому сроки хранения и нормального функционирования КМОП ИМС представляют огромный интерес.
На первом этапе эксплуатации КМОП ИМС наблюдается повышенная интенсивность отказов из-за технологических дефектов. Для снижения интенсивности отказов на этом этапе используются методы отбраковки ненадежных изделий. При применении высококачественных изделий (класса «Space») интенсивность отказов ЭКБ значительно снижается, что позволяет обеспечивать длительное функционирование на втором этапе «жизненного цикла». На третьем этапе имеет место процесс старения, в котором наблюдается ухудшение параметров изделий, что приводит к отказу аппаратуры.
Исследования воздействия низкоинтенсивного облучения, в результате которых наблюдался рост плотности поверхностных состояний на границе раздела Si-SiO2, проводились как в нашей стране (см., например, работы [1] и [2]), так и за рубежом (см., например, [3] и [4]). Но с позиций надежности этот эффект не рассматривался.
Поэтому изучение радиационно-стимулированных процессов старения МОП ИМС является актуальной проблемой. Особенно это касается применения МОП ИМС в условиях длительного низкоинтенсивного воздействия ионизирующего излучения (ИИ).
До настоящего времени проверка качества микросхем осуществляется с помощью проведения ускоренных испытаний при повышенной температуре, в то время как радиационные испытания проводятся при нормальной температуре в условиях низкоинтенсивного воздействия ИИ. Поэтому остается неясным соответствие результатов, полученных в случае ускоренных испытаний при повышенных температурах, результатам радиационных испытаний при нормальных условиях и низкоинтенсивном облучении.
Целью настоящей работы является прогнозирование отказов МОП ИМС в период старения в условиях воздействия низкоинтенсивного ионизирующего излучения на основе использования ускоренных испытаний при повышенной температуре.
Для достижения поставленной диссертационной работе цели необходимо решить следующие основные задачи:
- Провести анализ результатов исследований образования поверхностных дефектов в широком диапазоне мощностей доз и длительностей воздействия ионизирующего излучения.
- Провести длительные исследования процесса образования поверхностных дефектов в условиях низкоинтенсивного воздействия ионизирующего излучения.
- Уточнить модель образования поверхностных дефектов при длительном воздействии ионизирующего излучения.
- Провести длительные испытания в условиях низкоинтенсивного воздействия ионизирующего излучения
- Провести ускоренные испытания при повышенной температуре и сопоставить их результаты с результатами радиационных испытаний при низкоинтенсивном облучении ионизирующим излучением.
Основные положения и результаты, выносимые на защиту:
- Физическая модель процесса старения при длительном низкоинтенсивном воздействии ионизирующего излучения;
- Метод использования кольцевых генераторов для прогнозирования отказов при испытании на надежность;
- Метод установления соответствия между ускоренными испытаниями при повышенной температуре и при низкоинтенсивном воздействии ионизирующего излучения.
Научная новизна:
- Предложен новый «надежностный» подход к анализу результатов радиационных испытаний при низкоинтенсивном воздействии ионизирующего излучения, позволяющий выявить два этапа радиационно-стимулированного процесса старения;
- Предложена физическая модель процесса старения при длительном (более ~1000 часов) низкоинтенсивном воздействии ионизирующего излучения, включающая два этапа накопления дефектов на границе раздела Si-SiO2.
- Применены впервые кольцевые генераторы для длительных испытаний в условиях низкоинтенсивного облучения и при повышенной температуре;
- Предложена методика сопоставления результатов испытаний при повышенной температуре и при длительном низкоинтенсивном воздействии ионизирующего излучения.
Практическая значимость.
- Установлена связь между ускоренными испытаниями при повышенной температуре и низкоинтенсивном облучении. Получено, что низкоинтенсивное облучение не дает выигрыша во времени, но дает большой экономический эффект.
- Выбран режим переключения при низкоинтенсивном облучении и предложена методика прогнозирования отказов КМОП ИМС с использованием экспоненциальной функции, описывающей изменение минимального напряжения функционирования кольцевых генераторов.
- Применение методики измерения минимального напряжения питания кольцевого генератора использовано при испытаниях КМОП ИМС серии 1582.
- Применение физической модели образования поверхностных дефектов позволит прогнозировать отказы МОП ИМС на этапе старения.
Апробация диссертации.
Основные результаты диссертационной работы докладывались и обсуждались на научном семинаре кафедры Микро- и наноэлектроники в 2013 году, на конференции «Твердотельная электроника, сложные функциональные блоки РЭА» в 2011году, на 43-ем международном научно-методическом семинаре «Флуктуационные и деградационные процессы в полупроводниковых приборах» в 2012 году, на научной сессии НИЯУ МИФИ в 2013 году, а также на всероссийских научно-технических конференциях «Стойкость-2011», «Стойкость-2012» и «Стойкость-2013».
Публикации.
По материалам диссертации опубликовано 14 работ, в том числе 6 статей в журналах, рекомендованных ВАК РФ.
Объем и структура диссертации.
Диссертация состоит из четырех глав, заключения и пяти приложений с общим объемом 99 страниц, включая 47 рисунков, 8 таблиц и список используемой литературы из 51 наименований.
СОДЕРЖАНИЕ РАБОТЫ.
Во введении обоснована актуальность темы, сформулированы цели исследования и основные задачи, решаемые в диссертационной работе. Отмечается актуальность прогнозирования процесса старения.
В первой главе отмечается необходимость использования ускоренных испытаний КМОП ИМС. Наиболее широко применяются ускоренные испытания при повышенной температуре. Однако представляет интерес использование радиационного воздействия для ускорения процесса старения. Этот процесс проявляется прежде всего в КМОП ИМС в образовании поверхностных состояний на границе раздела кремний-оксид кремния в МОП транзисторах. Поэтому в данной главе приводится обзор моделей процессов образования поверхностных состояний при низкоинтенсивном воздействия ионизирующего излучения.
Образование поверхностных состояний в МОП структуре при воздействии ионизирующего излучения согласно моделям отечественных ученых может проходить двумя путями. Общим моментом всех моделей является ионизация диэлектрика и перемещение дырок, образованных в объеме подзатворного оксида, к границе раздела с кремнием с последующим попаданием в приповерхностную область оксида кремния.
Далее по модели, описанной в [1], происходит туннелирование дырки в приповерхностную область кремния, «всплывание» и захват ее на уровень напряженной связи. В результате образуется дефект, называемый «поверхностным состоянием» Параллельно может происходить процесс, обусловленный ионизацией К-оболочек кремния в приповерхностной области. Эта модель показана на рис. 1.

Рис.1. Образование поверхностных состояний при ионизации пленки оксида и при ионизации К-оболочки кремния: образование дырки (1), движение дырки к границе раздела Si-SiO2 (2), переход дырки в валентную область кремния (3), захват на уровень напряженной связи (4) и образование дефекта (5) [1]
По модели, описанной в [2] и названной «конверсионной моделью», образовавшиеся дырки в оксиде при воздействии ионизирующего излучения двигаются к границе с кремнием и захватываются на уровни дефектов, уровни которых располагаются в пределах запрещенной зоны кремния. Причем дырки, захваченные вблизи границы раздела с кремнием конвертируются поверхностное состояние за короткое время, а для дырок, захваченных в глубине пленки оксида, требуется длительный период времени. Модель иллюстрируется на рис.2.
![Конверсионная модель образования поверхностных состояний [2] В-1](/images1/421370/konversionnaya-model-obrazovaniya-p.png)
Рис.2. Конверсионная модель образования поверхностных состояний [2]
В зарубежной литературе отдается предпочтение «водородной» модели [3]. Согласно этой модели в пленке оксида кремния нейтральный атом водорода Н0 при воздействии ионизирующего излучения захватывает образовавшуюся дырку h и становится протоном Н+
Н0 + h Н+.
Поскольку не все атомы водорода ионизируются, то, наблюдаются два процесса. При LT-процессе имеет место диффузия нейтральных атомов водорода, которые на границе раздела SiO2-Si участвуют в реакции
Si – H + H0 Si· + H2
и образуют рb-центр.
рb
Этот процесс протекает очень медленно. Второй HT-процесс проходит с участием реакции (3) и реакции
Si – H + H+ + е- Si· + H2
и также образует рb-центр.
рb
Таким образом, имеются два процесса образования поверхностных состояний – медленный (LT) и быстрый (НТ). В обоих случаях образуется так называемый рb – центр (рис.3).
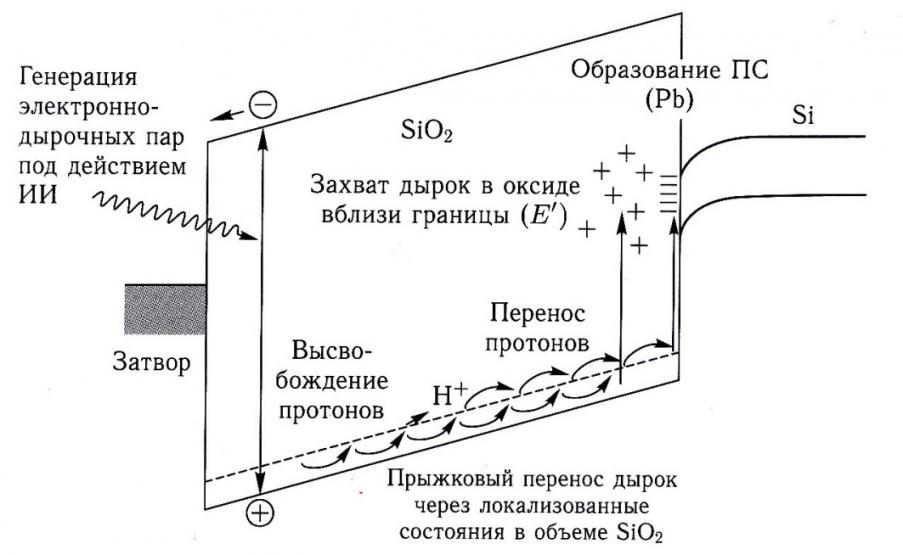
Рис.3.Процесс образования поверхностных состояний с участием водорода[3]
В обзоре также уделяется внимание «водородным разновидностям» (Н2, ОН-, Н2О, которые также принимают участие в образовании поверхностных состояний на границе раздела кремний-оксид кремния.
Все описанные выше процессы описываются экспоненциальной зависимостью вида
![]() ( 1 )
( 1 )
где (Nit)H – плотность ПС при насыщении, – параметр, характеризующий скорость поверхностного дефектообразования.
Во второй главе проведено исследование образования поверхностных дефектов при воздействии низкоинтенсивного гамма-излучения. Гамма-излучение является основным средством исследования долговременных радиационных эффектов в МОП приборах и интегральных микросхем на их основе.
В данной работе предлагается «надежностный» подход, который позволяет рассматривать радиационные эффекты в МОП транзисторах (МОПТ) как процесс, протекающий во времени t при воздействии ионизирующего излучения с мощностью дозы Р. В этом случае поглощенная доза D=P·t характеризует интегральную поглощенную энергию.
Анализ зарубежных работ по длительному облучению МОП транзисторов показал [4], что наблюдается возрастание плотности поверхностных состояний во времени при разных мощностях дозы. На рис.4 показано, что при снижении мощности дозы резко увеличивается уход порогового напряжения МОПТ как при дозовом (рис.4,а), так и при «надежностном» подходе (рис.4,б). В этом случае увеличение плотности поверхностных состояний можно описать выражением вида
 (2)
(2)
в котором (Nit)H – плотность поверхностных состояний (ПС) при насыщении «дозового» процесса, – параметр, характеризующий скорость образования поверхностных состояний, Nit*(t) - составляющая «временнго» процесса (дополнительные поверхностные дефекты -ПД).
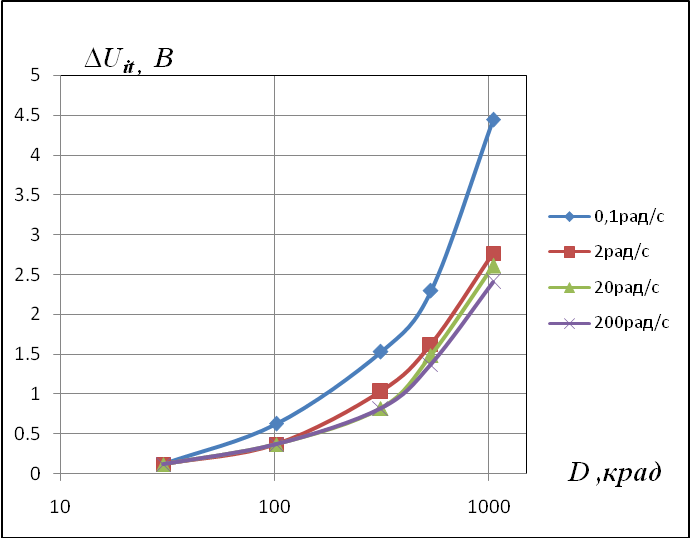
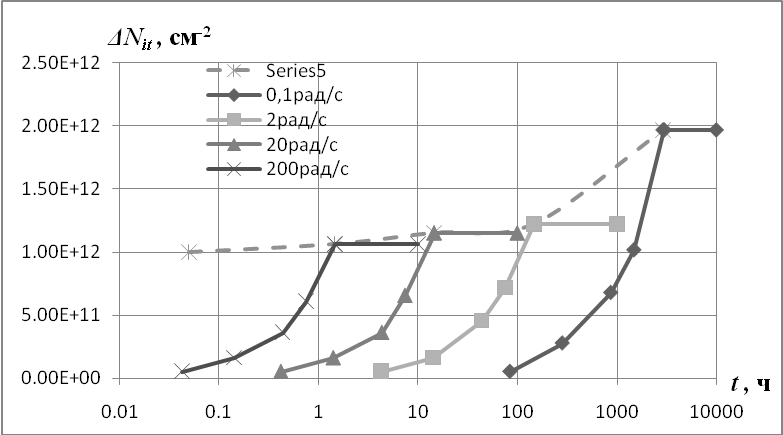
(а) (б)
Рис.4. Изменение сдвига порогового напряжения МОП транзистора (а), вызванного поверхностными дефектами, плотности поверхностных состояний и дополнительных дефектов (б) при разных мощностях дозы для образцов подзатворного оксида с толщиной 100 нм
Изменение плотности поверхностных дефектов при снижении мощности дозы сначала медленно возрастает, а затем при больших временах облучения резко увеличивается. Для изучения этого эффекта были проведены длительные облучения при разных мощностях дозы гамма-излучения. Облучение проводилось в вертикальном канале шахты-хранилища реактора ИРТ МИФИ. Источником гамма-излучения являлся изотоп Cs137. Измерения стоко-затворных характеристик производилось в широком диапазоне токов с использованием анализатора полупроводниковых приборов Agilent Technologies B1500A. Для определения плотностей поверхностных дефектов использовался метод подпороговых токов [5].
На первом этапе экспериментального исследования использовались КМОП ИМС типа 564ЛА9. Экспериментальные результаты показали (рис.5), что с уменьшением мощности дозы снижается сдвиг порогового напряжения Uot, вызванный зарядом в оксидных ловушках и возрастает плотность поверхностных ловушек Nit. Кроме того, наблюдается дополнительный рост Nit за счет Nit*.
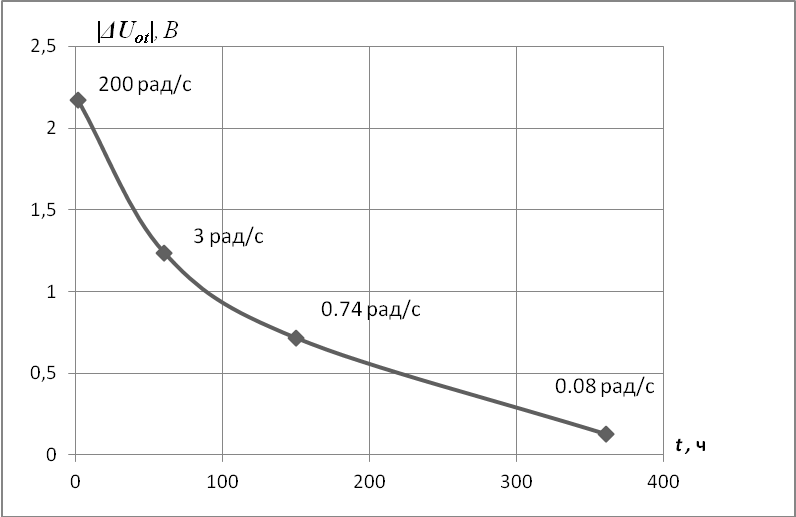
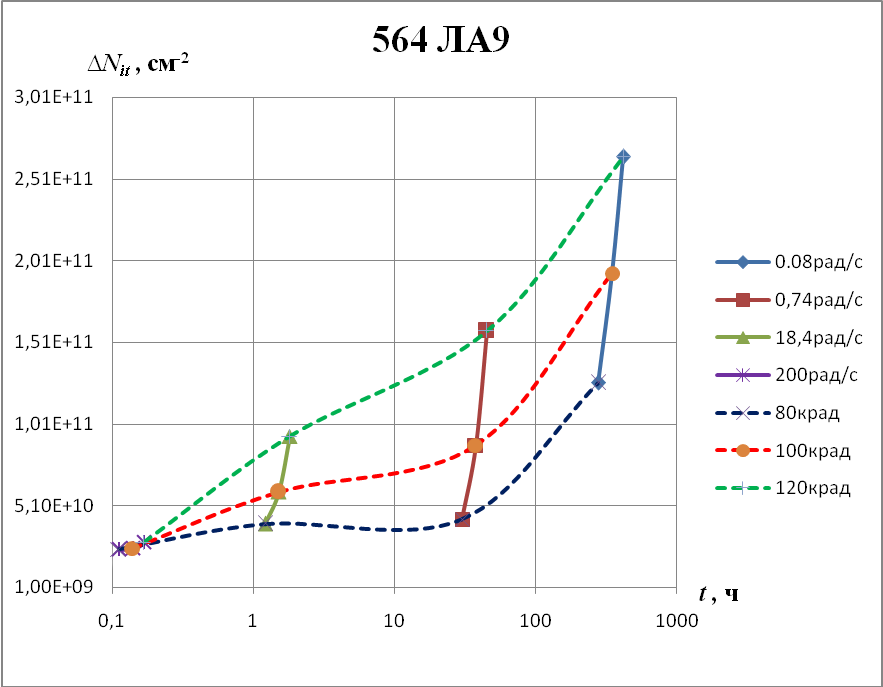
(а) (б)
Рис. 5. Изменение Uot (t, P) (а) и Nit(t, P) (б) при разных мощностях дозы
На втором этапа экспериментальных исследований проводили облучение МОП транзисторов в КМОП ИМС серии 1526 в режиме хранения и в режиме переключения. Использование метода подпороговых токов позволило получить зависимость плотности поверхностных дефектов от времени облучения при мощности дозы Р=0,1 рад/с. Указанные зависимости представлены на рис.6. Как можно видеть, и в случае облучения в пассивном режиме (а) и в режиме переключения (б) наблюдаются 2 этапа поверхностного дефектообразования.
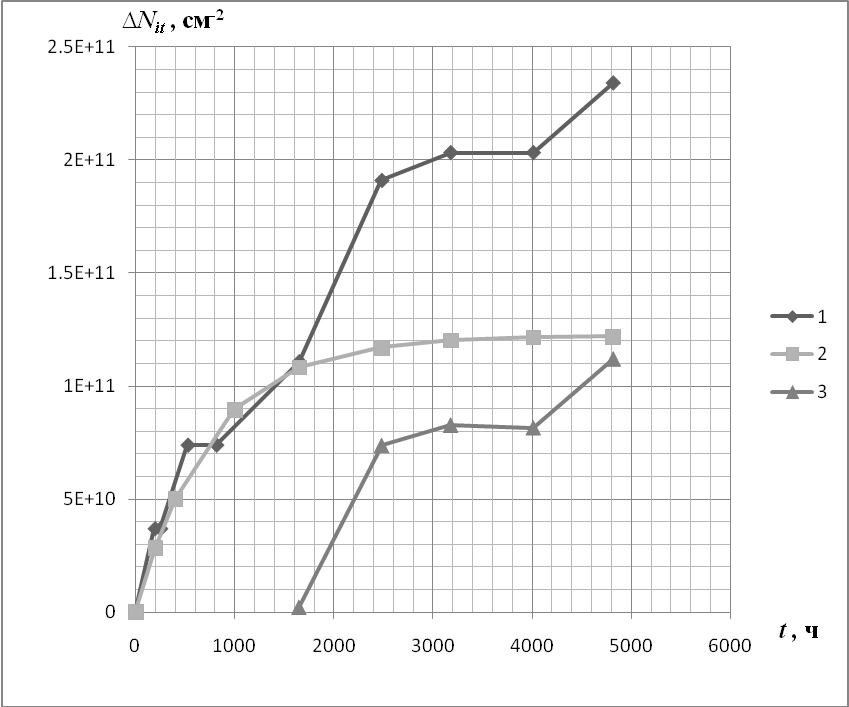

(а) (б)
Рис.6. Изменение средней плотности поверхностных дефектов во времени при Р=0,1 рад/с в пассивном режиме: (1) – общая зависимость, (2) – изменение плотности ПС, (3) – изменение плотности ПД
Таким образом, при длительном низкоинтенсивном облучении гамма-лучами как в пассивном режиме, так и в режиме переключения имеет место два этапа поверхностного дефектообразования.
Для выяснения роли объема оксидной пленки в данной работе был проведен эксперимент, в котором исследовались тестовые КНИ п-канальные МОП транзисторы с толщиной пленки оксида dox=6,8 нм на островке кремниевой пленки толщиной dSi = 200 нм. Использовались тестовые транзисторы п-типа, изготовленные по технологии 0,35 мкм с длиной канала 0,35 мкм и шириной канала 18,7 мкм. Облучение образцов проводилось при мощности дозы Р=0,1 рад/с в пассивном режиме.
Используя метод подпороговых токов, были определены зависимости плотности поверхностных дефектов от времени облучения. На рис.7 представлена средняя зависимость Nit(t), полученная при Р=0,1 рад/с (кривая 1). Наличие изгиба на этой зависимости свидетельствует о двух этапах образования поверхностных дефектов. На рис.7 так же показаны рост плотности поверхностных состояний (кривая 2) и дополнительных поверхностных дефектов (кривая 3).

Рис.7.Изменение плотности поверхностных дефектов во времени при облучении гамма-лучами с мощностью дозы Р=0,1 рад/с.
Результаты экспериментов показали, что поскольку толщина пленки оксида снижает роль дефектов оксида, то дополнительные дефекты появляются со стороны кремния.
В работе предложена физическая модель образования «дополнительных» поверхностных дефектов, которые возникают в кремнии и мигрируют к границе раздела кремний-оксид кремния. В образовании дефектов кремния участвуют комптоновские электроны. Основное внимание уделяется «подпороговому» дефектообразованию в кремнии [6].
Из области «подпорогового» дефектообразования в объеме кремния образовавшиеся дефекты мигрируют в приповерхностную область кремния и вызывают рост плотности дополнительных поверхностных состояний Nit*(Р,t).
Поток дефектов описывается выражением

где D –коэффициент диффузии «подпороговых» дефектов, dNit* - изменение плотности дополнительных поверхностных дефектов, dNд – изменение концентрации дефектов кремния в переходном слое от кремния к оксиду,
 - градиент распределения дефектов около границы SiO2,
- градиент распределения дефектов около границы SiO2,
 - градиент распределения дефектов в переходном слое от кремния к оксиду кремния,
- градиент распределения дефектов в переходном слое от кремния к оксиду кремния,
x – толщина переходного слоя от кремния к оксиду кремния.
В данной работе на основе данных [7] выбрано, что ширина переходного слоя «border traps» от Si к SiO2 составляет Х50.
Определены коэффициенты диффузии дефектов. Результаты приведены в таблице 1. Длина диффузии за время 1400 часов составляет величину около 20 мкм. Т.е. все процессы происходят в приповерхностной области кремния. Низкое значение коэффициента диффузии объясняется тем, что для перемещения «подпорогового» дефекта требуется ионизация соседних с дефектом атомов кремния. В таблице 1 также приводятся для сравнения коэффициенты диффузии «водородных разновидностей» и «надпороговых» дефектов кремния, которые рассчитаны по данным [3] и [6].
Таблица 1. Сравнение коэффициентов диффузии водородных разновидностей и дефектов в кремнии при температуре 25оС
| Дефекты | D(to), cм2/с | ||||||
| H0 | 9.12710-8 | ||||||
| H+ | 1.46510-13 | ||||||
| H2 | 1.43410-11 | ||||||
| OH-1 | 3.12210-15 | ||||||
| H2O | 4.5610-20 | ||||||
| Надпороговые дефекты | ~10-9 | ||||||
| 1526 ЛЕ5 в пассивном режиме | 2.21710-17 | ||||||
| 1526 ЛЕ5 в активном режиме | 3.8710-17 | ||||||
| КНИ тестовые МОПТ | 1,98410-17 | ||||||
В третьей главе предлагается использование кольцевых генераторов для исследования надежности КМОП ИМС в период старения в режиме переключения при воздействии низкоинтенсивного гамма-излучения. Облучение проводилось в шахте-хранилище реактора ИРТ МИФИ при мощности дозы Р=0,1 рад/с.
Испытания кольцевых генераторов на КМОП ИМС типа 564ЛН2 проводились в пассивном режиме. После каждого этапа облучения включалось питание кольцевого генератора, состоящего из 53 инверторов. Результаты эксперимента позволили определить коэффициент ускорения отказов при воздействии низкоинтенсивного гамма-излучения. Он получился равным Ку = 4,19. Наработка на отказ составила 534 ч.
Проводились испытания кольцевых генераторов в тестовых КМОП ИМС в интегральном исполнении. Для прогнозирования отказа использовалось минимальное напряжения питания Uмин. При облучении Uмин возрастает и отказ происходит при Uмин= Uпит. Для прогнозирования времени отказа в литературе использовалась показательная функция вида
Uмин(t) = Uмин(0) + А t m,
где Uмин(t) и Uмин(0) – значения минимального напряжения питания после и до облучения, t – время, А и m – параметры аппроксимирующей функции.
В данной работе предложено использование экспоненциальной функции вида
Uмин(t) = Uмин(0) + Аехр(а t),
в которой Uмин(t) и Uмин(0) – значения минимального напряжения питания после и до облучения, t – время, А и а – параметры аппроксимирующей функции.
Результаты испытаний при мощности дозы Р=0,1 рад/с в электрическом режиме переключения представлены в таблице 2. Они позволили определить минимальную оценку времени отказа.
Таблица 2. Времена отказов тестовых кольцевых генераторов при воздействии ИИ с мощностью дозы Р=0,1 рад/с
| Тестовая схема | Кольцевой генератор | t, ч | N | qотк |
| K1R001 | CG5 | 337 | 13 | 0,154 |
| K1R004 | CG1 | 556 | 23 | 0,083 |
Использование двух оценок времени отказа кольцевых генераторов позволило сделать прогноз для КМОП ИМС типа 1526ЛЕ5, т.к. отказ при испытаниях не был достигнут. Изменение минимального напряжения кольцевого генератора на элементах 2ИЛИ-НЕ показано на рис.8, а оценки времени отказа приведены в таблице 3.

Рис.8. Изменение минимального напряжения функционирования кольцевого генератора на микросхемах типа 1526ЛЕ5
Таблица 3. Результаты прогнозирования времени отказа 1526ЛЕ5
при Р=0,1 рад/с
| Аппроксимация | Время отказов |
| Показательная функция | 22500 ч |
| Экпоненциальная функция | 4028 ч |
Как можно видеть, прогноз времени отказа при использованием экспоненциальной функции, как и в случае рис. 6, значительно меньше и может быть принято для прогноза с запасом.
По результатам испытаний вероятность отказа получилась равной
![]()
откуда интенсивность отказов получается равной (см.таблицу 2 для случая экспоненциальной зависимости t = 4028 ч)

В этом случае средняя наработка на отказ при мощности дозы ИИ Р=0,1 рад/с получилась равной tср = 20 072 ч.
В четвертой главе поведено сопоставление ускоренных испытании при повышенной температуре с радиационными испытаниями при воздействии низкоинтенсивного ионизирующего излучения. При длительном хранении КМОП ИМС в пассивном режиме и при эксплуатации происходит релаксация напряженных валентных связей между атомами в приповерхностной области кремния, покрытого пленкой оксида кремния. Экспериментальные данные, полученные при низкоинтенсивном облучении и при ускоренных испытаниях, достаточно хорошо описываются экспериментальными зависимостями вида [1] и [8] соответственно
Nit = (Nit)нас (1-exp(-Pt)),
Nit = (Nit)нас (1-exp(-t)),
где Р – мощность дозы, t – время воздействия дестабилизирующего фактора, – эффективность радиационного воздействия, – эффективность воздействия температуры.
В случае одинакового времени воздействия дестабилизирующего фактора t и равенстве плотностей поверхностных состояний при низкоинтенсивном облучении и при повышенной температуре эквивалентные условия могут быть определены из выражения
Nit(Р, t) = Nit (Т, t).
Таким образом, получаем значение мощности дозы Р, эквивалентное условиям испытаний при заданной температуре Т,
Р = 0 VT ехр[(ESB – EF)/kT]/
где 0 – некоторый коэффициент, VT - тепловая скорость дырок, ESB – энергетический уровень напряженной связи (ESB=-1,18 эВ), EF – уровень Ферми, отчитанный от границы валентной зоны, k – постоянная Больцмана, T – абсолютная температура..
При воздействии ионизирующего излучения процесс старения значительно ускоряется. В данной работе на основании опубликованных экспериментальных данных, полученных для КМОП ИМС типа 564ЛА9, проводился поиск соответствия результатов ускоренных испытаний при повышенной температуре и при воздействии ионизирующего излучения (ИИ)
Ускоренные испытания при повышенной температуре Т=150оС проводились в течение 392 часов в том же электрическом режиме, что в эксперименте, описанном в [9]. Результат испытаний представлен на рис.9.
Сопоставления результатов испытаний интегральных микросхем типа 564ЛЕ5 в пассивном режиме при Т=150оС и низкоинтенсивном облучении и при Р=0,1 рад/с показано на рис.10 (кривые 1 и 2 соответственно). Определение эквивалентной мощности дано значение Р=0,01 рад/с. Полученная при Р=0,01 рад/с представлена на рис.10 (кривая 3).
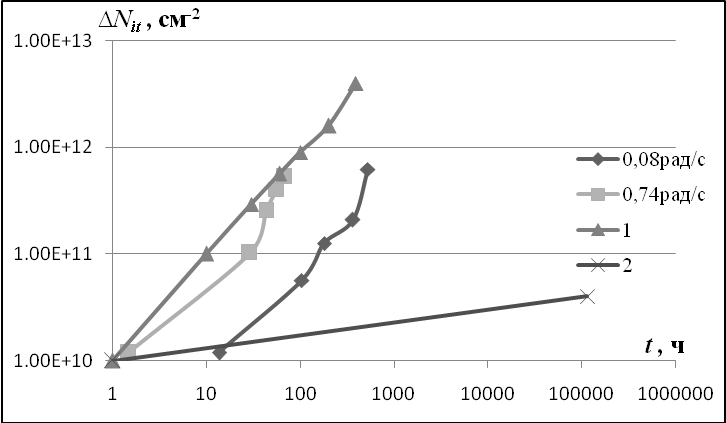

Рис.9. Изменение плотности Nit для МОП транзисторов с п-каналом (а)и с р-каналом (б) в случае испытаний при Т=150оС(1,) при нормальной температуре (2), при облучении электронами с Р=0,08 рад/с и 0,74 рад/с

Рис.10.Изменение плотности ПД при ускоренных испытаниях (1), радиационных испытаниях при мощностях дозы 0,1 рад/с (2) и 0,01 рад/с (3)
Сопоставление результатов испытаний интегральных микросхем типа 1526ЛЕ5 в пассивном режиме при 150оС и при облучении с Р=0,1 рад/с показано на рис.11 (кривые 1 и 2 соответственно). Определение эквивалентной мощности дозы дало значение Р=0,02 рад/с. Первый этап образования поверхностных состояний показан на рис.11 (пунктирная кривая) при мощности дозы Р=0,02 рад/с хорошо совпадает с результатами измерений при температуре 150оС (кривая 1). В дальнейшем температурная и радиационная зависимости расходятся.
Таким образом, использование низкоинтенсивного облучения может моделировать ускоренные испытания в пределах 2000 часов. Далее возникает второй этап поверхностного дефектообразования, который продолжается после 2000 часов облучения. На этом этапе согласно предложенной модели имеет место миграция дефектов из кремния, что увеличивает плотность поверхностных дефектов.

Рис.11. Сравнение результатов испытаний при температуре 150оС (1) и при облучении с Р=0,1 рад/с (2). Пунктиром показан результат прогноза при Р=0,02 рад/с
Сопоставление результатов испытаний в электрическом режиме тестовых структур кольцевых генераторов в интегральном исполнении производилось при напряжении питания 5 В в режиме переключения. Облучение тестовой КМОП ИМС проводилось при мощности дозы Р=0,1 рад/с, а испытания при температуре Т=150С осуществлялись в термокамере. Результаты представлены на рис. 12. Определялась мощность дозы гамма-излучения, эквивалентная испытанию при температуре 150оС в режиме переключения. Хорошее совпадение зависимостей Uмин(t) при температурном и радиационном воздействии получено при Р = 0,2 рад/с.


(а) (б)
Рис.12. Изменение минимального напряжения функционирования тестовых кольцевых генераторов 4CG1 (a) и 1CG5(б): 1 – прогноз, 2-облучение при Р=0,1 рад/с, 3 – испытания при Т = 150оС.
Таким образом, может быть найдена эквивалентная температурным испытаниям мощность дозы гамма-излучения при длительности испытаний до 1000 ч. для коммерческих КМОП ИМС и до 2000 ч. для других классов изделий. При бльших временах начинается миграция дефектов из кремния.
ЗАКЛЮЧЕНИЕ
В настоящей диссертационной работе доказано, что процесс старения МОП интегральных микросхем при долговременных радиационных испытаниях эквивалентен общепринятым ускоренным испытаниям при повышенной температуре, что показывает достижение поставленной цели.
Основные научные результаты диссертационной работы заключаются в следующем:
- Проведен анализ экспериментальных данных отечественных и зарубежных авторов по радиационно-стимулированному старению МОП приборов и показано наличия двух этапов старения в случае длительных испытаний при воздействии низкоинтенсивного ИИ.
- Показано, что радиационные испытания при низкоинтенсивном облучении и при испытании в случае повышенной температуры на первом этапе образования поверхностных состояний эквивалентны. На втором этапе сказывается диффузия дефектов из кремния, что не наблюдается при испытаниях в случае повышенной температуре.
- Впервые предложена модель старения МОП приборов при длительном низкоинтенсивном воздействии ионизирующего излучения, в которой на первом этапе происходит образование поверхностных состояний на границе раздела Si-SiO2, а на втором этапе старения происходит миграция радиационных дефектов, образовавшихся в полупроводнике при облучении, к границе раздела Si-SiO2.
- Предложен метод прогнозирования отказов кольцевых генераторов с использованием экспоненциальной функции, что значительно повысило точность определения времени отказа как при радиационных испытаниях, так и при испытаниях при повышенной температуре.
Основные практические результаты диссертационной работы заключаются в следующем:
- Впервые предложено использование кольцевых генераторов для длительных испытаний логических элементов при воздействии низкоинтенсивного ионизирующего излучения и при повышенной температуре. Определена средняя наработка на отказ элементов серийных КМОП ИМС и тестовых элементов.
- В случае испытания при низкоинтенсивном облучении может быть получен значительный экономический эффект по отношению к ускоренным испытаниям при повышенной температуре. Например: испытания в течение 1000 часов дает потребляемую энергию термокамеры 8MS-811 Е=3000 кВтч и гамма-установки МРХ--30 Е=0,05 кВтч дает экономический эффект в 60 тысяч раз.
- Применение методики измерения минимального напряжения питания кольцевого генератора использовано при испытаниях КМОП ИМС серии 1582.
В целом, научная и практическая значимость результатов работы заключается в том, что впервые в области старения МОП приборов осуществлен синтез теоретических и экспериментальных результатов и на этой основе может быть решена задача обеспечения длительного функционирования КМОП ИМС в условиях воздействия низкоинтенсивного излучения.
Список цитированных работ:
- Першенков В.С., Попов В.Д., Шальнов А.В. Поверхностные радиационные эффекты в элементах ИМС. – М.: Энергоатомиздат, 1988.
- Конверсионная модель эффекта низкой интенсивности в биполярных микроэлектронных структурах при воздействии ионизирующего излучения./ В.С.Першенков, Д. В.Савченков, А. С.Бакеренков, В.Н.Улимов.//Микроэлектроника. 2006. Том 35. № 2. С.102-112.
- Annealing of total dose damage: redistribution of interface states density on <100>, <110> and <111> orientation silicon./ R.E.Stahlbush, R.K.Lawrence, H.L.Hughes, N.S.Saks.//IEEE Trans.on Nucl.Sci. 1988. Vol.NS-35. No 6. P.1192-1196.
- Dose rate effects on total-dose threshold-voltage shift of power MOSFETs./ Schrimpf R/D/ at al.// IEEE Trans. on Nuclear Science. 1988. Vol.NS-35. No 6. P.1536-1540.
- McWhorter P.J., Winokur P.S. Simple technique for separating the effects of interface traps and charge metal-oxide-semiconductor transistors. // J.Appl.Phys.Lett. 1986. Vol.48. No1. P.133-135.
- Вавилов В.С., Кив Л.Е., Ниязова О.Р. Механизмы образования и миграции дефектов в полупроводниках.- М.: «Наука». Главная редакция физико-математической литературы. 1981.
- Fleetwood D.M. Border traps in MOS devices.// IEEE Trans.on Nucl.Sci. 1992. Vol.NS-39. No 6. P.269.
- Физическая модель процесса старения МОП-структуры. /М.А.Булушева, В.Д.Попов, Г.А.Протопопов, А.В.Скородумова. // Физика и техника полупроводников. 2010. Том 44. Вып.4. С.527-532.
- Моделирование радиационных эффектов в КМОП ИС при воздействии электронного облучения различной интенсивности. / В.В. Емельянов, О.В.Мещуров, В.Ш.Насибуллин, Р.Г.Усеинов.// Вопросы атомной науки и техники. Сер.Физика радиационного воздействия на радиоэлектронную аппаратуру. Вып. 1 – 2. – М.: ЦНИИатоминформ, 1995. С.51 – 58.
Список работ по теме диссертации
Публикации в изданиях, рекомендованных ВАК:
- Катеринич И.И., Попов В.Д., Чжо Ко Вин. Анализ изменения плотности поверхностных состояний состояний в МОП-приборах при воздействии гамма-излучения в широком диапазоне мощностей дозы.//Вопросы атомной науки и техники. Сер.Физика радиационного воздействия на радиоэлектронную аппаратуру. 2012. Вып.1. С.43-45.
- Чжо Ко Вин. Применение ионизирующего излучения для ускоренных испытаний МОП интегральных схем.// Электронная техника. Сер.Полупроводниковые приборы. 2012. Вып.1(228). С.54-56.
- Попов В.Д., Чжо Ко Вин. Радиационно-стимулированное старение интегральных микросхем.//Вопросы атомной науки и техники. Сер.Физика радиационного воздействия на радиоэлектронную аппаратуру. 2012. Вып.3. С.17-19.
- Попов В.Д., Чжо Ко Вин, Чубунов П.А. Определение параметров надежности КМОП ИМС после низкоинтенсивного облучения.// Вопросы атомной науки и техники. Сер.:Физика радиационного воздействия на радиоэлектронную аппаратуру. 2012. Вып.4. С.46-47.
- Г.Ф.Белова, В.Д.Попов, Чжо Ко Вин. Сравнение радиационного и термического старения МОП интегральных микросхем.//Вопросы атомной науки и техники. Сер.Физика радиационного воздействия на радиоэлектронную аппаратуру. 2012. Вып.2. С.29-32.
- Чжо Ко Вин. Использование тестовых кольцевых генераторов для прогнозирования дозы отказа КМОП ИМС при воздействии низкоинтенсивного излучения.// Вопросы атомной науки и техники. Сер.Физика радиационного воздействия на радиоэлектронную аппаратуру. Научно-техн.сб. 2013.Вып.1. С. 67-69.
Статьи и материалы конференций
- Катеринич И.И., Попов В.Д., Чжо Ко Вин. Анализ изменения плотности поверхностных состояний состояний в МОП-приборах при воздействии гамма-излучения в широком диапазоне мощностей дозы.// Радиационная стойкость электронных систем - «Стойкость-2011». Научно-технический сборник. – М.: НИЯУ МИФИ, 2011. С.119-120.
- Г.Ф.Белова, В.Д.Попов, Чжо Ко Вин. Сравнение радиационного и термического старения МОП интегральных микросхем.//Радиационная стойкость электронных систем - «Стойкость-2011». Научно-технический сборник. – М.: НИЯУ МИФИ, 2011. С.97-98.
- Чжо Ко Вин. Применение ионизирующего излучения для ускоренных испытаний МОП интегральных схем.//Твердотельная электроника, сложные функциональные блоки РЭА. Материалы Х научно-технической конференции молодых специалистов. г.Дубна, 12-14 октября 2011 г. - М.: МНТОРЭС им.А.С.Попова, 2011. С.146-149.
- В.Д.Попов, Чжо Ко Вин, П.А.Чубунов. Определение параметров надежности КМОП ИМС после низкоинтенсивного облучения.//Тезисы докладов 15 Всероссийской научно-технической конференции по радиационной стойкости электронных систем-«Стойкость-2012». Научно-технический сборник.- Лыткарино: НИИП, 2012. С.49-50.
- Исследование процесса старения КМОП ИМС при длительном низкоинтенсивном воздействии гамма-излучения./А.В.Власов, Р.В.Власов, В.Д.Попов, Чжо Ко Вин.//Тезисы докладов 16 Всероссийской научно-технической конференции по радиационной стойкости электронных систем -«Стойкость-2013». Научно-технический сборник.- Лыткарино: НИИП, 2013. С.116.
- Чжо Ко Вин. Использование тестовых кольцевых генераторов для прогнозирования дозы отказа КМОП ИМС при воздействии низкоинтенсивного излучения. //Тезисы докладов 16 Всероссийской научно-технической конфекенции по радиационной стойкости электронных систем «Стойкость-2013». Научно-технический сборник.- Лыткарино: НИИП, 2013. С.117-118.
- А.В.Власов, Р.В.Власов, Е.С.Воронцов, В.Д.Попов, Чжо Ко Вин. Прогнозирование радиационных отказов КМОП микросхем при использовании кольцевых генераторов. //Научная сессия НИЯУ МИФИ-2013. Аннотации докладов. Том 1.- М.: НИЯУ МИФИ, 2013. С.129.
- Попов В.Д., Чжо Ко Вин. Сравнение роста плотности поверхностных состояний в МОП структуре при воздействии температуры и низкоинтенсивного ионизирующего излучения.- Флуктуационные и деградационные процессы в полупроводниковых приборах. М-лы докладов Международного научно-методического семинара. – М.:НИУ «МЭИ», 2013. С.88-91.

