Генерация неравновесных точечных дефектов и сопутствующие ей эффекты при физико-химических воздействиях на поверхность кристаллов
На правах рукописи
Итальянцев Александр Георгиевич
ГЕНЕРАЦИЯ НЕРАВНОВЕСНЫХ ТОЧЕЧНЫХ ДЕФЕКТОВ И СОПУТСТВУЮЩИЕ ЕЙ ЭФФЕКТЫ ПРИ ФИЗИКО-ХИМИЧЕСКИХ ВОЗДЕЙСТВИЯХ НА ПОВЕРХНОСТЬ КРИСТАЛЛОВ
05.27.01 – твердотельная электроника, радиоэлектронные компоненты, микро- и наноэлектроника, приборы на квантовых эффектах
Автореферат диссертации на соискание ученой степени доктора
физико-математических наук
ЧЕРНОГОЛОВКА 2009 г
Работа выполнена в Учреждении Российской академии наук Институт проблем микроэлектроники и особочистых материалов РАН
Официальные оппоненты:
Доктор технических наук, профессор Мильвидский Михаил Григорьевич (ГИРЕДМЕТ).
Доктор физико-математических наук, профессор Герасименко Николай Николаевич (МИЭТ),
Доктор физико-математических наук Барабаненков Михаил Юрьевич (ИПТМ РАН).
Ведущая организация: Физический институт им. П.Н.Лебедева РАН
Защита состоится: 10 июня 2009 г в « 11 » часов « 00 » мин.
на заседании диссертационного совета Д 002.081.01 при Институте проблем технологии микроэлектроники и особочистых материалов (ИПТМ) РАН по адресу: 142432, Московская обл., г. Черноголовка, ул. Институтская, д.6, ИПТМ РАН.
С диссертацией можно ознакомиться в библиотеке ИПТМ РАН.
Автореферат разослан: « » ____________ 2009 г.
Ученый секретарь диссертационного совета Д 002.081.01
Панченко Л.А.
Общая характеристика работы.
Предметом диссертационной работы являются теоретические и экспериментальные исследования генерации неравновесных собственных точечных дефектов (ТД) на поверхности моноатомных кристаллов, т.е. образование в объеме кристалла неравновесных вакансий (V) и собственных атомов в междоузельных положениях решетки (I) при двух видах физико-химических воздействий на поверхность кристалла. Каждый из этих видов воздействий носит достаточно общий характер и может быть реализован в качественно различных условиях эксперимента. Кроме того, к предмету исследований относятся эффекты в объеме кристалла, которые сопутствуют появлению неравновесных ситуаций в подсистеме собственных ТД кристалла, обусловленной генерацией ТД на его поверхности.
Первый вид воздействия на кристалл связан с протеканием на его поверхности твердофазных химических реакций (ТФР), в результате которых образуется слой новой твердой фазы. Такие ТФР могут наблюдаться как в исходно твердофазных системах Атв–Втв, так и при взаимодействии поверхности кристалла (Втв) с газовой или жидкостной средой, т.е. в системах Агаз–Втв или Аж–Втв. Применительно к наиболее распространенному и хорошо изученному кристаллу полупроводниковой технологии – кремнию, в качестве примеров ТФР в таких системах можно привести реакции образования силицидов, окислов и нитридов кремния. Сочетание трех видов исходных систем с различным агрегатным состоянием исходных компонентов с многообразием возможных исходных реагентов А и В и продуктов их реакции определяет широту спектра реализаций ТФР.
Общий признак второго типа физико-химических воздействий на кристалл, исследуемых в работе, – прямое удаление матричных атомов с его поверхности, т.е. удаление атомов без образования промежуточных твердых фаз. Такой вид воздействий может быть реализован, например, при некоторых видах химического и плазмохимического травления кристалла, при стимулированной сублимации поверхностных атомов, а также при низкоэнергетическом радиационном распылении материала.
Среди сопутствующих эффектов в объеме кремния, вызванных инжекцией неравновесных собственных ТД с поверхности в объем кристалла, в первую очередь следует отнести ускоренную (заторможенную) диффузию примесных атомов, изменение степени электрической активации внедренной примеси, а также стимулированную эволюцию комплексов и кластеров различного происхождения.
Актуальность темы диссертационной работы обусловлена тем, что она направлена на изучение важнейшей подсистемы кристаллов - подсистемы собственных ТД, от параметров которой существенно зависят многие процессы в объеме бездислокационных кристаллических решеток. К таким процессам относятся, например, все диффузионно лимитируемые процессы в кристалле.
Несмотря на имеющиеся в литературе модельные представления о генерации неравновесных собственных ТД для ряда конкретных реализаций исследуемых воздействий, единая теория генерации ТД для каждого из двух классов исследуемых воздействий отсутствует. В первую очередь это относится к ТФР на поверхности кристаллов. Например, существуют модели генерации I при термическом окислении кремния. Известны также экспериментальные работы, свидетельствующие об образовании неравновесных V в кремнии под растущими слоями некоторых силицидов в структурах металл-Si. Однако, несмотря на то, что оба вида этих реакций относятся к одному классу физико-химических явлений - поверхностным ТФР - и a’priori имеют глубокую гносеологическую и физическую связь, модельные представления, способные с единых позиций на качественном и количественном уровне описать основные параметры генерации неравновесных ТД даже только в этих двух случаях, отсутствуют.
Аналогичная ситуация и со вторым классом воздействий на кристалл, предусматривающих принудительное удаление матричных атомов с его поверхности. В этом случае, даже для частных случаев такого воздействия (химическое или плазмохимическое травление, стимулированная сублимация и т.д.), теоретические модели генерации неравновесных V отсутствуют. Отправной точкой в этой части диссертационной работы можно считать классическую модель образования термодинамически равновесного вакансионного раствора по Шоттки.
Научная составляющая актуальности темы определяется тем, что она предусматривает построение таких обобщенных моделей. Создание унифицированных количественных моделей генерации неравновесных ТД для каждого класса рассматриваемых воздействий позволит не только с единых позиций численно оценивать кинетические и термодинамические параметры неравновесных подсистем ТД кристалла, возникающих при различных воздействиях на кристалл, но и откроет возможность прогноза эффектов от еще экспериментально не исследованных гипотетических внешних воздействий.
Практическая значимость темы диссертационной работы обусловлена прикладным значением результатов предполагаемых исследований. Дело в том, что подавляющая часть ТФР и методов удаления матричных атомов, составляют основу базовых технологических приемов производства полупроводниковых приборов. Это означает, что изучение таких воздействий с точки зрения их влияния на подсистему собственных ТД позволит заранее прогнозировать появление структурно зависимых эффектов в объеме кристалла в процессе ряда технологических воздействий на его поверхность. Эти эффекты могут быть как целевыми, так и артефактами.
Целью работы является разработка единых модельных представлений о генерации неравновесных собственных ТД в элементарных кристаллах, стимулированной протеканием различных ТФР на его поверхности или прямым отбором поверхностных матричных атомов, а также исследование сопутствующих этой генерации эффектов в объеме кристалла.
Поставленная цель предусматривает решение следующих укрупненных задач для каждого из двух исследуемых классов воздействий:
- разработка феноменологических модельных представлений о механизме генерации неравновесных ТД и теории количественных оценок;
- анализ термодинамических стимулов такой генерации и оценка кинетических факторов, при которых процесс может быть реализован;
- выполнение численных оценок параметров генерации ТД для конкретных экспериментальных ситуаций;
- экспериментальное исследование теоретически анализируемых ситуаций;
- сопоставление полученных результатов теоретических расчетов параметров подсистемы ТД с данными экспериментов;
- исследование некоторых наиболее очевидных эффектов в объеме кристалла, сопутствующих инжекции неравновесных ТД с поверхности в объем кристаллического образца.
Научная новизна.
- Впервые разработана обобщающая модель генерации неравновесных собственных ТД в моноатомных кристаллах, обусловленная протеканием ТФР на их поверхности. Модель способна с единых позиций адекватно эксперименту описывать генерацию ТД в различных исходных системах для широкого спектра реакций, протекающих на границе раздела с кристаллом. В рамках разработанной теории впервые получены аналитические выражения, позволяющие без использования каких-либо подгоночных коэффициентов численно оценивать:
- энергию образования ТД в условиях ТФР;
- термодинамически оправданную предельную степень пересыщения твердого раствора ТД;
- кинетический фактор достижения этой предельной степени пересыщения;
- среднестатистический выход числа ТД на одну молекулу новой фазы, а также критерий природы (V или I) ожидаемых ТД.
Возможности развитых модельных представлений продемонстрированы на примере расчета с единых позиций перечисленных параметров для широкого спектра ТФР в различных системах: металл-Si (V-Si, Mo-Si, Ni-Si, Ti-Si, Cr-Si, Pt-Si и т.п.), SiO2-Si и Si3N4-Si.
Адекватность разработанных положений подтверждена удовлетворительным соответствием теории и эксперимента для всех анализируемых ТФР.
- В качестве следствий разработанных модельных представлений получены выражения для количественной оценки энергии активации ТФР и численного критерия определения последовательности образования первой и последующих фаз в твердофазных системах с полифазной диаграммой состояния.
Теоретически рассчитанные значения энергии активации ТФР в структурах металл-Si и SiО2-Si, а также аналитически предсказанные последовательности образования фаз в структурах металл-Si, хорошо совпадают с экспериментальными данными для исследуемых систем и ТФР.
- В развитие положений классической модели Шоттки разработана модель генерации неравновесных V в моноатомных кристаллах, которая с единых позиций описывает генерацию V в условиях различных внешних воздействий, обеспечивающих удаление матричных атомов с поверхности кристалла.
- Впервые получено комплексное экспериментальное подтверждение факта генерации неравновесных V при трех различных внешних воздействиях, приводящих к прямому удалению матричных атомов кристалла: при химическом травлении в газовой атмосфере, плазмо-химическом травлении и фотостимулированной сублимации.
- Экспериментально установлены новые эффекты в монокристаллическом Si и GaAs, обусловленные целенаправленным изменением состояния подсистемы собственных ТД:
- ускоренный диффузионный выход примесных атомов из кремниевой подложки, исходно легированной Sb, в эпитаксиальный слой под действием ТФР образования силицидов ванадия на поверхности эпитаксиальной структуры;
- «дальнодействие» V, вводимых за счет ТФР или химического травления, далеко за пределами их диффузионного фронта, проявляющееся во влиянии на экзоэлектронную эмиссию, динамику отжига радиационных дефектов и электрическую активацию примесных атомов в ионно-имплантированных слоях Si;
- эффект понижения температуры начала ТФР при in situ введении в кристалл ТД, противоположных по природе ТД, генерация которых должна сопровождать эту ТФР;
- эффект ускоренного распада в Si термостабильных кластеров внедренного типа различной природы за счет целенаправленного пересыщения решетки неравновесными V при высокотемпературном газовом травлении кристалла;
- эффекты повышения люминесцентных свойств полуизолирующих кристаллов GaAs и ионно-легированных Si+ слоев на их основе за счет введения в кристалл VGa и VAs в условиях поддержания стехиометрии поверхности кристалла.
- Построена оригинальная система уравнений и соотношений для описания эволюции размеров кластеров собственных дефектов в двухкомпонентном растворе подвижных ТД. Показано, что в ситуации, когда уравнения учитывают одновременное взаимодействие кластера как с однотипными ТД, так и с дефектами противоположной природы, теоретически можно выделить семь исчерпывающих качественно различных состояний неравновесия в подсистеме собственных ТД, при которых кластеры должны распадаться или расти. Каждому из семи состояний сопоставлены примеры внешних воздействий, с помощью которых можно создать то или иное состояние неравновесия. Выдвинутые предположения о характере эволюции кластеров сопоставлены с экспериментальными данными о реальном их поведении.
- Систематизированы методы дефектной инженерии на основе целенаправленного управления параметрами подсистемы собственных ТД кристалла за счет введения в решетку ТД заранее известной природы. Предложенные методы создают основу для разработки технологических способов управления структурным совершенством исходных и ионно-имплантированных слоев, проведения низкотемпературных процессов диффузии примесных атомов, роста слоев новой фазы, геттерирования.
Прикладная значимость результатов работы обусловлена следующими факторами.
Во-первых, разработанные теоретические положения позволяют производить прогноз практически значимых эффектов в объеме моноатомных кристаллов. К таким эффектам относятся, например, изменение скорости диффузии примесных атомов, рост или распад структурных нарушений различной природы, рост включений и слоев новой фазы, увеличение эффективности электрической активации внедренных примесей.
Во-вторых, развитые теоретические положения и система количественных оценок позволяют еще до постановки эксперимента рассчитывать важнейшие параметры и характеристики роста слоев новой фазы на поверхности кристалла, а также оценивать последствия такого роста с точки зрения его влияния на подсистему собственных ТД.
В-третьих, большинство исследуемых в работе воздействий на кристалл хорошо совместимы с известными технологическими приемами. В этой связи, полученные результаты могут лечь в основу новых или модернизации известных технологических методов проведения ускоренных или низкотемпературных целевых процессов, а также предотвращения артефактов от технологических воздействий.
Общность изложенных положений прикладной значимости достаточна для создания атласов параметров и характеристик самых различных эффектов на поверхности и в объеме кристалла от широкого спектра ТФР и воздействий, приводящих к удалению матричных атомов. Такие данные по отношению к разным кристаллам, к широкому спектру не только известных, но и гипотетических воздействий, могут быть полезны как в микроэлектронике, так и в других областях техники, предполагающих создание слоистых систем, защитных и упрочняющих покрытий с заранее заданными свойствами.
Достоверность результатов работы обусловлена:
- соответствием результатов теории с экспериментальными данными не только опытов автора, но также данными, полученными различными исследователями в ведущих лабораториях мира;
- согласованием теоретических результатов с классическими представлениями, для которых они являются развитием на случай неравновесных ситуаций в подсистеме собственных ТД кристалла, достигаемых целенаправленным раздельным введением в решетку V или I;
- использованием широкого спектра современных методов исследования при проведении экспериментов: вторичной ионной масс-спектроскопии, рентгеновского микроанализа, емкостных методов исследования, включая спектроскопию глубоких уровней, экзоэлектронной эмиссии, методов катодо- и фотолюминесценции, в том числе низкотемпературных, методов ренгеновской дифракции, а также зондовых и металлографических методов исследования.
Автор защищает:
- Единую модель генерации собственных ТД в элементарных кристаллах под воздействием ТФР на их поверхности, позволяющую проводить количественную оценку следующих параметров: энергии образования ТД в условиях ТФР, предельной степени пересыщения кристалла ТД, коэффициента кинетической реализации этих предельных пересыщений, а также критерия прогноза ожидаемого типа неравновесных ТД. Результаты расчета параметров генерации ТД и ТФР для систем металл-Si, Si-SiO2 и Si-Si3N4, полученные на основании разработанной единой модели.
- Следствия единой теории генерации ТД при ТФР, позволяющие a’priori оценивать характеристики собственно ТФР: энергию активации реакции, последовательность образования фаз в твердофазных системах с полифазной диаграммой состояния. Результаты расчета указанных параметров для некоторых ТФР в системах металл-Si, Si-SiO2.
- Эффект взаимного влияния пространственно разнесенных ТФР и ионно-имплантированных слоев, который заключается в понижении (примерно на 100оС) температуры начала ТФР и восстановления электрической проводимости ионно-имплантированных слоев Si.
- Комплекс экспериментальных результатов по стимулированным ТФР процессам: экзоэлектронной эмиссии с поверхности Si, ускоренной диффузии Sb из подложки в эпитаксиальный слой Si в структуре V-Si, электрической активации внедренных примесных атомов.
- Обобщенную феноменологическую модель генерации неравновесных V при внешних воздействиях, обеспечивающих прямое, без образования промежуточных твердых фаз, удаление матричных атомов с поверхности кристалла, включая специальные требования к внешнему воздействию и кристаллу.
- Модель трансформации размеров кластеров собственных дефектов в двухкомпонентном растворе собственных ТД в изотермическом процессе, а также эмиссионную модель распада кластеров при резком нагреве кристалла.
- Комплекс экспериментальных данных по эффектам в исходных кристаллах и в ионно-имплантированных слоях, стимулированным введением неравновесных V за счет принудительного отбора матричных атомов кристалла методом его высокотемпературного химического или плазмо-химического травления.
- Результаты экспериментов, подтверждающие генерацию неравновесных вакансий в условиях принудительного отбора матричных атомов кристалла методом фотостимулированной сублимации атомов Si.
- Эффекты улучшения структурного совершенства кристаллов полуизолирующего GaAs, повышения электрофизических и люминесцентных свойств ионно-легированных кремнием слоев на его основе, благодаря предварительному введению в бинарный кристалл неравновесных вакансий по подрешеткам As и Ga при высокотемпературном химическом травлении кристалла в условиях поддержания его стехиометрического состава.
Публикации и доклады. Результаты диссертационной работы в полной мере изложены в 45 научных публикациях в ведущих рецензируемых отечественных и зарубежных журналах [1-16], материалах отечественных и международных конференций [17-38], а также в материалах авторских свидетельств на изобретения [39-45]. Список этих публикаций приведен в конце автореферата. Общее число опубликованных научных трудов автора по специальности диссертации – более 75.
Апробация результатов работы.
Результаты работы доложены и обсуждались на различных международных и отечественных научных конференциях [17-38] и симпозиумах, в числе которых:
- VI Конференция по процессам роста и синтеза полупроводниковых кристаллов и пленок», Новосибирск, 1982.
- 7 Международная конференция по ионной имплантации в полупроводниках и других материалах», Вильнюс, 1983.
- Всесоюзная конференция по радиационной физике полупроводников и родственных материалов, Ташкент, 1984.
- Международная конференция по импульсным и лучевым воздействиям на материалы - EPM-87, Dresden, GDR, 1987.
- Всесоюзная конференция «Ионно-лучевая модификация материалов», Черноголовка, 1987.
- XII Всесоюзная конференция по микроэлектронике, Тбилиси, 1987.
- Всесоюзная конференция по физико-химическим основам легирования, Москва, 1988.
- Международная конференция по ионно-лучевой модификации материалов - IBMM-88, Japan, 1988.
- Международная конференция по ионной имплантации и ионно-лучевому оборудова-нию - Ion implantation and ion beam equipment (I3BE), Elenita, Bulgaria, 1990.
- Международная конференция по прикладным вопросам металлизации в схемах со сверхвысокой степенью интеграции - Metallization in ULSI Application, Murray Hill, NJ USA, 1991.
- Международная конференция по компьютерным приложениям в области материаловедения - CAMCE-92, Yokogava, Japan, 1992.
- Международный симпозиум Общества Исследователей Материалов, MRS-87, MRS-90, MRS-92 Strasbourg, France, 1987, 1990, 1992.
- 5 Международная конференция по актуальным проблемам физики, материаловедения, технологии и диагностике кремния, нанолегированных структур и приборов на его основе «Кремний – 2008», Черноголовка, 2008.
- Одиннадцатая научно-прикладная конференция «Кремний 2008» -11th Scientific and Business Conference “Silicon 2008”, Чехия, 2008.
Вклад автора в результаты работы.
Теоретическая часть работы, результаты которой составляют основу положений, выносимых на защиту, все расчеты параметров генерации ТД и характеристик ТФР, иллюстрирующие возможности развитых модельных представлений, автором выполнены самостоятельно и опубликованы в нескольких работах без соавторов. Во всех экспериментальных исследованиях автор принимал непосредственное участие в постановочной части эксперимента, в обсуждении и вычислительной обработке их результатов. Инструментальная часть экспериментов, связанная с использованием специализированных аналитических методов экспериментальных исследований, выполнена коллегами и соавторами автора диссертации по научным публикациям.
Структура работы. Работа включает оглавление, введение, заключение и 9 глав описания исследований, которые условно можно разбить на два раздела. Первый раздел (1-4 главы) посвящен вопросам генерации ТД в условиях протекания ТФР на поверхности кристалла и сопутствующим ей процессам в объеме кристаллической решетки. Во втором разделе диссертации (5-9 главы) рассмотрены условия образования неравновесных ТД при стимулированном отборе поверхностных атомов и сопутствующие эффекты в объеме кристалла.
Общее количество страниц диссертационной работы - 280, включая 51 рисунок, 22 таблицы. Библиография составляет 158 ссылок.
Краткое содержание диссертационной работы
Первая глава - «Единая модель генерации собственных точечных дефектов при твердофазных реакциях на поверхности моноатомных кристаллов». Под твердофазными реакциями (ТФР) понимают реакции, в которых один из реагентов и продукт химической реакции находятся в твердом состоянии. Второй реагент может быть в любом из четырех агрегатных состояний.
Рассматривается граница раздела А-В, имеющая атомарный контакт между компонентами А и В. Компонент В всегда моноатомный кристалл В (т.е. В В). Компонент А – инвариантен. В общем случае он может состоять из атомов или молекул, находиться в газообразном (или в виде плазмы), жидком или твердом агрегатом состоянии в зависимости от типа исходной системы. Кроме того, инвариантность А определяется химией реагента и продуктом реакции, а также стадией формирования слоя новой фазы. Большое количество возможных сочетаний элементов А и В, инвариантность границы раздела А-В даже в пределах одной исходной системы определяет многообразие ТФР и позволяет характеризовать твердофазные реакции как широкий класс физико-химических воздействий на кристалл.
Отправной точкой для разрабатываемой модели генерации неравновесных ТД в кристалле при ТФР на его поверхности является молекулярный дисбаланс объемов, возникающий при встраивании молекулы новой фазы АхВу на границе раздела с кристаллом. Элементарный объем молекулы АхВу не равен сумме объемов атомов (или молекул) реагентов, затраченных на построение этой молекулы. По этой причине, при встраивании вновь рожденной молекулы АхВу на границе раздела, возникает дисбаланс =1-2 между молекулярным объемом 1=АхВу и объемом 2 условной полости для размещения новой молекулы. На величину также может оказывать влияние механизм диффузии реагента через растущий слой новой фазы в зону реакции.
Для ТФР, протекающих на границе раздела с кристаллом, часть молекулы АхВу располагается в кристалле, а (1- ) часть по другую сторону от условной математической границы раздела кристалла с растущим слоем новой фазы. С учетом этого, в работе вводится понятие парциального дисбаланса объемов размещения по обе стороны от границы раздела, т.е. величины А, В. Значения А, В могут отличаться друг от друга и даже иметь различный алгебраический знак. Алгебраическая сумма парциальных дисбалансов объемов дает интегральный дисбаланс размещения на границе раздела =А + В.
В качестве первого приближения предполагается, что коэффициент распределения объема молекулы в кристалле определяется долей объема атомов кристалла по отношению к объему всех атомов молекулы АхВу, т.е.
1 BА1В1/А1В1= у1В/(x1А + у1В).
Объем молекулы или атома в своей фазе =М/(NA) естественным образом выражен через молярную (атомарную) массу М, удельную плотность и число Авогадро NA. С учетом коэффициента распределения объема молекулы новой фазы 1 для парциальных дисбалансов объемов размещения, возникающих на границе раздела получены выражения
В = А1В1 (y1B)/(x1A + y1B)– у1В ,
А = [x1АА1В1/(x1А + у1В)] - x1А.
Эти выражения соответствуют ситуации, когда молекула новой фазы образуется в результате реакции из так называемых чистых компонентов x1A+y1B=Ax1By1.

Рис.1 Иллюстрация к возникновению молекулярного дисбаланса для размещения молекулы новой фазы, образованной из чистых компонентов исходной А-В системы.
Для парциальных несоответствий молекулярных объемов при зарождении второй и последующих фаз из промежуточных компонентов в реакции типа Ax1By1 + mB = nAx2By2 получены выражения
В = 2А2В2 - (mB + 1А1В1)/n,
А = (1- 2)А2В2 - (1- 1)А1В1/n,
в которых под 2 следует понимать коэффициент распределения дополнительного размещаемого объема, создаваемого такой реакцией, т.е.
2 BА2В2/А2В2 =[1+(1-1)A1B1 /(1A1B1+ mB) ]-1

Рис.2 Иллюстрация к возникновению молекулярного дисбаланса для размещения молекулы новой фазы, образованной из промежуточных компонентов системы Ax1By1-В.
В результате дисбаланса объемов по обе стороны от границы раздела, вокруг встроенной молекулы новой фазы возникают (Рис.3) поля упругих напряжений (r,). Исключение составляет ситуация начальной стадии формирования слоя новой фазы при взаимодействии кристалла с газовой средой (Рис.3, поз.1). Величина (r,) определяется модулем упругости фазы Е, в которой они возникают, и соответствующими парциальными дисбалансами объемов размещения А и В.

Рис.3 Локальные поля упругих напряжений вокруг встроенной молекулы новой фазы в открытой (1), полузакрытой (2) и закрытой (3) механических системах в зависимости от стадии формирования слоя новой фазы.
В исходных системах Агаз-Втв для ТФР с преимущественным диффузантом А реакции протекают вначале в «открытой» системе, затем в «полузакрытой», где часть упругих напряжений может релаксировать за счет геометрического искажения поверхности растущей пленки (Рис.3, поз.2), и далее в «закрытой» механической системе, когда на расстояниях порядка толщины слоя новой фазы напряжения значительно спадают (Рис.3, поз.3). С учетом этих рассуждений выбирается область интегрирования поля упругих напряжений (r,) вокруг отдельно взятой молекулы новой фазы по соответствующей области пространства с модулем упругости ЕВ или ЕА и определяется энергия упругих напряжений g*el, как
g*el = r (ЕА,ЕВ,А,В,r,)ddr.
В рамках развиваемых в работе модельных представлений такой интеграл вычисляется в приближении изотропного континуума (без учета анизотропии кристалла) в пределах одной фазы. Например, в варианте задачи Ламе при интегрировании по полубесконечному пространству с коэффициентом изотропной объемной упругости кристалла КВ=ЕВ/3(1-2) и коэффициентом Пуассона представленный интеграл равен
g*el=(8/9)KВ·(В)2/(В1+В2),
где выражение для В выбирается в зависимости от того, рассматривается образование первой фазы из чистых компонентов или рассматривается ситуация с образованием второй или последующих фаз в твердофазных системах с полифазной диаграммой состояния.
Энергия упругих напряжений g*el увеличивает свободную энергию системы и уменьшает термодинамический стимул протекания ТФР, который в основном задается энтальпией реакции Нр. В связи с этим система будет искать термодинамически выгодные и кинетически открытые пути релаксации возникающих локальных упругих напряжений. На рис. 4 представлены наиболее распространенные и возможные пути релаксации таких напряжений в твердофазных системах с участием кристалла.

Рис.4 Возможные механизмы релаксации локальных упругих напряжений в твердофазных системах путем: выдавливания дислокаций, испускания неравновесного ТД, перестройки блочной структуры в слое новой фазы, механического разрушения системы, например, путем отслоения растущей пленки от кристаллической подложки.
В работе рассматривается механизм релаксации таких напряжений путем генерации в кристалле неравновесных вакансий (V) или собственных атомов в междоузлиях (I). Допускается, что для выдавливания одного ТД может понадобиться образование ()-1 молекул новой фазы. Далее все расчеты проводятся при допущении об аддитивности накопления упругих напряжений в пределах образования ()-1 молекул новой фазы. Величина представляет собой коэффициент выхода ТД на одну молекулу новой фазы. При условии полной компенсации молекулярного дисбаланса размещения в кристалле В объемом · PD испускаемых ТД соответствующей природы, коэффициент выхода составит
=В/PD.
Допущение о полной компенсации В удовлетворительно для случаев, когда после завершения ТФР и формирования слоя новой фазы в системе не наблюдается остаточных напряжений gel, сопоставимых с нерелаксированным значением g*el. В большинстве исследуемых случаев это допущение оправдано. В более общей ситуации, когда релаксация g*el за счет испускания ТД неполная и в системе существуют остаточные напряжения gel, величина должна определяться из соотношения
gel = (4/9)КВ·(В - PD)2/(21B - B).
Показано, что в этом случае выражение для коэффициента выхода ТД на одну молекулу новой фазы принимает вид
=В/PD – [gel( 11 + В2)/(4/9)КВ2PD]1/2.
В представленном выражении для второе слагаемое играет роль поправки на неполноту релаксации упругих напряжений.
Алгебраический знак дисбаланса объемов размещения В определяет характер локальных напряжений (сжатия или растяжения) и является фактором прогноза природы (вакансионной или междоузельной) ТД, генерация которых способна обеспечить релаксацию этих напряжений.
С точки зрения термодинамики при генерации неравновесных ТД система осуществляет размен упругой энергии g*el на избыточную энергию пересыщенного твердого раствора ТД gPD. В пересчете на одну молекулу новой фазы величина gPD представлена в виде
gPD =kTln(CPD/CoPD).
В этом выражении CPD/CoPD = –пересыщение решетки кристалла ТД.
Чтобы размен g*el на gPD был энергетически выгоден, необходимо выполнение неравенства gPD < g*el. Решение этого неравенства приводит к соотношению для термодинамически допустимого пересыщения ТД решетки кристалла под растущими слоями новой фазы
= CPD/CoPD = exp(g*el/kT).
Как следует из представленного выражения, энергия образования дефектов Е*fPD в присутствии ТФР при этом равна
Е*fPD = ЕfPD - g*el/,
где Еоf – энергия образования V или I в равновесных условиях.
Показано, что предельные значения, по соображениям кинетики, могут реализоваться не во всех ситуациях. Предложен критерий кинетической открытости к достижению предельно допустимых пересыщений ТД в кристалле под растущими слоями новой фазы. Этот критерий представлен в виде отношения двух характерных промежутков времени t/tэксп: времени достижения стационарного диффузионного профиля ТД при их «накачке» с поверхности в объем кристалла t и характерного времени эксперимента tэксп. Численная оценка t из диффузионного уравнения с граничным условием jх=0 = W, где W – скорость образования молекул новой фазы, показывает, что, например, для реакций образования слоев силицида металла в структурах М-Si и при росте пленки SiO2 при термическом окислении Si, пересыщение приповерхностных слоев кристалла ТД в эксперименте кинетикой не лимитируется. А вот в случае роста слоя Si3N4 на том же кремнии, за характерное время реального процесса предельные пересыщения достигнуты не будут.
В заключительной части главы, рассмотрен возможный вклад физических явлений, неучтенных в разработанных модельных представлениях: макроскопические механические напряжения в структуре, эффект Киркендала и другие. Показано, что в случае большинства ТФР их вклад не является определяющим и при необходимости может быть учтен в качестве поправок.
Следует отметить, что разработанные модельные представления позволяют с единых позиций для широкого класса ТФР в различных исходных системах сделать численные оценки ряда молекулярных и интегральных параметров генерации неравновесных ТД. К таким молекулярным параметрам относятся: коэффициент распределения объемов молекулы новой фазы по обе стороны от условной границы раздела ее размещения; общий и парциальные А, В дисбалансы объемов размещения молекулы новой фазы; величина энергии нерелаксированных упругих напряжений, возникающих вокруг молекулы новой фазы g*el; коэффициент выхода ТД на каждую рождаемую молекулу новой фазы. В качестве интегрального параметра модель позволяет рассчитать предельную степень пересыщения решетки кристалла неравновесными ТД, генерация которых стимулирована ТФР. Кроме того, предложены количественные критерии прогноза природы ожидаемых ТД, а также кинетической открытости процесса для достижения предельных пересыщений за характерное время эксперимента.
Все параметры генерации ТД, в рамках разработанных модельных представлений, определяются без использования каких-либо подгоночных коэффициентов и выражаются, в конечном итоге, через классические параметры фаз – модуль упругости Е и коэффициент Пуассона, молярную и удельную массы М и, а также фундаментальные константы Больцмана k и Авогадро NA.
Вторая глава – «Пересыщения неравновесных растворов точечных дефектов при твердофазных реакциях на поверхности кремния. Следствия единой модели». Часть главы посвящена дальнейшему развитию модели путем формулировки ее следствий. Два важных следствия позволяют характеризовать уже не процесс генерации ТД при ТФР, а саму ТФР. Первое следствие по-новому определяет правило первой фазы в твердофазных системах с полифазной диаграммой состояния, второе – относится к количественной оценке энергии активации Еа ТФР. В литературе уже имеются несколько попыток формулировки правила первой фазы для образования силицидов металлов. Наиболее распространена формулировка, в соответствии с которой в системе M-Si первым зарождается силицид с наиболее высокой температурой плавления, соседствующий с самой легкоплавкой эвтектикой на фазовой диаграмме. Однако, это «правило» и другие имеющиеся эмпирические алгоритмы, по-видимому, справедливые в ряде частных случаев, не позволяет предсказать правильную фазу для ряда систем.
В диссертационной работе правило первой и последующих фаз формулируется на основе естественных термодинамических представлений: при равных кинетических факторах последовательность образования фаз, включая первую фазу, определяется наибольшей величиной уменьшения свободной энергии системы g при смене фаз в системе. Величина g в условиях смены фаз за счет ТФР, в рамках развиваемых представлений, в работе записана в виде
g = Hr - TSr+ g*el + gint,
где TSr, gint слагаемые, связанные соответственно с энтропией и энергией новых границ раздела. Как показывают численные оценки, для двух- и трехатомных молекул в большинстве ТФР в первом приближении можно ограничиться двумя наиболее значимыми по величине слагаемыми в этом выражении и записать
g Hr + g*el.
С учетом этого приближения, новая формулировка «правила первой фазы» примет вид: первой в бинарной системе А-В образуется та фаза АxВy из числа возможных, для которой алгебраическая сумма энтальпии реакции Hr и энергии нерелаксированных локальных упругих напряжений g*el, связанных с ТФР, будет наименьшей. Последующие фазы образуются по тому же правилу. В качестве примера, в работе представлены результаты расчета термодинамического стимула в виде суммы (Hr+g*el) для ряда ТФР в системах Сo-Si, V-Si, Ti-Si, Cr-Si, Ni-Si, Pt-Si и Mo-Si.
Второе следствие из разработанных модельных представлений касается энергии активации Eа ТФР. Предполагается, что завершенный ряд элементарных событий, приводящий к рождению молекулы новой фазы, включает: последний диффузионный скачок атома реагента в зону реакции, химическую реакцию между реагентами и возникновение локальных упругих напряжений, испускание неравновесного ТД. Такое предположение приводит к следующему полуэмпирическому выражению для Eа
Eа = EmA + (g*el + EfPD),
где EmA - энергия активации миграции атомов А через слой новой фазы в зону реакции, EfPD –энергия образования ТД соответствующего типа в ненапряженной решетке, – выход ТД на одну молекулу новой фазы. Приводятся результаты расчета Eа для некоторых ТФР в системах Ni-Si, Pt-Si и SiO2-Si с известными из литературы значениями EmA.
Кроме того, вторая глава посвящена расчету численных значений предельного пересыщения решетки ТД в кристалле под воздействием различных ТФР. Расчет проводится в качестве иллюстрации единства модельного подхода на примере более десятка различных ТФР на поверхности Si. В таблице 1 представлены расчетные значения некоторых параметров молекулярного уровня, введенных в первой главе, а также предельная степень пересыщения Si V или I () и тип прогнозируемых ТД. Все параметры рассчитаны для ТФР на поверхности Si в исходно твердофазных системах М-Si и в системах (О2, N)газ - Si.
Табл.1 Теоретические значения и молекулярные параметры ТФР на поверхности Si: Si - дисбаланс объемов размещения молекулы новой фазы в Si, g*el - величина нерелаксированных упругих напряжений, - коэффициент выхода ТД в пересчете на одну молекулу новой фазы.
| Cистема | ТФР | Si 1024 см3 | Si/1 (%) | ТД | g*el эВ | | | Т 0С |
| Ni – Si | 2Ni+Si=Ni2Si | -3,97 | -11,8 | V | 0,199 | 0,248 | 1,2·107 | 300 |
| Ni – Si | Ni2Si+Si = 2NiSi | -2,45 | -3,4 | V | 0,008 | 0,052 | 2,5·101 | 300 |
| Co-Si | 2Co+Si + Co2Si | -4,55 | -14,0 | V | 0,244 | 0,284 | 3,5·107 | 300 |
| Pt - Si | 2Pt + Si = Pt2Si | -3,01 | -7,7 | V | 0,102 | 0,188 | 3,4·103 | 500 |
| V - Si | 3V + Si=V3Si | -3,15 | -6,0 | V | 0,112 | 0,197 | 5,1·103 | 500 |
| Cr - Si | 3Cr+Si=Cr3Si | -3,02 | -6,3 | V | 0,104 | 0,189 | 1,3·104 | 400 |
| Ti - Si | Ti+Si=TiSi | -4,50 | -15,4 | V | 0,240 | 0,281 | 3,7·105 | 500 |
| Mo - Si | 3Mo+Si=Mo3Si | -4,62 | -9,0 | V | 0,252 | 0,293 | 2,8·104 | 700 |
| О - Si | Si+2О = SiО2 | +0,69 | +1,5 | I | 0,005 | 0,144 | 3.4·100 | 1200 |
| О - Si | Si+О=SiO | + 1,88 | +5,5 | I | 0,035 | 0,094 | 2,4·101 | 1200 |
| О - Si | SiO+О = SiО2 | -1,18 | -2,7 | V | 0,014 | 0,186 | 4,8·100 | 1200 |
| N - Si | 3Si+4N=Si3N4 | -19,03 | -28,1 | V | 1,269 | 1,009 | 9,0·103 | 1350 |
При расчетах g*el и приняты следующие значения: КSi=7,55·1010Па, SiV = 0,8Si=16·10-24 см3, SiI=20·10-24 см3.
В качестве демонстрации множественности реакций в системах с полифазной диаграммой состояния в таблице для системы Ni-Si представлены две последовательно реализующихся реакций. В остальных системах М-Si также реализуется не одна реакция, но для краткости таблицы они опущены.
На рисунке 5 величина пересыщения (Т) представлена в виде прямых Аррениуса как функция температуры (T)=С*/Со=exp(g*el/kT).
Все полученные в данной главе аналитические результаты в виде расчетных цепочек реакций и их энергии активации Eа, а также расчетные значения V и I сопоставлены с экспериментами. Результаты этих сопоставлений излагаются в следующей главе диссертации.

Рис. 5. Теоретические зависимости предельного пересыщения приповерхностной области Si неравновесными V (ТФР 1-10, 12) или I (ТФР 11, 13) под растущими слоями новой фазы при следующих ТФР:
(1) 2Co+Si=Co2Si, (2) Ti+Si=TiSi, (3) 2Ni+Si=Ni2Si,
(4) Ni+Si=NiSi, (5)3Cr+Si=Cr3Si, (6) 2Pt+Si=Pt2Si, (7) 3V+Si=V3Si, (8) NiSi+Si=NiSi2,
(9) 3Mo+Si=Mo3Si, (10) Ni2Si+Si=2NiSi,
(11) Si+0=SiO, (12) SiO+0=Si02, (13) Si + 20=Si02.
Таким образом, в первой и второй главе на примере ряда различных ТФР на поверхности Si с единых позиций выполнены численные расчеты парциального дисбаланса объемов размещения, энергии локальных упругих напряжений, коэффициента выхода ТД на одну молекулу новой фазы, предельных пересыщений приповерхностной области кристалла ТД, а также сделан прогноз типа ТД, ожидаемых при той или иной ТФР. Сформулированы следствия модельных представлений в виде нового правила последовательности образования фаз в системах с полифазной диаграммой состояния и в виде полуэмпирического выражения для энергии активации ТФР. В качестве иллюстрации возможностей этих следствий для ряда ТФР в системах М-Si рассчитаны термодинамические критерии появления фазы g = Hr + g*el, а также энергии активации Eа реакций.
Третья глава – «Сопоставление результатов модельной аналитики с экспериментом». Глава посвящена сопоставлению всех ранее теоретически рассчитанных параметров генерации ТД и характеристик ТФР с экспериментальными данными автора, а также данными, заимствованными из литературы.
С целью экспериментальной проверки предложенного правила образования первой и последующих фаз в соответствии с минимизацией алгебраической величины g = Hr + g*el, построены теоретические цепочки фаз для различных тонкопленочных структур М-Si. Эти цепочки для систем Co-Si, Ni-Si, V-Si, Pt-Si, Ti-Si, Mo-Si и Сr-Si имеют следующий вид:
(Co – Si) Co2Si (g = -0.72 эВ) CoSi (g = -0.71 эВ) CoSi2 ;
(Ni – Si) Ni2Si (g = -1.23 эВ) NiSi (g = -0.74 эВ) NiSi2 ;
(V – Si) VSi2 (g = -2.11 эВ);
(Pt – Si) Pt2Si (g = -1.94 эВ) PtSi (g = -1.57 эВ) PtSi2 ;
(Ti - Si) TiSi (g = -1.22 эВ) TiSi2 (g = -1.36 эВ);
(Mo- Si) Mo3Si (g = -0.044 эВ) Mo5Si3 (g = -1.31 эВ) … MoSi2 ;
(Cr - Si ) Cr2Si (g = -0.72 эВ) Cr5Si3 (g = -2.51 эВ) … CrSi2.
В скобках около очередной фазы указаны значения g, с которыми эта фаза «выиграла» у других фаз, указанное место в цепочке. Например, в соответствии с диаграммой состояния в системе Ni-Si на роль первой фазы в результате реакции из чистых компонентов, в принципе, могли бы претендовать фазы NiSi, Ni2Si и NiSi2. Однако, расчет g дает, что в этом случае изменение свободной энергии составит -1,226 эВ/молекулу для Ni2Si, -0,537 эВ/молекулу для NiSi и +0,609 эВ/молекулу для NiSi2. Это означает, что первой фазой в системе будет Ni2Si. Образование NiSi2 из чистых компонентов при ТФР вообще невозможно, в отличие, например, от VSi2.
Сопоставление этих последовательностей с экспериментальными данными многих исследователей, известными из различных литературных источников, показывают, что для всех исследованных систем последовательности фаз теоретически рассчитаны верно.
Выполненные в предыдущей главе оценки энергии активации Eа некоторых ТФР с известным значением EmA, в данной главе сопоставлены с экспериментальными результатами различных авторов. Сопоставление выполнено для твердофазных систем типа М-Si с тонкой пленкой металла (Таблица 2).
| Вид ТФР | Еатеор (эВ) | Еаэкспер (эВ) |
| 2Ni + Si=Ni2Si | 1,36 | 1,5 |
| NiSi + Si=NiSi2 | 1,31 | 1,3 |
| 2Pt+Si=Pt2Si | 1,46 | 1,3 |
| 2Co + Si = Co2Si | 1,76 | 1,5 |
| Si+20=Si02 | 1,32 | 1,27 |
| Si + 20H=Si02+H2 | 0,79 | 0,78 |
Табл.2. Сопоставление теоретических значений Eа = EmA + (g*el + EfPD) с экспериментальными данными.
Для случаев, когда экспериментальные значения EmA неизвестны и, следовательно, вычислить Eа невозможно, но известны экспериментальные значения Eа, в работе выполнен обратный расчет: для таких ТФР определены значения EmA, которые по мере постановки соответствующих опытов могут быть экспериментально проверены..
При сопоставлении предсказываемой природы ТД и степени пересыщения кристалла ТД (см. табл. 1) с экспериментом использованы экспериментальные данные, полученные в опытах по ускоренной диффузии примесных атомов и эволюции размеров ростовых и технологически вносимых дефектов известной природы в Si под растущими слоями силицидов металлов и окисных пленок SiO2. Результаты экспериментов проанализированы для систем Ni-Si, Co-Si, Pt-Si, V-Si, Ti-Si, SiO2-Si и Si3N4 – Si. Во всех случаях была найдено полное совпадение теории с экспериментом с точки зрения прогноза природы ТД и удовлетворительное совпадение степени пересыщения решетки ТД. В частности, экспериментально подтверждаются теоретически предсказанные колоссальные (102-106 раз) пересыщения кристаллической решетки неравновесными V при формировании слоев силицида металла. На рисунке 6 представлены результаты эксперимента автора по исследованию ускоренной диффузии Sb из подложки Si в эпитаксиальный слой Si в процессе роста слоя силицида ванадия на поверхности эпитаксиальной структуры.

Рис.6. Низкотемпературное (730оС) перераспределение атомов Sb (по данным вторичной ионной масс-спектроскопии) на границе раздела Si-epi Si под действием потока V, стимулированного ростом силицидов ванадия на поверхности эпитаксиальной структуры. Диффузия Sb ускорена примерно в 105 раз и соответствует диффузии в стандартных условиях при температуре 11000С.
Экспериментально подтверждаются теоретически полученные умеренные (2-4 кратные) пересыщения кристалла по I при термическом окислении Si. На рисунке 7 представлена совокупность данных по пересыщению кремния

Рис.7. Зависимость пересыщения СI/CoI кремния I при термическом окислении в сухом кислороде в соответствии экспериментальными данными по диффузии атомов бора (), фосфора () и роста ОДУ ()
I под растущими слоями SiO2 по данным литературных источников о диффузии атомов бора и фосфора, а также роста окислительных дефектов упаковки при термическом окислении кремния.
Что касается системы Si3N4 –Si, то, как и предполагалось, в ней, в отличии от термического окисления, происходит генерация не I, а неравновесных V и их концентрация лимитируется не термодинамически допустимым пересыщением, а кинетикой роста слоя новой фазы.
По итогам сопоставления развиваемых в работе теоретических положений с экспериментальными данными по более, чем десяти различных ТФР, можно сделать вывод об адекватности и универсальности разработанных модельных представлений. Несмотря на то, что модельные представления распространяются на различные виды моноатомных кристаллов, в качестве экспериментальной базы выбраны результаты, полученные на Si как наиболее совершенном и изученном кристалле, данные по которому статистически носят наиболее достоверный характер.
Четвертая глава раздела – «Эффекты в объеме кремния, сопутствующие твердофазным реакциям на его поверхности». Глава посвящена изучению некоторых процессов в объеме кристалла в условиях пересыщенных твердых растворов собственных ТД, появление которых обусловлено ТФР на поверхности кристалла. Перечень эффектов в объеме Si от ТФР на его поверхности в данной главе расширяется за счет экспериментальных исследований эффектов в ионно-имплантированных слоях и стимулированной экзоэлектронной эмиссии с поверхности кристалла.
Ионная имплантация In+ или Р+ проводилась в Si пластины, на обратной стороне которых заранее были сформированы тонкие слои хрома (Cr), силицида хрома CrSi2 или SiO2. Из трех видов представленных структур ТФР с тыльной стороны пластины следовало ожидать только в случае экспериментальных структур со слоем Сr. Остальные структуры выполняли роль контрольных образцов, в которых слои CrSi2 или SiO2 имитировали возможные макроскопические упругие напряжения в экспериментальных структурах во время отжига. Как видно из рисунка 8, именно в экспериментальных структурах, где одновременно с отжигом ионно-имплантированного слоя на лицевой стороне пластины протекала ТФР на обратной стороне той же пластины, восстановление электрической проводимости в ионно-имплантированных слоях начиналось уже в области 300оC, что на 100-150оС меньше температуры аналогичной точки для контрольных образцов.
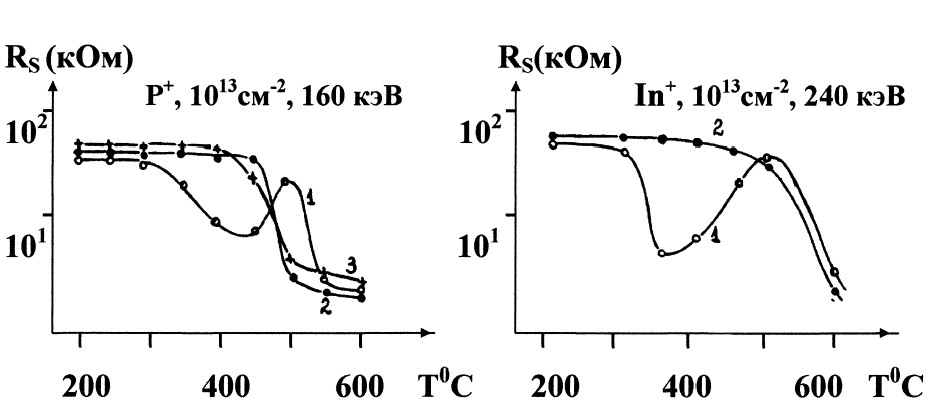
Рис.8. Динамика восстановления при изохронном отжиге (15 мин.) электрической проводимости ионно-имплантированных слоев в присутствии ТФР образования силицидов Cr на обратной стороне пластины (кривые 1)
Следует отметить, что температура начала ТФР в присутствии ионно-имплантированного слоя также была ниже и составляла примерно 300оC вместо характерных для нее 400оC.
На основании эксперимента и расчета сделан вывод о взаимном влиянии пространственно разнесенных ионно-имплантированных слоев и ТФР. Это влияние выражается в уменьшении температуры начала восстановления электрической проводимости имплантированных слоев и в понижении температуры начала ТФР. Обнаруженное взаимное влияние пространственно разделенных ионно-имплантированного слоя и области ТФР объяснено с позиций взаимодействия встречных потоков I радиационного происхождения, диффундирующих из ионно-имплантированного слоя на начальной стадии распада радиационных кластеров и потока неравновесных V, стимулированного ростом силицидов хрома на обратной стороне подложки.
Представлен количественный анализ решений диффузионного уравнения для I, полученных для двух различных граничных условий на обратной стороне пластины толщиной L. Первый вариант граничного условия CI(x=L)=0 соответствует ситуации в экспериментальных образцах и предполагает наличие вакансионного облака у обратной стороны пластины. Второй вариант - dCI/dxx=L=0 моделирует наличие отражающей для I границы на обратной стороне пластины и, по всей вероятности, соответствует контрольным структурам с пленкой SiO2. Показано, что число I, покидающих имплантированный слой во время отжига экспериментальных и контрольных образцов Q1 и Q2, определяется выражениями
Q1 =С0I{[DItq/th(qL)]+[exp(qL)-L]/q–[(ch(qL)-L)exp(qL)]/q sh(qL)},
Q2 = С0I (DItq + L/q) th(qL),
где C0I=CI(x=0), q=(А/DI)1/2 - параметр, А – коэффициент, учитывающий сток I на ненасыщающихся ловушках в объеме кристалла, DI – коэффициент диффузии I, t – время эксперимента. Численные оценки отношения Q1/Q2 в условиях поставленного эксперимента составляет от 1,5 до10, в зависимости от мощности центров перехвата А в объеме кристалла.
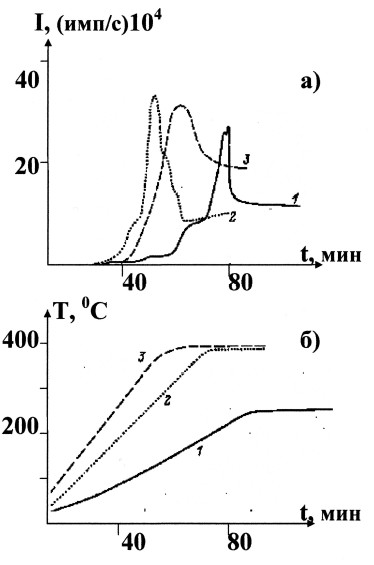
Эффект дальнодействия, вводимых за счет ТФР силицидообразования неравновесных V, подтвержден в эксперименте с экзоэлектронной эмиссией. Из литературных данных известно, что диффузионный сток ТД радиационного происхождения на поверхность кристалла вызывает экзоэлектронную эмиссию с этой поверхности.
Рис.9.Схема эксперимента и сигналы экзоэлектронной эмиссии с поверхности Si, коррелирующие с началом ТФР образования силицидов Pt (1), Ni (2) и Cr (3) на обратной стороне Si пластины.
В рамках диссертационной работы этот эксперимент повторен с точностью до замены ТД радиационного происхождения на ТД, генерация которых вызвана образованием силицидов платины Pt, никеля Ni или хрома Cr. Установлено (рисунок 9) резкое увеличение сигнала экзоэлектронной эмиссии, совпадающее с началом образования силицидов на обратной стороне пластины. Отмечается, что уровень сигнала экзоэлектронной эмиссии качественно коррелирует с расчетным соотношением вакансионного пересыщения решетки при формировании первых фаз в системах Pt - Si, Ni- Si и Cr-Si.
Таким образом, на примере ионно-имплантированных слоев и экзоэлектронной эмиссии получены дополнительные доказательства известного эффекта дальнодействия собственных ТД в Si. Показано, что целевое изменение состояния подсистемы собственных ТД в кремнии за счет ТФР может приводить к практически значимым результатам в области технологии ионной имплантации и технологии формирования слоев силицидов металлов. В частности, эти результаты могут быть положены в основу сознания методов отжига имплантированных слоев и создания слоистых гетерогенных структур при пониженных температурах.
Пятая глава – «Модель генерации неравновесных вакансий в условиях принудительного отбора матричных атомов с поверхности кристалла». Глава посвящена развитию классической модели Шоттки на случай неравновесных ситуаций, когда генерация вакансий в моноатомных кристаллах обусловлена принудительным отбором матричных атомов с поверхности кристалла. В рамках развиваемой теории, в частности, рассмотрены основополагающие требования к параметрам внешнего воздействия и к кристаллу, выполнение которых должно приводить к генерации неравновесных V.
Термодинамически равновесные V в объеме кристалла первоначально образуются либо в виде вакансии в поверхностном монослое кристалла (Vs), либо в его объеме в составе пары Френкеля (пара V и I). В последнем случае считается, что I диффундирует к поверхности и там достраивает излом атомарной ступени на поверхности кристалла, а V остается в объеме кристаллической решетки. Какой из этих двух механизмов в большей степени реализуется в той или иной ситуации зависит от типа решетки, кристаллографической ориентации поверхности и даже формы образца. Предметом нашего рассмотрения будет первый механизм, связанный с образованием Vs.
В составе развиваемых в диссертации модельных представлений выделим следующие положения. Во-первых, механизм удаления матричного атома под влиянием внешнего воздействия не должен сопровождаться образованием промежуточных твердых фаз с последующим их растворением. В противном случае речь идет об уже рассмотренной в предыдущем разделе диссертации ситуации. Такой механизм удаления атомов в работе назван механизмом прямого удаления. Для образования Vs необходимо, чтобы прямое удаление атома происходило по нормальному механизму из атомарно плоской террасы вицинальной грани кристалла, а не по тангенциальному механизму, например из излома поверхностной атомарной ступени, когда атомарная конфигурация поверхности самовоспроизводится и Vs не образуется (Рис.10).
Во-вторых, для перехода Vs в объем кристалла (Vs V переход), т.е. для генерации V по рассматриваемому механизму, необходимо, чтобы время жизни
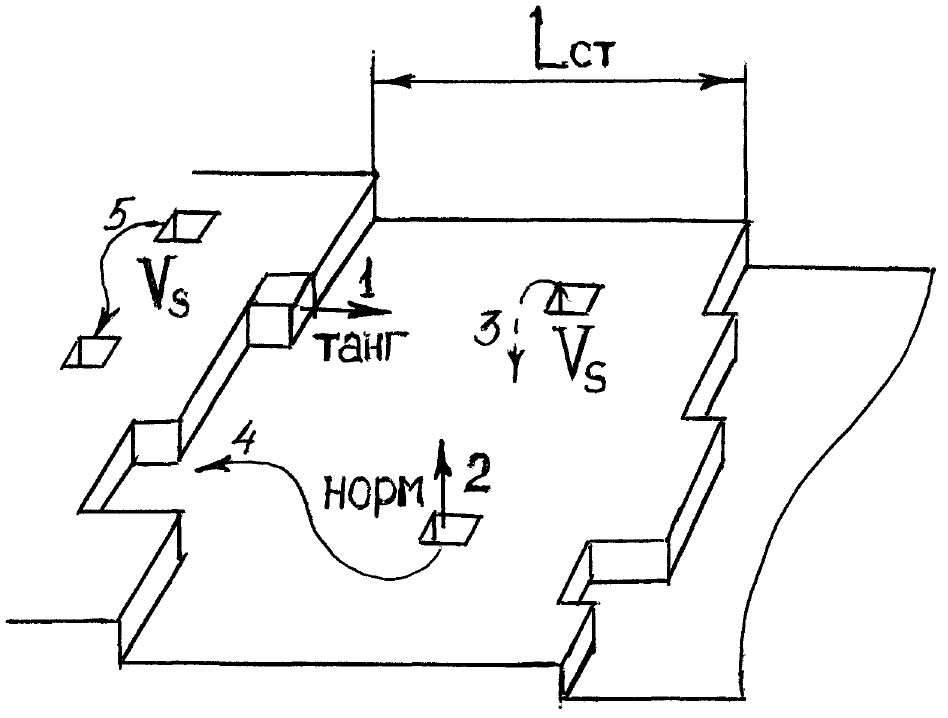
Рис.10 Тангенциальный механизма удаления поверхностного матричного атома (1), рождение Vs при нормальном механизме удаления атома (2), исчезновение Vs при ее переходе в объем кристалла (3), стоке на атомарную ступень вицинальной грани (4) или при взаимодействии (5) с другой Vs.
Vs вакансии на поверхности идеализированного кристалла было достаточно для такого перехода. Помимо перехода Vs V, значение Vs определяется также стоком Vs на изломы поверхностных ступеней и возможным их исчезновением при послойном удалении материала под влиянием внешнего воздействия. В связи с этим развиваемая модель предусматривает ограничения на микро- и макроскопическую скорость удаления моноатомных слоев, а также допустимую кристаллографическую разориентацию поверхности относительно атомарно гладких (сингулярных) поверхностей на угол.
Получены количественные оценки вероятности Р для перехода VsV, а также оценки потока JV неравновесных V с поверхности в объем кристалла как функции угла кристаллографической разориентации.
Вероятность P перехода VsV характеризует кинетическую открытость процесса генерации неравновесных V. Полученное в работе для нее выражение имеет вид
P=1– (1 – ts/tv )s/ts,
где ts, tv – периоды диффузионных скачков вакансии, соответственно на поверхности и в объеме, а s – характерное время диффузионного блуждания Vs вдоль поверхности. В этом выражении (1 – ts/tv ) - вероятность того, что Vs не «провалится» в объем в одном из посещаемых ею поверхностных узлов решетки.

Рис.11 Траектория движения поверхностной вакансии VS. Штриховая линия - потенциальная траектория движения VS без учета возможности их инжекции в объем кристалла
Величина (1– ts /tv ) s/t - вероятность того, что перехода Vs V не произойдет ни в одном из s/ts поверхностных узлов кристаллической решетки. Величина Р - искомая вероятность того, что V перейдет в объем кристалла хотя бы в одной из s/ts потенциально посещаемых ею поверхностных ячеек (Рис.11). В силу того, что энергия активации миграции вакансии на поверхности всегда меньше соответствующей энергии в объеме кристалла, значение = ts/tv много меньше единицы и, как правило, лежит в пределах 10-4 < < 10-2. С учетом малости величины и зависимости s от угла разориентации поверхности кристалла относительно сингулярной грани, выражение для Р представлено в виде
Р=1-ехр(-/3tg2),
где 1/3tg2 = ms – число потенциально возможных элементарных диффузионных скачков Vs до ее стока на атомарную ступень.
Элементарный инжекционный поток dJV неравновесных V c площадки dS=1·dl, удаленной от атомарной ступени на расстояние l, выражен через Р(l) как
dJv=gn·Р/(1+Р)dS,
где gn - скорость удаления атомов по норамальному механизму. После интегрирования полученного выражения по площади атомарно гладкой террасы среднестатистической длины Lтер, а также с учетом того, что на единице площади имеется n=a-1tg таких террас, получено приближенное выражение для потока V в объем решетки как функции угла разориентации вицинальной грани
Jv gna-1tg (12)-1/2 ·{(3)1/2(a)-1tg – (/2)1/2·erf[(3)1/2(a)-1tg]},
где erf(y)=(2/)0уexp(-x2/2)dx – функция ошибок. Показано, что при увеличении разориентации вицинальной грани, например c 0,5о до 4о, вероятность перехода Vs V уменьшается при =10-3 примерно в 15 раз, а поток вакансий в объем кристалла уменьшается примерно на порядок.
Представленные в данной главе результаты теоретических рассмотрений генерации V в неравновесных условиях носят достаточно общий характер и не привязаны к какому-либо конкретному воздействию, способному приводить к удалению поверхностных атомов кристалла. В тоже время, они достаточны, чтобы перейти к рассмотрению конкретных внешний воздействий данного класса, например, к химическому травлению кристалла и стимулированной сублимации матричных атомов.
Шестая глава – «Образование вакансий при стимулированном удалении поверхностных атомов путем прямого химического травления кристалла». Глава посвящена исследованию генерации неравновесных V при прямом химическом травлении как частном случае рассматриваемого класса физико-химических воздействий, приводящих к удалению матричных атомов кристалла.
Показано, что высокотемпературное газовое травление кристалла удовлетворяет основополагающим требованиям, предъявляемым к исследуемому классу внешних воздействий. Сформулировано дополнительное частное требование к кристаллу при этом виде воздействия. Оно накладывает еще одно ограничение на допустимую разориентацию поверхности кристалла относительно сингулярной грани. Это ограничение обусловлено необходимостью лимитировать сток на изломы атомарных ступеней адсорбированных атомов травителя. Ширина атомарно гладкой террасы сравнивается с диффузионной длиной пробега адсорбированного атома Lадс (Рис.12), которая определяется разностью энергии активации десорбции Едес и поверхностной миграции Еm атома травителя.
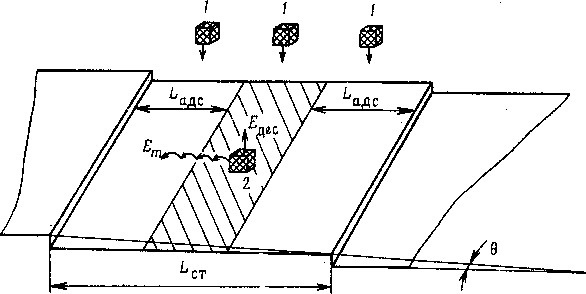
Рис.12 Центральная зона атомарно гладкой террасы вицинальной грани кристалла (заштрихована), разориентированной на угол ’, из которой адсорбированные атомы травителя не могут достигать изломов атомарных ступеней.
Полученное выражение для критического угла кристаллографической разориентации поверхности относительно сингулярной грани ’ в этом случае имеет вид
’ = (1/2) ехр [-(Eдec-Em)/(2kТ)].
Представлены результаты экспериментов автора, подтверждающие факт генерации неравновесных V в кристаллах Si при их высокотемпературном (1100-1150оС) химическом травлении в газовой смеси водорода с хлорсодержащими добавками. Методами DLTS исследованы следы вакансионного пресыщения кристалла в виде спектра комплексов ТД в n и p экспериментальных образцах Si, подвергнутых высокотемпературному травлению. Контрольные образцы прошли аналогичную термообработку, но не приводящую к удалению матричных атомов, а также низкотемпературное полирующее травление. Представленные в работе данные, указываюют на повышенное в 5-6 раз интегральное количество вакансий в составе комплексов в экспериментальных образцах в сравнении с контрольными.
Седьмая глава – «Генерация неравновесных вакансий при фотостимулированной сублимации поверхностных атомов» посвящена экспериментальному исследованию генерации V при фотостимулированной сублимации, представляющей еще один частный случай рассматриваемого класса физико-химических воздействий, но принципиально отличающийся от химического травления по физике удаления матричных атомов. Проведен анализ фотостимулированной сублимации с точки зрения выполнения общих требований и условий, предъявляемых к исследуемому классу воздействий. Показано, что под влиянием света ксеноновой лампы вероятность рождения Vs должна возрастать примерно в 103 раз. Представлены результаты экспериментальных исследований автора, подтверждающие факт генерации неравновесных V и в этом случае. Выполнена численная оценка фактически достигнутых пересыщений решетки Si по V.
В качестве индикатора на введение в кристалл неравновесных V выбрана диффузия атомов сурьмы (Sb) и бора (В) в Si. Такой индикатор реагирует на состояние подсистемы ТД кристалла непосредственно в процессе внешнего воздействия на кристалл, и поэтому позволяет судить о состоянии подсистемы собственных ТД in situ, а не по остаточным признакам, как это было в случае с газовым травлением. В роли экспериментальных и контрольных образцов использованы эпитаксиальные структуры, полученные методом молекулярной эпитаксии при температуре не выше 650оС на сильно легированной (1019 см-3) атомами Sb или В подложке Si. С учетом большого количества возможных артефактов при изучении диффузии примесей при фотонном облучении кристалла отличие между экспериментальными и контрольными структурами состояло лишь в точности кристаллографической ориентации поверхности этих структур. Поверхность экспериментальных структур была разориентирована относительно сингулярной грани кремния (111) на 0о20’, а контрольных структур – на 3о30’. Оба типа структур при Т=950оС были подвергнуты внешнему воздействию мощной ксеноновой лампы, обеспечивающей фотостимулированную сублимацию поверхностных атомов Si, которые оседали во время эксперимента на стенках кварцевого реактора, что подтверждало факт сублимации.
Методами вторичной ионой масс-спектроскопии показано, что диффузионное перераспределение примесных атомов в экспериментальных - точно ориентированных структурах, существенно выше, чем в контрольных, где введение неравновесных V, согласно развиваемой в диссертации теории, должно быть затруднено (Рис13).
СSb, (см-3)

Рис.13 Диффузионное перераспре-деление концентрации Sb СSb(см-3) на границе раздела подложки и эпитаксиальной структуры под действием фотостимулированной сублимации матричных атомов в зависимости от разориентации поверхности эпитаксиальных структур относительно (100): а) 3о30’, б) 0о20’.
Показано, что коэффициент диффузии Sb в экспериментальных структурах возрастал в 20, а В примерно в 3 раза. С учетом того, что Sb, как принято считать, на 100%, а В лишь на 20% диффундирует в Si по вакансионному механизму, оба результата означают, что достигнутое пересыщение решетки по V составляло =СV/СоV 20 раз.
Таким образом, генерация неравновесных вакансий экспериментально продемонстрирована на примере второго частного случая внешнего воздействия, приводящего к прямому удалению матричных атомов с поверхности кристалла. Подтверждено, что теоретически выдвинутое требование к точности кристаллографической ориентации поверхности кристалла с точки зрения генерации вакансий является существенным фактором. Совокупность экспериментальных данных о генерации неравновесных вакансий в Si при двух физически различных внешних воздействиях (травление и сублимация) подтверждает адекватность и общность развитых в данном разделе диссертации теоретических представлений.
Восьмая глава – «Особенности эволюции кластеров собственных дефектов в неравновесном двухкомпонентном растворе вакансий и междоузельных атомов». Глава посвящена исследованию процесса, сопутствующего введению в решетку неравновесных V: эволюции кластеров собственных ТД в кристаллах Si. Представлено развитие кинетической теории роста и распада кластеров собственных ТД на случай взаимодействия кластеров с двухкомпонентным твердым раствором V и I, а также на случай резко выраженных неизотермических процессов. Кластеры определены как достаточно большие взаимосвязанные агломераты вакансионного или внедренного типа, изменение числа частиц в которых на одну или несколько не приводит к резкому (т.е. качественному) изменению их свойств. Данное определение четко разграничивает понятие кластер, комплекс и примесный преципитат. Предполагается, что массовый баланс во времени на поверхности S кластера обеспечивают три процесса: тепловая эмиссия (G) частиц из кластера, и диффузионно-лимитируемая конденсация (RV и RI) на их активной поверхности V и I:
dm/dt = [-G ±(RV – RI)]S, m(0)=m0,
где знак ± определяется внедренной или вакансионной природой кластера. Построены кинетические уравнения диффузионно-лимитированного роста (распада) кластеров в вакансионно-междоузельном твердом растворе в изотермическом процессе, а также уравнения их эмиссионного распада при надкритических скоростях нагрева. Показано, что в двухкомпонентном растворе V и I кинетическое уравнение для радиуса кластера r в канонической форме удобно записать через пару С**V и С**I кинетически равновесных концентраций двухкомпонентного раствора в виде
r/t = ±(/) [(DI (С**I – СI) - DV (С**V – СV)].
Здесь комбинация кинетически равновесных диффузионных потоков
R**V + R**I = ±-1(DI С**I - DV С**V)
определяется эмиссией частиц из кластера: R**V + R**I = G
G=ms exp[-( Eb/kT)].
Комбинация фактических потоков частиц из раствора определяется реальными концентрациями СI,V в растворе
RV + RI= ±-1(DVСV - DIСI).
В представленных выражениях: ms - плотность частиц кластера на границе раздела с матрицей, - частота их тепловых колебаний, Eb – энергия связи частиц в кластере, – элементарный объем частицы кластера, - безразмерный коэффициент, зависящий от геометрии кластера. Отмечается, что введение в рассмотрение второй компоненты раствора приводит к появлению множественности кинетически равновесных состояний в подсистеме ТД для каждого типа кластеров.
При развитии теории эволюции кластеров в неизотермических условиях отмечается, что равновесная комбинация R**V + R**I = ms exp[-( Eb/kT)], определяющая эмиссионную составляющую массового баланса с точностью до ()-1, безынерционно следует за изменением температуры Т. Комбинация же фактических потоков ТД RV + RI, выражаемых через реальные концентрации раствора СI и СV, инерционна по отношению к изменению температуры Т. Именно вследствие этого, например, при резком понижении Т, возникают пересыщенные растворы и связанные с ними закалочные эффекты. Отмечается, что в обратной ситуации, когда происходит быстрый нагрев кристалла, должны возникать разбавленные растворы и как следствие – эмиссионный распад кластеров. Представлено количественное описание этой концепции.
Введено новое понятие «критическая скорость нагрева». Показано, что каждому сильносвязанному кластеру (Eb больше Eb среднестатистического источника ТД в кристалле) можно сопоставить свое значение критической скорости нагрева (dT/dt)кр, при превышении которой реальные концентрации ТД ниже кинетически равновесных значений и кластеры распадаются, даже если они обычно термостабильны в области текущих температур нагрева. Полученное выражение для критической скорости нагрева имеет вид:
(dT/dt)кр=(kT2)(D/)[(S01/Eb)+(S02/Eb)exp(E/kT)],
где E=Eb-Eb, S01, S02 - коэффициенты с размерностью см-1. Факт существования критической скорости нагрева подтвержден экспериментально в опытах с распадом А-кластеров при быстром фотонном отжиге.
По результатам исследований указывается на существование семи принципиально различных с точки зрения поведения кластеров неравновесных ситуаций в двухкомпонентном растворе ТД. Обсуждается реализация каждой из этих неравновесных ситуаций, в том числе с использованием разрабатываемых в диссертации методов управления подсистемой ТД.
Результаты данной главы позволяют адекватно объяснять и прогнозировать изменение дефектного фона в бездислокационных кристаллах под влиянием различных внешних воздействий, оказывающих влияние на подсистему собственных ТД кристалла, в том числе классов воздействий, исследуемых в диссертации.
Девятая глава – «Вторичные эффекты вакансионного легирования Si и GaAs» посвящена экспериментальным исследованиям вторичных эффектов от генерации неравновесных V за счет принудительного удаления матричных атомов с поверхности кристалла путем его химического и плазмо-химического травления. Несмотря на то, что теоретические основы введения неравновесных V за счет прямого химического травления были развиты для моноатомных кристаллов, в работе показано, что такой прием введения неравновесных V при некоторых условиях может быть распространен и на кристаллы GaAs. Основными объектами исследования в данной главе выступают исходные кристаллы и ионно-имплантированные слои.
Показано, что при условии введения неравновесных V в Si до процесса ионной имплантации примесей, при последующем его отжиге изменяется степень электрической активации амфотерной примеси (In), ее пространственное распределение и динамика отжига таких слоев в целом. При введение неравновесных V в кристалл непосредственно в процессе отжига ионно-имплантированного слоя Si изменение динамики отжига радиационных дефектов и степени активации внедренной примеси продемонстрировано на примере слоев, легированных In, В и P. Результаты интерпретируются с позиций модификации дефектного фона исходного кристалла или взаимодействия ТД радиационного происхождения с вводимыми in situ V. Отмечается, что когда V вводились в кристалл одновременно с отжигом имплантированного слоя, то они вводились с противоположной ионно-легированному слою стороны пластины, как и в аналогичном эксперименте с ТФР. В этот раз использовался другой метод их введения, связанный не с ТФР, а с плазмохимическим травлением. Однако, и в этом случае «эффект дальнодействия» получил подтверждение.
Методами рентгеновской дифракции, внешней фотоэмиссии и катодолюминесценции показано, что введение V по обеим подрешеткам GaAs приводит к улучшению показателей его структурного совершенства в слоях толщиной не менее 5 мкм. В этих слоях уменьшаются интегральная деформация решетки, понижается концентрация центров безызлучательной рекомбинации носителей заряда. Пропорциональное введение VAs и VGa при температурах (750оС), превышающих температуру конгруэнтного испарения GaAs, достигалось благодаря полирующему химическому травлению кристалла в условиях подпитки химически активной газовой среды парами As таким образом, чтобы стехиометрия поверхности во время травления не нарушалась.
При изучении ионно-легированных Si+ слоев в таким образом модифицированных кристаллах GaAs методами низкотемпературной (115К и 12К) катодолюминесценции, долговременной релаксации катодопроводимости, а также методами вольт-фарадных и холловских измерений был обнаружен ряд положительных изменений в их структурных и электрофизических свойствах. Увеличенные интегральная краевая катодолюминесценция (рис.14а), а также соотношение пиков центров SiGa, SiAs, SiAs-VAs и SiAs-VGa в низкотемпературных спектрах контрольных и экспериментальных образцов (рис. 14б) свидетельствуют об уменьшении центров безызлучательной рекомбинации и уменьшении атомов Si в нежелательных позициях As, где они проявляют акцепторные свойства.

Рис.14. Катодолюминесценция от ионно-легированных Si+ слоев GaAs в экспериментальных (1) и контрольных (2) образцах GaAs: а) краевая катодолюминесценция (=843нм, T=115К) как функция ускоряющего напряжения электронов U, и глубины их проникнове-ния; б) спектральная низкотемпературная (Т=12К) катодолюминесценция. Пики I1 - SiGa, I2 - SiAs, I3 - SiAs-VAs, I4 - SiAs-VGa.
С помощью измерения эффекта Холла показано, что подвижность электронов в экспериментальных образцах на 20-30% выше подвижности электронов в контрольных образцах, что чрезвычайно важно с прикладной точки зрения.
В выводах главы отмечается, что разработанные приемы введения в моноатомные кристаллы неравновесных V могут быть эффективно использованы на различных стадиях технологических процессов как в кремниевой технологии, так и в технологии, связанной с GaAs. Применительно к кристаллам GaAs следует отметить, что одновременное и пропорциональное введение в кристалл VAs и VGa приводит к существенному улучшению не только структурных и электрофизических свойств ионно-легированных Si+ слоев, но и к улучшению его люминесцентных характеристик.
Заключение
В диссертационной работе решена актуальная научная задача в области физики твердого тела, относящаяся к теоретическому и экспериментальному изучению управления параметрами подсистемы собственных точечных дефектов (ТД) в кристаллах. В рамках решения этой задачи впервые с единых позиций разработаны унифицированные модельные представления о генерации неравновесных ТД в кристаллах при двух достаточно широких классах физико-химических воздействий: твердофазных реакциях на поверхности кристалла и при воздействиях, приводящих к прямому удалению матричных атомов кристалла. Основные результаты разработанных теоретических положений подтверждены экспериментально с помощью аналитических методов исследования, а также при изучении процессов в объеме кристаллов, сопутствующих изучаемым внешним воздействиям.
По результатам выполненной работы можно сделать следующие выводы:
- Впервые разработана единая физическая модель образования неравновесных собственных точечных дефектов (ТД) в кристалле, генерация которых стимулирована твердофазными реакциями на его поверхности. Модель базируется на термодинамически выгодном размене энергии локальных упругих напряжений вокруг молекул новой фазы на границе раздела кристалла с растущим слоем новой фазы на энергию пересыщенного твердого раствора ТД. Предложенная модель способна с единых позиций на основе фундаментальных параметров фаз и без использования каких-либо подгоночных параметров описывать как параметры генерации ТД, так и важнейшие характеристики самой твердофазной системы.
- В рамках единой физической модели получены оригинальные аналитические выражения для основных параметров генерации собственных ТД в условиях твердофазных реакций на поверхности моноатомных кристаллов: для энергии образования ТД, предельной степени пересыщения твердого раствора ТД, кинетического фактора достижения термодинамически оправданных пересыщений, среднестатистического выхода ТД на одну молекулу новой фазы, а также для критерия прогноза природы генерируемых ТД.
- Теоретически показано, что рост силицидов металлов должен сопровождаться генерацией неравновесных вакансий не только в ранее экспериментально исследованных системах Ti-Si и Со-Si, но также в других системах М-Si (V-Si, Mo-Si, Ni-Si, Ti-Si, Cr-Si, Pt-Si), для которых были выполнены расчеты. Степень ожидаемого вакансионного пересыщения решетки кремния от системы к системе, а также в зависимости от образующейся фазы в конкретной системе варьируется в пределах 5-ти порядков величины. На примере систем V-Si, Ti-Si и Со-Si результаты расчетов подтверждены экспериментально.
- С позиций единой теории генерации ТД при твердофазных реакциях теоретически подтверждено, что в системе SiO2-Si для большинства типов реакции окисления должны рождаться собственные атомы в междоузлиях. Однако, в двухстадийной реакции окисления кремния, на стадии перехода окисла кремния в двуокись кремния, в системе могут образовываться неравновесные вакансии.
- Теоретически установлено, что процесс термического роста слоев нитрида кремния должен сопровождаться генерацией неравновесных вакансий. Показано, что среди всех исследованных структур - структура Si3N4-Si единственная, в которой кинетика лимитирует достижение термодинамически допускаемых пересыщений решетки неравновесными ТД.
- Получены аналитические выражения для энергии активации твердофазных реакций на поверхности моноатомных кристаллов. Для некоторых реакций в структурах Ni-Si, Pt-Si, Ti-Si, Со-Si, а также SiO2-Si выполнены количественные расчеты энергии активации роста ряда фаз или энергии миграции реагентов в зону реакции. Для реакций, по которым известны из литературы экспериментальные данные, результаты теории сопоставлены с экспериментом. Максимальное отклонение расчета от эксперимента не превышает 15%.
- Сформулировано новое правило определения первой и последующих фаз, образующихся в твердофазных системах с полифазной диаграммой состояния. С помощью полученного численного критерия расчетным путем выстроены последовательности фаз в структурах Со-Si, Ni-Si, V-Si, Pt-Si, Ti-Si, Mo-Si, Cr-Si, полностью совпадающие с экспериментальными данными различных авторов о чередовании фаз в структурах тонкая пленка металла – монокристалл кремния.
- На основе классической модели Шоттки в качестве развития ее положений на случай неравновесных ситуаций разработаны унифицированные модельные представления об образовании неравновесных вакансий при достаточно широком классе физико-химических воздействий, приводящих к удалению матричных атомов с поверхности кристалла. Такой класс воздействий, в частности, включает прямое травление и стимулированную сублимацию матричных атомов кристалла.
- Сформулированы общие требования к данному классу внешнего воздействия, накладывающие ограничения на механизм удаления матричных атомов, макро- и микроскорость удаления моноатомных слоев, а также на температуру процесса. Определены требования к объекту этого воздействия – кристаллу, в частности, требование по предельному углу кристаллографической разориентации его поверхности относительно направлений атомарно гладких плоскостей. Получена аналитическая зависимость вероятности перехода неравновесных поверхностных вакансий в объем кристалла и вакансионного потока от угла вицинальной грани.
- На примере высокотемпературного газового и плазмо-химического травления монокристаллического кремния, а также фотостимулированной сублимации матричных атомов кремния экспериментально подтверждена общность концепции и развитые положения модели Шоттки, включая факт генерации неравновесных V и зависимость эффективности их введения в кристаллическую решетку от кристаллографической разориентации поверхности кристалла относительно направления атомарно гладкой сингулярной поверхности. Показано, что достигаемая степень вакансионного пересыщения кристалла в случае этих воздействий не превышает 102 и, следовательно, на несколько порядков ниже, чем в среднем аналогичные вакансионные пересыщения при твердофазных реакциях.
- Получены новые примеры, подтверждающие «эффект дальнодействия» неравновесных вакансий в кремнии далеко за пределами диффузионного фронта их распространения. Показано, что вакансии, вводимые за счет плазмо-химического травления или образования силицидов металла (на примере силицидов хрома) с обратной стороны кремниевой пластины, способны оказывать влияние на динамику отжига ионно-имплантированных слоев и на экзоэлектронную эмиссию с лицевой стороны пластины толщиной в несколько сотен микрометров.
- Установлены эффекты в объеме кристаллов Si, обусловленные изменением состояния подсистемы собственных ТД за счет исследованных физико-химических воздействий на кристалл: изменение скорости диффузии примесных атомов в ионно-имплантированных слоях и на границе раздела подложка – эпитаксиальный слой; ускоренная электрическая активация внедренной примеси и отжиг сопутствующих имплантации радиационных дефектов; изменение спектра комплексов дефектов и эволюция кластеров, включая ускоренный распад термостабильных кластеров внедренного типа различной природы. Установленные эффекты могут быть использованы при разработке низкотемпературных технологий создания легированных слоев и технологий геттерирования.
- Обнаружен технологически значимый эффект понижения температуры начала твердофазных реакций за счет in situ введения в кристалл ТД, природа которых противоположна природе ТД, генерация которых должна сопровождать эту реакцию. Эффект продемонстрирован на примере образования начальных фаз силицидов хрома при температуре 3000С, которая примерно на 100оС ниже характерных температур образования этих фаз в стандартных условиях эксперимента.
- Представлен комплекс практически значимых эффектов улучшения структурного совершенства, люминесцентных и электрофизических характеристик исходных кристаллов полуизолирующего GaAs и ионно-легированных Si+ слоев на его основе. Показано, что за счет предварительного введения в кристалл вакансий по подрешеткам Ga и As при газовом химическом травлении поверхности исходных кристаллов в условиях поддержания стехиометрии их состава, может быть достигнуто увеличение подвижности электронов в них более, чем на 25%.
Разработанные теоретические представления отличаются универсальностью с точки зрения широты охвата разновидностей внешних воздействий на кристалл, а также с точки зрения набора параметров и характеристик процессов в кристалле, которые они описывают. Важный результат диссертационной работы заключается в возможности теоретического прогноза перечисленных параметров. Созданный комплекс численных оценок может быть использован не только для анализа уже экспериментально известных ситуаций, но также для прогноза еще не изученных или даже гипотетических сочетаний воздействий и кристаллов. Он позволяет предвидеть важнейшие положительные или негативные эффекты в объеме кристалла.
С точки зрения практической полезности важно отметить, что исследованные подходы к целенаправленному раздельному введению в кристалл вакансий или собственных междоузлий хорошо совместимы с известными технологическими приемами. В силу этого, полученные результаты могут быть использованы для совершенствования технологии в области микроэлектроники или в других областях современной техники, например, при разработке новых покрытий, слоистых систем, в том числе на основе новых или малоизученных кристаллических материалов.
Полученные в рамках диссертационной работы результаты опубликованы в следующих статьях, материалах конференций и авторских свидетельств:
- Итальянцев А.Г., Мордкович В.Н. Трансформация размеров кластеров собственных точечных дефектов в полупроводниках. Физика и техника полупроводников, 1983, т.17, в.2, с.217-222.
- Итальянцев А.Г., Мордкович В.Н. Эмиссионная модель аннигиляции агломератов точечных дефектов в условиях быстрого нагрева кристалла. Журнал технической физики, 1983, т.53, в.5, с.937-939.
- Смульский А.С., Итальянцев А.Г., Авдеев И.И., Мордкович В.Н. Термообработка кремния и проблема ликвидации дефектов его структуры при создании полупроводниковых приборов и ИС. Электронная техника, 1983, сер.2, в.3/162/, с.62-69.
- Итальянцев А.Г., Мордкович В.Н., Темпер Э.М. О роли атермических процессов в импульсном отжиге ионно-имплантированных слоев кремния. Физика и техника полупроводников, в.5, 1984, с.928-930.
- Вяткин А.Ф., Итальянцев А.Г., Копецкий Ч.В., Мордкович В.Н., Темпер Э.М. Перестройки дефектов структуры полупроводников, стимулированные химическими реакциями на поверхности кристалла. Поверхность, 1986, №11, с.67-72.
- Итальянцев А.Г., Митюхляев В.Б., Пащенко П.Б., Файфер В.Н. Влияние химически стимулированного введения вакансий в GaAs на свойства ионно-легированных кремнием слоев. Поверхность, 1988, №11, с.93-98.
- Ерохин Ю.Н., Итальянцев А.Г., Мордкович В.Н. Новый механизм ионизационно-стимулированного воздействия на радиационные дефекты в имплантированных полупроводниках. Письма в Журнал технической физики, 1988, т.14, в. 9, с.835-838.
- Итальянцев А.Г., Краснобаев Л.Я., Кузнецов А.Ю., Мордкович В.Н. Стимулированный отжиг ионно-имплантированного кремния при твердофазной реакции силицидообразования металлов. Письма в Журнал технической физики, 1988, т.14, в.13, с.1178-1182.
- Итальянцев А.Г., Краснобаев Л.Я., Кузнецов А.Ю., Омельяновская Н.М., Хмельницкий С.Г. Эффекты в полупроводниках при введении неравновесных вакансий. Электронная техника, сер.6, вып.4(241), 1989, с.43-48.
- Итальянцев А.Г., Кузнецов А.Ю., Пантелеев В.А. Экзоэлектронная эмиссия с поверхности кремния, стимулированная образованием силицидов металлов. Эффект дальнодействия. Письма в Журнал технической физики, т.15, вып.11, 1989, с.27-30.
11. Омельяновская Н.М., Итальянцев А.Г., Краснобаев Л.Я., Астахова Е.Ф. Глубокие уровни в n-Si, вводимые при высокотемпературном газовом травлении. Физика и техника полупроводников, т.23, в.8, 1989, с.1503-1505.
12. Омельяновская Н.М., Итальянцев А.Г., Краснобаев Л.Я., Астахова Е.Ф. Образование глубоких уровней в р-Si при газовом травлении в хлорсодержащей атмосфере. Физика и техника полупроводников, т.24, в.11, 1990, с.2040-2043.
13. Итальянцев А.Г. Генерация вакансий, стимулированная химическим травлением поверхности кристалла. Поверхность, 1991, в.10, с.122-127.
- Итальянцев А.Г., Лойко Н.Н. Эффект фотостимулированной диффузии примеси в объеме кремния. Письма в Журнал технической физики, т.20, вып.23, 1994, с.26-29.
- Buravlev A.V., Vjatkin A.F., Italyantsev A.G., Krasnobaev L.Y., Mordkovich V.N. Solid phase epitaxial regrowth of amorphus ion implanted Si layers in the presence of point defects flow. Nuclear Instruments and Metods in Physics Research, B39 (1989), pp.366-369.
16. Italyantsev A.G. Solid-phase reaction on silicon surface. Accompanying processes.
J. Appl. Phys., 79 (5), 1996, pp.2369-2375.
- Italyantsev A.G., Kuznetsov A.Yu. Possible mechanism of the stress evolution and point defects generation during the solid phase epitaxial silicides growth. Mat. Res.Soc.Symp.Proc., 1990, v.238, pp.90-96.
- Italyantsev A.G., Kuznetsov A.Yu. Point defects generation at the silicon-growing silicide layer interface. Proc. Thir. Int.Conf. «Metallization in ULSI Application», Murray Hill, NJ, 1991, pp.181-187.
19. Итальянцев А.Г. Взаимодействие собственных точечных дефектов с их кластерами в элементарных полупроводниках при внешних воздействиях. В сб.: «VI Конференция по процессам роста и синтеза полупроводниковых кристаллов и пленок», Новосибирск, 1982, т.II, с.19-20.
20. Итальянцев А.Г., Мордкович В.Н., Смульский А.С., Темпер Э.М. Химическая стимуляция перестройки дефектов в кремнии. В сб.: Всесоюзная конференция по радиационной физике полупроводников и родственных материалов, Ташкент, 1984, с.179.
21. Итальянцев А.Г., Мордкович В.Н., Ерохин Ю.Н. Роль индуцированных светом электрических полей в фотостимулированных перестройках радиационных дефектов в полупроводниках. В сб.: Всесоюзная конференция «Ионно-лучевая модификация материалов», Черноголовка, 1987, с.127.
22. Мордкович В.Н., Итальянцев А.Г., Кузнецов А.Ю., Краснобаев Л.Я. Взаимное влияние отжига ионно-имплантированных слоев и образования силицидов металлов. В сб.: Всесоюзная конференция «Ионно-лучевая модификация материалов», Черноголовка, 1987, с.129.
23. Итальянцев А.Г., Митюхляев В.Б., Пащенко П.Б., Файфер В.Н. Свойства ионно-легированных слоев GaAs, подвергнутого предварительному термохимическому воздействию. В сб.: Всесоюзная конференция «Ионно-лучевая модификация материалов», Черноголовка, 1987, с.130.
24. Итальянцев А.Г., Краснобаев Л.Я., Мордкович В.Н., Омельяновская Н.М., Пащенко П.Б. Влияние предварительно сформированного фона собственных дефектов на характеристики ионно-имплантированных полупроводников. В сб.: Всесоюзная конференция «Ионно-лучевая модификация материалов», Черноголовка, 1987, с.132.
25. Мордкович В.Н., Итальянцев А.Г., Краснобаев Л.Я., Кузнецов А.Ю. Особенности формирования силицидов металлов при сильном пересыщении кристалла собственными точечными дефектами. В сб.: XII Всесоюзная конференция по микроэлектронике, Тбилиси, 1987, т.VII, с. 71-72.
26. Итальянцев А.Г. Условия легирования полупроводников неравновесными термохимическими вакансиями. В сб.: Всесоюзная конференция по физико-химическим основам легирования. Москва, 1988.
27. Итальянцев А.Г., Краснобаев Л.Я., Кузнецов А.Ю., Мордкович В.Н., Хмельницкий С.Г. Эффекты в полупроводниках при введении неравновесных вакансий. В сб.: Всесоюзная конференция по физико-химическим основам легирования. Москва, 1988.
28. Итальянцев А.Г., Михайлов Г.Б., Мордкович В.Н. О трансформации дефектов структуры в ионно-имплантированных полупроводниках при импульсном отжиге. В сб.: « 7 Международная конференция по ионной имплантации в полупроводниках и других материалах», Вильнюс, 1983, с.127-128.
29. Итальянцев А.Г. Эффекты в кремнии, обусловленные химическими реакциями на его поверхности. В сб.: « 5 Международная конференция по актуальным проблемам физики, материаловедения, технологии и диагностике кремния, нанолегированных структур и приборов на его основе «Кремний – 2008», Черноголовка, 2008, с.159.
30. Italyantsev A.G., Mordkovich V.N. Peculiarities of defect rearrgement in semiconductor structure upon pulse photon annealing. International Conf. EPM-87, Dresden, GDR, 1987, p.4.15.
31. Italyantsev A.G., Mordkovich V.N., Krasnobaev L.Y. The effect of chemical action on the impurity behavior in highly irradiated in implanted layers. International Conference EPM-87, Dresden, GDR, 1987, p.10.7.
32. Italyantsev A.G., Mordkovich V.N. Chemical stimulated defect rearrgement in GaAs structure. International Conf. E-MRS-87, Strasbourg, France, 1987, p.B-1.6.
33. Italyantsev A.G., Mordkovich V.N. Photoinduced defect rearrgement in ion-implanted silicon. International Conf. E-MRS-87, Strasbourg, France, 1987, p.A-1.5.
34. Buravlev A.V., Vjatkin A.F., Italyantsev A.G., Krasnobaev L.Y., Mordkovich V.N. Solid phase epitaxial regrowth of amorphus ion implanted Si layers in the presence of point defects flow. Thesises of Reports International Conf. IBMM-88, Japan.
35. Buravlev A.V., Italyantsev A.G., Vasin A.S. A new solid-phase recrystallisation effect of ion amorfphized Si under high pressure. Internation Conference on ion implantation and ion beam equipment (I3BE), 1990, Elenita, Bulgaria.
36. Italyantsev A.G., Kuznetsov A.Yu. Computer simulation of the point defects distribution, injected into silicon through the advancing silicide-silicon interfase. CAMCE-92, 1992, p.127, Yokogava, Japan.
37. Italyantsev A.G., Kuznetsov A.Yu. Vacancy flux enhanced diffusion of Sb in n+-n-Me structures during surface silicides formation: new experimental data and quantitative model. MRS Spring Meeting, 1992, p.91.
38. Еnisherlova К.L., Italyantsev A.G., Tkacheva T.M. The thermodynamical model of the internal guttering in Si. 11th Scintific and Business Conference “Silicon 2008”, November, 2008, pp.257-269.
39. Смульский А.С., Мордкович В.Н., Итальянцев А.Г. Авторское свидетельство № 820528, приоритет от 21.12.1979. Способ создания структур Si-SiO2.
40. Итальянцев А.Г., Мордкович В.Н., Смульский А.С., Енишерлова К.Л., Иноземцев С.А. Авторское свидетельство №1088593 с приоритетом от 19.11.1982. Способ термообработки кремния и кремниевых структур.
41. Курбаков А.И., Трунов В.А., Рубинова Э.Э. Итальянцев А.Г., Мордкович В.Н., Смульский А.С., Вахрушев С.Б., Квятковский Б.Е. Авторское свидетельство №1195831 с приоритетом от 07.04.1984. Способ изготовления монохроматоров тепловых нейтронов из монокристаллического кремния.
42. Аветесян Г.Х., Кузнецов Ю.А., Итальянцев А.Г. Авторское свидетельство №257176 с приоритетом от 27.03.1986. Способ изготовления мишеней видиконов на основе фосфида галлия.
43. Итальянцев А.Г., Мордкович В.Н., Вяткин А.Ф., Копецкий Ч.В., Пащенко П.Б. Авторское свидетельство с приоритетом от 18.11.1986. Способ изготовления приборных структур на основе монокристаллического GaAs.
44. Смульский А.С., Итальянцев А.Г., Мордкович В.Н. Новая методика ликвидации ростовых и технологически вносимых дефектов структуры кремния при создании ПЗС. В сб.: «Приборы с зарядовой связью. Технология и применение», Москва, 1983, с.32-33.
45. Итальянцев А.Г., Мордкович В.Н. Ускоренный распад кластеров собственных точечных дефектов при импульсном нагреве кристалла. Препринт Института проблем технологии микроэлектроники АН СССР. Черноголовка, 1986, 25 с.

