Разработка и применение физико - топологической модели мощного полевого транзистора с барьером шоттки и моделей микрополосковых линий для проектирования монолитных и квазимонолитных свч схем на арсени
ГОСУДАРСТВЕННОЕ ОБРАЗОВАТЕЛЬНОЕ УЧРЕЖДЕНИЕ
ВЫСШЕГО ПРОФЕССИОНАЛЬНОГО ОБРАЗОВАНИЯ
«НОВОСИБИРСКИЙ ГОСУДАРСТВЕННЫЙ ТЕХНИЧЕСКИЙ
УНИВЕРСИТЕТ»
На правах рукописи
Раков Юрий Николаевич
РАЗРАБОТКА И ПРИМЕНЕНИЕ ФИЗИКО - ТОПОЛОГИЧЕСКОЙ
МОДЕЛИ МОЩНОГО ПОЛЕВОГО ТРАНЗИСТОРА С БАРЬЕРОМ
ШОТТКИ И МОДЕЛЕЙ МИКРОПОЛОСКОВЫХ ЛИНИЙ ДЛЯ
ПРОЕКТИРОВАНИЯ МОНОЛИТНЫХ И КВАЗИМОНОЛИТНЫХ
СВЧ СХЕМ НА АРСЕНИДЕ ГАЛЛИЯ
Специальность
05.27.01 «Твердотельная электроника, радиоэлектронные
компоненты, микро- и нано- электроника, приборы на
квантовых эффектах»
Автореферат
диссертации на соискание ученой степени
кандидата технических наук
Новосибирск-2009
Работа выполнена в ОАО «Октава» (г. Новосибирск) и Новосибирском государственном техническом университете.
Научный руководитель автора доцент, кандидат технических наук
Данилов Вячеслав Семенович
Официальные оппоненты: доктор технических наук
Айзенштат Геннадий Исаакович
доцент, кандидат технических наук
Макаров Евгений Афанасьевич
Ведущая организация: ЗАО «НПФ «Микран»» г. Томск.
Защита диссертации состоится 24декабря в 11 час. 00 мин. на заседании диссертационного совета Д212.173.03 при Новосибирском государственном техническом университете по адресу: 630092, г. Новосибирск, пр. К.Маркса 20.
С диссертацией можно ознакомиться в библиотеке Новосибирского государственного технического университета.
Автореферат разослан « 24» ноября 2009г.
Ученый секретарь диссертационного совета
профессор, доктор технических наук
Корнилович Александр Антонович
ОБЩАЯ ХАРАКТЕРИСТИКА РАБОТЫ
Актуальность работы
Монолитные интегральные схемы СВЧ на основе арсенида галлия (МИС) интенсивно развиваются свыше 20 лет в России и за рубежом. В последние 5 лет начато широкое внедрение МИС СВЧ в военную технику, космические аппараты, спутниковое телевидение и сотовую индивидуальную связь.
Объединение в МИС СВЧ на кристалле активных и пассивных элементов, использующих диэлектрические свойства i-GaAs при толщинах подложки 75 - 125мкм, позволяет существенно сократить габариты и массу ИС и, в целом, радиоэлектронной аппаратуры СВЧ. Малые размеры ИС позволяют применить при изготовлении СВЧ МИС групповые полупроводниковые технологии и реализовать массовый выпуск идентичных СВЧ изделий, столь необходимых, например, при создании активных антенных фазированных решеток РЛС.
Высокая стоимость полупроводниковой технологии и отсутствие возможности индивидуальной подстройки выдвигают повышенные требования к точности проектирования МИС СВЧ. Эффективность компьютерных средств расчета МИС СВЧ на арсениде галлия определяется точностью заложенных в них моделей СВЧ активных и пассивных элементов. К моделям элементов, используемых в программах инженерного расчета для анализа и оптимизации МИС СВЧ, также предъявляются жесткие требования по использованию ресурсов ЭВМ и расчетного времени.
Цель работы
Цель работы заключалась в исследовании, разработке и применении физико-топологической модели (ФТМ) интегрального полевого транзистора с барьером Шоттки (ПТШ), а также моделей одиночной и связанных микрополосковых линий (ОМПЛ и СМПЛ) при проектировании СВЧ МИС и квазимонолитных интегральных схем (квази-МИС) на арсениде галлия.
Для реализации поставленной цели необходимо решить следующие задачи:
1) Провести анализ существующих ФТМ и электрических моделей СВЧ ПТШ на GaAs с точки зрения их применимости в инженерных расчетах МИС СВЧ;
2) Разработать ФТМ интегрального GaAs ПТШ, программу расчета ВАХ и элементов СВЧ эквивалентной схемы (ЭС) ПТШ и методику определения физических параметров для ФТМ;
3) Провести анализ существующих моделей ОМПЛ и СМПЛ с точки зрения их применимости при проектировании МИС СВЧ на GaAs. При необходимости, разработать такие модели;
4) Встроить разработанные модели МПЛ на GaAs в программу расчета СВЧ схем «ДИСАПР», разработанную в ОАО «Октава»;
5) Применить разработанные модели МПЛ, ФТМ и электрическую модель ПТШ в разработках усилителей мощности (УМ) диапазона СВЧ.
Научная новизна работы
1. Разработана новая модель ОМПЛ в квази-ТЕМ- приближении, которая рассчитывает эффективную диэлектрическую проницаемость (ЭДП) с погрешностью 2% и потери СВЧ мощности в МПЛ с погрешностью 12% в диапазоне частот до 24ГГц (включая случай малых отношениях ширины линии к толщине подложки w/h и больших r). В модели учтены дисперсионные характеристики ЭДП и волнового сопротивления (ВС) МПЛ.
2. Разработана новая модель двухпроводной СМПЛ в квази-ТЕМ- приближении, которая не содержит эмпирических коэффициентов, как модель S. Akhtarzad et al., и описывает характеристики СМПЛ на различных подложках. Впервые получены аналитические выражения для потерь в полосках СМПЛ. В модели учтены дисперсия ВС и ЭДП.
3. Впервые разработана модель направленного ответвителя (НО) Ланге, в которой учитываются потери и дисперсия ВС и ЭДП. Модель адекватно отображает в диапазоне частот до 18ГГц измеренные характеристики НО на подложках GaAs МИС и гибридных интегральных схем (ГИС).
4. Разработана аналитическая ФТМ мощного субмикронного ПТ с барьером Шоттки (БШ) с однородно легированным каналом и идеально изолированной подложкой, которая из электрофизических параметров GaAs, конструкции и геометрии мощного многоштыревого ПТШ позволяет рассчитать ВАХ и элементы малосигнальной СВЧ ЭС в наклонной и пологой частях ВАХ в следующих режимах работы ПТШ: управления током канала областью пространственного заряда (ОПЗ) БШ; прямого включения БШ, аналитическая модель которого впервые предложена автором, и запирания канала. Впервые в аналитической модели ПТШ учитывается явление саморазогрева канала токами стока и затвора, что позволяет рассчитывать характеристики ПТШ в диапазоне температур окружающей среды 150 - 600°K.
5. Показана возможность использования модели ПТШ без учета баллистического всплеска скорости дрейфа электронов для расчета характеристик GaAs и GaN ПТШ с длинами затвора вплоть до 0,2мкм.
Практическая значимость работы
1. Разработана система определения электрофизических параметров для ФТМ ПТШ на GaAs (входных данных программы «WAXNEW»), которая включает:
– собранную автором из опубликованных теоретических и экспериментальных исследований базу данных по транспортным и другим электрофизическим свойствам легированного GaAs n-типа в широком диапазоне температур;
– разработанный автором метод экспериментального определения профилей легирования и подвижности электронов в канале под затвором ПТШ, позволяющий определить параметры моно- и гетероструктур со сверхтонкими слоями. Метод внедрен в производство квази-МИС СВЧ на GaAs на предприятии ОАО «Октава»;
– разработанный автором метод определения параметров омических контактов с учетом различия слоевого сопротивления полупроводника между омическими контактными площадками и под самим омическим контактом;
– метод определения параметров БШ.
2. Точность разработанной модели ПТШ проверена по данным измерений статических и динамических характеристик СВЧ GaAs ПТШ, полученных как в процессе собственных, так и заимствованных из публикаций исследований. Полученное соответствие измеренных и рассчитанных по модели характеристик GaAs ПТШ при прямом и обратном монтаже кристалла позволяет достоверно прогнозировать СВЧ характеристики МИС и квази-МИС УМ на GaAs в диапазоне частот до 18ГГц;
3. Совместно с сотрудниками ИФП СО РАН разработаны с использованием технологии молекулярно-лучевой эпитаксии мощные ПТШ на структуре «аналог-САГМК» и гетероструктурные ПТ (ГСПТ) двух типов: ГСПТ на структуре AlGaAs/GaAs (HFET) и псевдоморфный ГСПТ с легированной квантовой ямой на структуре AlGaAs/InGaAs/GaAs-AlGaAs (PHEMT), обеспечивающие в диапазоне частот 12-18ГГц уровень удельной выходной мощности Рвых=0,8-1,2Вт/мм. ГСПТ использованы в квази-МИС УМ в диапазоне частот 2-18ГГц;
4. С использованием разработанных моделей МПЛ и GaAs ПТШ на основе балансного сложения СВЧ мощности делителями / сумматорами Ланге и технологии изготовления УМ, основанной на конструкции «чипы на макрочипе» и унифицированном ряде интегральных СВЧ GaAs ПТШ, созданы квази-МИС УМ на GaAs в диапазоне частот 2-18ГГц с уровнями выходной мощности Рвых=150-2000мВт и коэффициента усиления Кур=4-16дБ;
5. Разработанная модификация метода упрощенных тепловых эквивалентов, позволяющая рассчитывать тепловые сопротивления мощных СВЧ транзисторов и элементов монолитных и гибридных ИС, подтверждена экспериментальными данными, полученными автором и заимствованными из публикаций. Метод внедрен в ОАО «Октава» при оценке надежности конструкций квази-МИС СВЧ на GaAs.
Личный вклад автора
Личный вклад автора включает формулировку целей исследований ПТ и гетероструктур, выбор путей достижения целей и методик исследований, анализ полученных результатов. Результаты по моделям и моделированию МПЛ, НО Ланге, ФТМ GaAs ПТШ и методике определения электрофизических параметров структур получены лично автором. Автором разработана программа «WAXNEW». Разработка программ расчета СВЧ монолитных схем «ДИСАПР-2» и «SAPR» выполнена автором (в части моделей пассивных элементов) совместно с В.И. Гуляевым и А.Ф. Скрипниковой. Методика и программа обработки профилей легирования и дрейфовой подвижности электронов в гетероструктурах «PROFIL» разработаны лично автором. Измерения параметров ПТШ (кроме S-параметров) и ГСПТ выполнены автором вместе с сотрудниками ОАО «Октава» – Н.В. Мончарес., Г.Ф. Узельманом и А.А. Шагабутдиновым. Разработка GaAs ПТШ и ГСПТ выполнена по инициативе автора вместе с сотрудниками ОАО «Октава» – Н.В. Мончарес, Л.В. Щепиной и ИФП СОРАН – А.И. Тороповым, К.С. Журавлевым. Разработка квази-МИС УМ СВЧ выполнена лично автором (УМ диапазона частот 9-12ГГц) и вместе с сотрудниками ОАО «Октава» Ю.Б. Мякишевым и В.А. Подухом (УМ диапазона частот 12-18ГГц), Е.Л. Павловым (унифицированный ряд УМ диапазона частот 4-18ГГц) и Г.С. Зыковой, В.Г. Будаковым и А.Г. Зайцевым (УМ диапазона частот 8-18ГГц). Изготовление и измерение образцов квази-МИС УМ СВЧ выполнены совместно с группой сотрудников ОАО «Октава». Анализ и обобщение результатов разработок УМ СВЧ выполнен лично автором. В написании диссертации неоценимую помощь оказал научный руководитель автора – доцент НГТУ, к. т. н. В.С. Данилов.
Научные положения, выносимые на защиту
1. Модели одиночной МПЛ и двухпроводной СМПЛ в квази-ТЕМ- приближении с учетом потерь мощности и дисперсии ВС и ЭДП.
2. Модель НО Ланге с учетом потерь мощности и дисперсии ВС и ЭДП.
3. Аналитическая ФТМ мощного субмикронного ПТШ с однородно легированным каналом и идеально изолированной подложкой, которая из электрофизических параметров GaAs и геометрии многоштыревого ПТШ позволяет рассчитать ВАХ и элементы малосигнальной ЭС ПТШ в наклонной и пологой частях ВАХ с учетом явления саморазогрева токами в канале в следующих режимах: управления током канала ОПЗ БШ, прямого включения БШ и запирания ПТШ.
4. Результаты разработки мощных ПТШ на структуре «аналог-САГМК» и ГСПТ двух типов: ГСПТ на структуре AlGaAs/GaAs и псевдоморфного ГСПТ с легированной квантовой ямой на структуре AlGaAs/InGaAs/GaAs-AlGaAs, обеспечивающих в диапазоне частот 12-18ГГц удельную выходную мощность 0,8-1,2Вт/мм.
5. Результаты разработки квази-МИС УМ на GaAs, обеспечивающие в диапазоне частот 2 -18ГГц уровни Рвых=150-2000мВт и коэффициенты усиления Кур=4-16дБ.
Апробация результатов исследования
Основные результаты исследований докладывались на следующих конференциях: Отраслевой семинар "Интегральные схемы на основе арсенида галлия", 27 - 29 янв.1983 г., Москва; 1999 IEEE-Russian Conference: MIA-ME’99, г. Новосибирск;
5-я Международная конференция «Актуальные проблемы Электронного приборостроения» АПЭП-2000», г. Новосибирск; 6-я Международная конференция «Радиолокация, навигация, связь», 25 - 27 апр. 2000 г., г. Воронеж; 6th International Conference APEIE-2002, г. Новосибирск; 3-я Всероссийская конференция «Нитриды галлия, индия и алюминия – структуры и приборы», Физический Факультет МГУ, 2005г., Москва; 16-я и 17-я Международные Крымские конференции «СВЧ – техника и телекоммуникационные технологии», сент. 2006 -2007гг., г. Севастополь.
Структура диссертации
Диссертация состоит из введения, трех глав, заключения, 6-ти приложений и списка цитируемой литературы. Объем работы составляет 238 страниц, 6 приложений на 51 странице, 195 рисунков, 28 таблиц.
КРАТКОЕ СОДЕРЖАНИЕ РАБОТЫ
Во введении обоснована актуальность выбранной темы, излагается предмет исследования, теоретическая значимость и практическая ценность полученных результатов, отмечены положения, выносимые на защиту.
В главе 1 излагаются разработанные автором модели ОМПЛ, СМПЛ и модель НО Ланге, предназначенные для использования в программах анализа и оптимизации МИС СВЧ на основе арсениде галлия и гибридных ИС.
1. Модель одиночной МПЛ. Формулы диссертанта для МПЛ на подложке GaAs в статическом приближении дают более точные значения ЭДП при w/h 0,1 (2-3%), чем формула H.A. Wheeler, и близкие значения ВС во всем диапазоне значений w/h. Получены формулы для расчета потерь мощности в полосках МПЛ и учтены потери в диэлектрике. Погрешность расчета суммарных потерь мощности в МПЛ на GaAs по разработанной модели в диапазоне частот до 40ГГц 15% в широком диапазоне значений w/h (рис.1), где r- относительная диэлектрическая проницаемость, tg - тангенс диэлектрических потерь, уд - удельное объемное сопротивление металла МПЛ. Данная модель точнее, чем модель W-P учитывает потери при w/h0,1. С ростом частоты параметры МПЛ становятся зависимыми от частоты (явление дисперсии). На рис.2 приведено сравнение расчетных и измеренных дисперсионных характеристик ЭДП МПЛ на подложке GaAs. На частоте 24ГГц погрешность расчета 2%. Значение ВС возрастает в диапазоне частот 1-26ГГц от 1% – для 86 Ом МПЛ до 2,3% – для 25 Ом МПЛ.
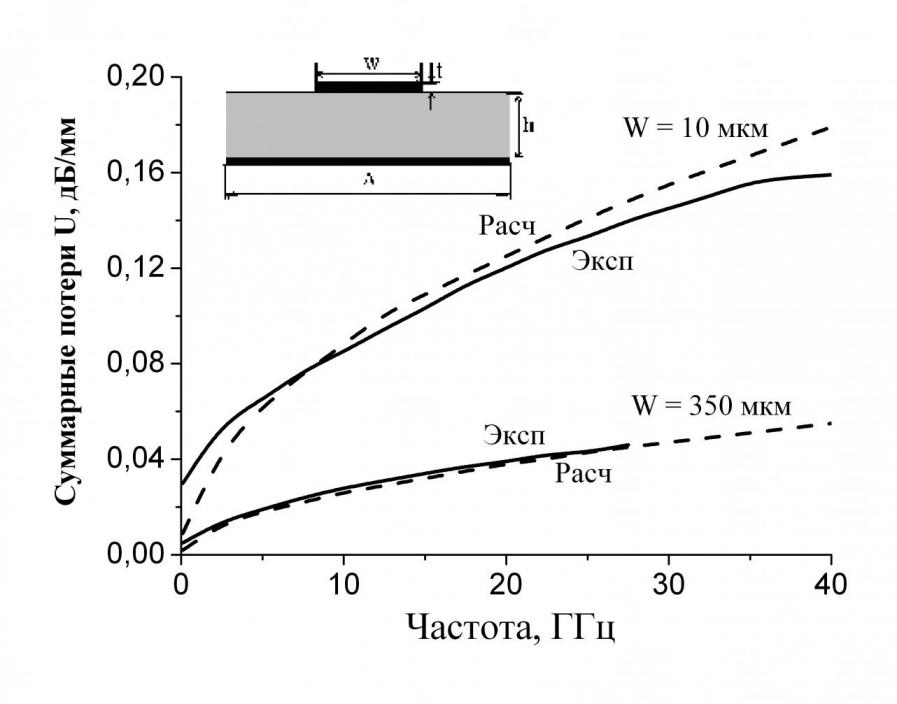
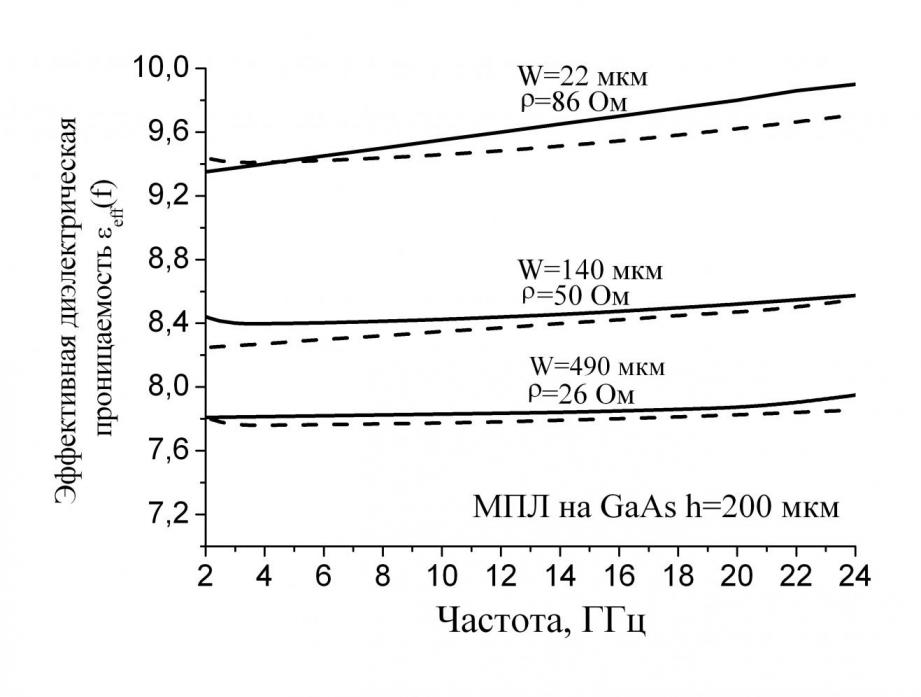
Рис.1. Сравнение расчетных и измеренных потерь СВЧ мощности в МПЛ на GaAs с h=100мкм при t=3мкм, r=12.9, tg=510-4,
уд=2.4410-5 Оммм (Au).
Рис.2. Сравнение рассчитанных по модели (штриховые линии) и измеренных (полные линии) дисперсионных характеристик ЭДП для МПЛ на подложке GaAs с h=200мкм.
2. Модель связанной двухпроводной МПЛ. ВС (Z), ЭДП и потери мощности 2х- проводной СМПЛ рассматриваются на четной (++) и нечетной (+-) модах возбуждения. Для расчета статических значений ВС и ЭДП диссертантом применен [2] подход Akhtarzad S. et al., который сводится к конформным преобразованиям геометрии СМПЛ к геометриям эквивалентных ОМПЛ на четной и нечетной модах. Однако, при расчете нечетной моды Akhtarzad S. et al. допустили неточность, которую пытались устранить введением эмпирического коэффициента в формулах. Диссертантом введена емкость взаимной связи между полосками в воздухе в случае нечетной моды и получены соотношения для погонных емкостей СМПЛ.


Рис.3. Сравнение расчетных и экспериментальных зависимостей ЭДП СМПЛ на
подложке ГИС с r=10.Рис.4. Сравнение расчетных (полные линии) и измеренных (штриховые линии) характеристик НО Ланге на GaAs с h=100мкм.
Учет толщины полосков сделан по формулам H.A. Wheeler. ВС и ЭДП определялись из погонных емкостей. Погрешность расчета по модели диссертанта составила – для Z++ 8%, а Z+- 15%. Впервые диссертантом получены формулы для расчета потерь мощности в полосках. Потери в диэлектрике определены аналогично ОМПЛ. Сравнение суммарных потерь, полученных из электродинамических расчетов R.H. Jansen и по модели диссертанта, показало отличие значений в 1.5-2.0 раза, обусловленное введением R.H. Jansen коэффициента неидеальности полосков и шероховатости подложки. С учетом исследований J. Carroll (1993) и И. Климачева (2006) это отличие объясняется превышением в 1.5-1.7 раза удельного объемного сопротивления гальванического металла по сравнению с сопротивлением металла, напыленного в вакууме. Учет дисперсии эфф(f) и Z(f) произведен по формулам ОМПЛ с заменой ВС ОМПЛ на четной и нечетной модах на Z++ /2 и 2Z+-, соответственно. На рис.3 приведено сравнение результатов расчета эфф++(f) и эфф+-(f) по модели автора и опубликованных измерений при w/h=0.3 и s/h=0.19 для СМПЛ на подложке с r=10. Максимальное отличие значений ЭДП получено при s/h >1.0 и составляет для четной моды 6%, а для нечетной 15%.
3. Модель направленного ответвителя Ланге. Диссертантом впервые разработана аналитическая модель НО Ланге с четным числом СМПЛ. При анализе НО Ланге (рис.4) сводится к эквивалентной 2-х проводной СМПЛ (ЭСМПЛ). При этом предложен новый метод определения погонных емкостей ЭСМПЛ на основе емкостей ОМПЛ и СМПЛ. Для ЭСМПЛ на четной и нечетной модах рассчитываются статические значения ВС и ЭДП, суммарные потери, дисперсионные характеристики ЭДП и ВС и S-матрица. Отличие результатов расчета и измерений 0,7дБ.
Модели ОМПЛ и СМПЛ положены диссертантом в основу расчета СВЧ спиральной индуктивности [18]. Разработанные модели вставлены в базовые элементы МИС СВЧ в программах анализа и оптимизации СВЧ схем «ДИСАПР-2» [6] и «SAPR» [13], в создании которых автор принял непосредственное участие.
В Главе 2 сделан анализ существующих ФТМ и ЭС GaAs ПТШ, выбраны ЭС интегрального и корпусного ПТШ, разработана аналитическая ФТМ субмикронного мощного ПТШ, приведено сравнение результатов расчета и измерения СВЧ характеристик ПТШ на GaAs и GaN.
1. Физико-топологическая модель субмикронного ПТШ. Результаты расчетов ПТШ с субмикронным затвором по двумерным и квазидвумерным моделям, учитывающим всплеск скорости дрейфа и нелокальные эффекты в приближении времен релаксации энергии и импульса носителей заряда (А.А. Кальфа, А.Б. Пашковский, А.С. Тагер, H.L. Grubin, W.R. Curtice, G. Ghione, C. Snowden), и результаты экспериментальных исследований показали, что на ВАХ мощных ПТШ при UсиUсн наблюдается насыщение или падение тока стока Iс. При этом, под стоковым краем затвора формируется стабильный домен сильного поля. Скорость дрейфа электронов в канале ПТШ имеет два пиковых значения Vp2,0107см/с, а в основной части затвора скорость Vs0,8107см/с (рис.5). Недостатками выше указанных моделей, ограничивающими их широкое применение в практических расчетах ПТШ и схем на его основе, являются их сложность, большие затраты машинного времени и проблемы экспериментального определения входных параметров этих моделей. Одномерные аналитические модели (A.B. Grebene, А.Б. Егудин, M.S. Shur, T. Sugeta, H. Statz et all.) основаны на кусочно-линейной зависимости скорости дрейфа электронов V(E). Канал под затвором разбивается на две части: 0<x<Lз1 и Lз1x Lз (рис.6).

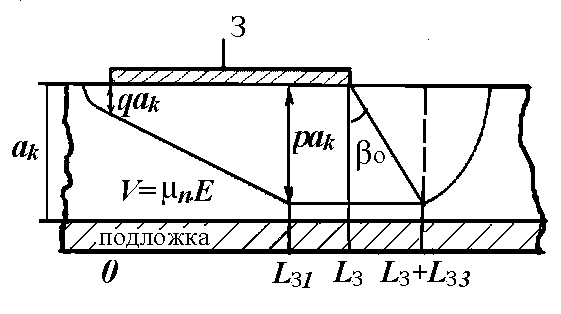

Рис.5. Аппроксимация V(E).
Рис.6. Форма ОПЗ в канале ПТШ.
Рис.7. Конструкция ПТШ.
В области I канал изменяется плавно V(x)=-nE(x) и, а в области II электроны движутся со скоростью Vs, и сечение канала постоянно. Большинство моделей не учитывает расширения стабильного домена в промежуток затвор - сток при росте Uси. В модели K. Lehovec - R.S. Miller (L-M) введена III-я область Lз x Lз+Lз3, выходящая за стоковый край затвора. При определении предельного тока затворной металлизации ПТШ, а также при расчете максимальной выходной мощности ПТШ в режиме большого сигнала необходима аналитическая модель режима прямого включения затвора. Теоретические и экспериментальные исследования этого режима в литературе отсутствуют. Общим недостатком ранее опубликованных работ является пренебрежение реальной конструкцией ПТШ (рис.7) и некорректный учет режимных зависимостей сопротивлений истока и стока, что приводит к большим погрешностям в расчете ВАХ и СВЧ параметров ПТШ.
А. Разработка модели GaAs ПТШ в режиме управления тока ОПЗ БШ. Конфигурация обедненной области в канале принята в виде, показанном на рис.6. При расчете ПТШ в режиме Uотс<Uзи k (высота БШ) и Uси>0В диссертантом [4,11] взята за основу модель L-M. При описании процессов в канале ПТШ приняты следующие допущения: 1) в ОПЗ БШ отсутствуют подвижные носители заряда, имеется резкий переход между этой области и каналом; 2) в переносе тока участвуют только электроны, профиль концентрации легирования равномерный; 3) в наклонной и пологой частях ВАХ (при /Е(x)/<Es, область I) V(x)=-nE(x), а в пологой части ВАХ V(x)=Vs при /Е(x)/ >Es, области II-III); 4) на границе областей I и II (x=Lз1) V(x) изменяется скачком от Vp=nEs до Vs и 5) при Uси Uсн под стоковым краем затвора формируется стабильный домен сильного поля, который с ростом Uси расширяется под затвор и в промежуток затвор - сток (области II и III). Для наклонной и пологой частей ВАХ численными методами решаются две системы нелинейных уравнений с учетом Rи и Rс, зависящих от конструкции ПТШ и режима смещения.
Б. Разработка модели GaAs ПТШ в режиме прямого включения затвора. При Uзи к БШ приоткрывается, и ОПЗ под затвором исчезает. Ток пробоя между затвором и стоком отсутствует (Iзс=0). В разработанной модели [11] учтен механизм термоэлектронной эмиссии из электрода затвора. Получены для наклонной и пологой частей ВАХ системы нелинейных уравнений, которые решаются численными методами и включают напряжение в канале Uси с учетом Rи и Rc и токи затвора и стока, для которых получены соответствующие выражения. Исследованы распределения Eк(x), Uк(x) и Iк(x) в канале ПТШ.
В. Режим запирания канала. Iс=0, и явление пробоя в канале не учитывается.
Во всех режимах работы ПТШ при расчете ВАХ учтены режимные зависимости Rи и Rс и реальная конструкция канала ПТШ (7 типов).
Г. Проверка ФТМ ПТШ. Проверка ФТМ выполнена на примере GaAs ПТШ с затвором 0,650мкм. Рассчитанные по ФТМ ВАХ приведены на рис.8.
Стоковые ВАХ: При Uзи 0,7В (управление тока ОПЗ) расчетные стоковые ВАХ отображают результаты измерений с достаточной точностью. При Uзи>0,7В (прямое включение БШ) присутствует область, где ток стока и крутизна ПТШ отрицательные. В расчетных ВАХ при Uзи>1В кривые резко переходят в режим насыщения и постоянны, что обусловлено предположением E(x)=const при /E(x)/Es.
Затворные ВАХ: При Uзи1В расчетные ВАХ адекватно отображают результаты измерения.
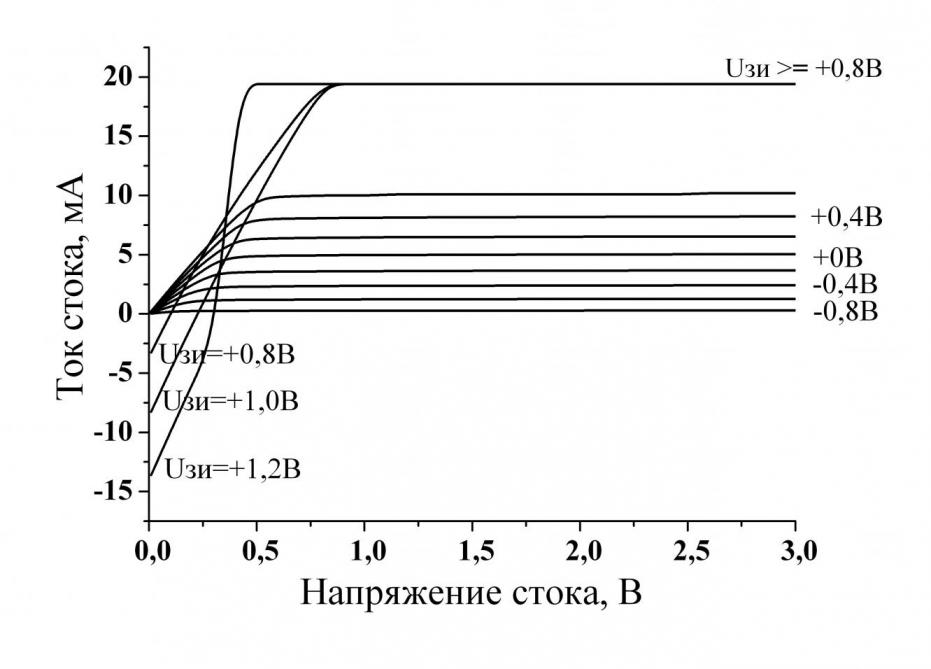
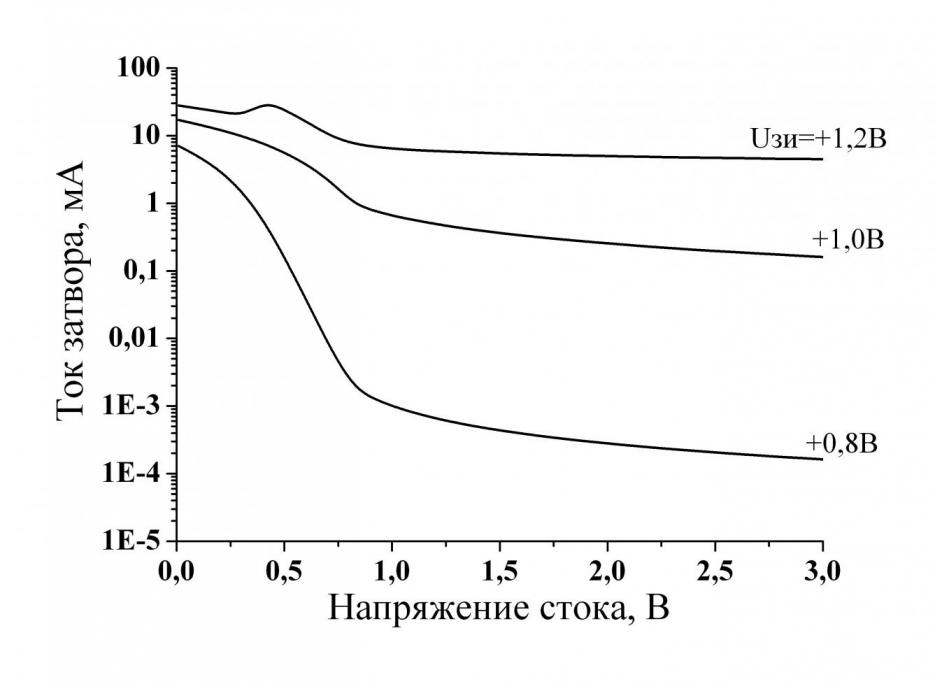
Рис.8. Рассчитанные по ФТМ диссертанта стоковые и затворные ВАХПТШ с затвором 0,650мкм.
При Uзи=0,8В расчетное значение Iз примерно на два порядка ниже измеренного значения, что обусловлено: 1) учетом только одного механизма эмиссии БШ, 2) пренебрежением током утечки в межслойном диэлектрике SiO2 в обоих режимах и 3) ограничением установки по точности измерения малых токов (10-8А).
2. Электрическая эквивалентная схема. На рис.9 представлена эквивалентная схема интегрального ПТШ, взятая за основу при расчете S-параметров ПТШ и выходных параметров однокаскадного СВЧ усилителя на его основе [3] (Приложение 1). Диссертант использовал теоретический метод определения элементов ЭС ПТШ: на основе выражений для распределения напряжения и тока в канале и урав- нений ВАХ во всех режимах работы ПТШ получены формулы для всех элементов ЭС ПТШ, зависящих от режима смещения. Также рассчитываются «холодные» емкости между электродами и индуктивности проволочек разварки. Емкости корпуса определяются экспериментально. Экспериментальный метод определения значений ЭС ПТШ, основанный на применении измеренных S-параметров, реализован в разработанной автором программе «EKVIV» и использован при проектировании квази- МИС УМ.
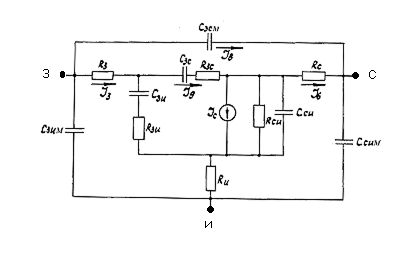
Рис 9. Эквивалентная схема интегрального ПТШ.
3. Особенности моделирования СВЧ мощного многоштыревого ПТШ. Сосредоточенная ЭС ПТШ может адекватно описывать ПТШ в диапазоне частот до 60ГГц при соответствующем учете распределенных эффектов многоштыревой конструкции. В ФТМ рассчитываются эффективные значения Rи и Rс для 2-х конструкций: при запитывании электродов затвора, истока и
стока – с одной и с двух сторон, а также, паразитные емкости конструкции - ПТШ с учетом контактных площадок и перекрытия соединительных шин по межуровневой изоляции – для прямого и перевернутого монтажа кристалла. С ростом температуры в канале ПТШ уменьшаются ток стока, крутизна, выходное сопротивление, коэффициент усиления и выходная мощность. Температура среды также сильно влияет на параметры ПТШ и схем на его основе. При моделировании температурных эффектов автором впервые в аналитической ФТМ учтены температурные зависимости параметров GaAs и БШ. Подход позволяет прогнозировать необходимый ПТШ и его параметры в диапазоне температур 150-600°K.
4. Сравнение результатов расчета и измерения мощного СВЧ ПТШ. ВАХ и зависимости элементов ЭС ПТШ от смещения рассмотрены на примере ПТШ с затвором 1,7600мкм, с концентрацией легирования канала Nk=7,51016см-3, измеренного H.A. Rausher et all. Кристалл ПТШ посажен в кристаллодержатель прямым монтажом. Расчет по модели достоверно отображает измеренные ВАХ (рис.10). Отличие на 30% значений внутренней крутизны ПТШ, определенных из измеренных S-параметров при предположении неизменных Rи и Rc, и значений, рассчитанных по модели, обусловлено учетом в модели режимных зависимостей Rи и Rc и не приводит к различию соответствующих значений внешней крутизны, определяемой из ВАХ. Модель завышает значения Rси в 1,3-3,5раза – в наклонной и в 5-12,5 раза – в пологой частях ВАХ, что вызвано принятой идеальной развязкой канала и буфера.
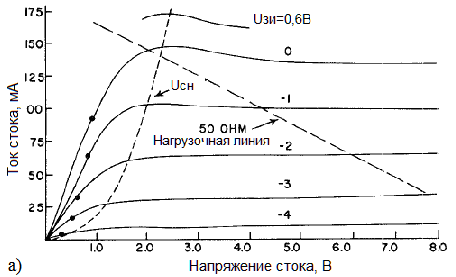
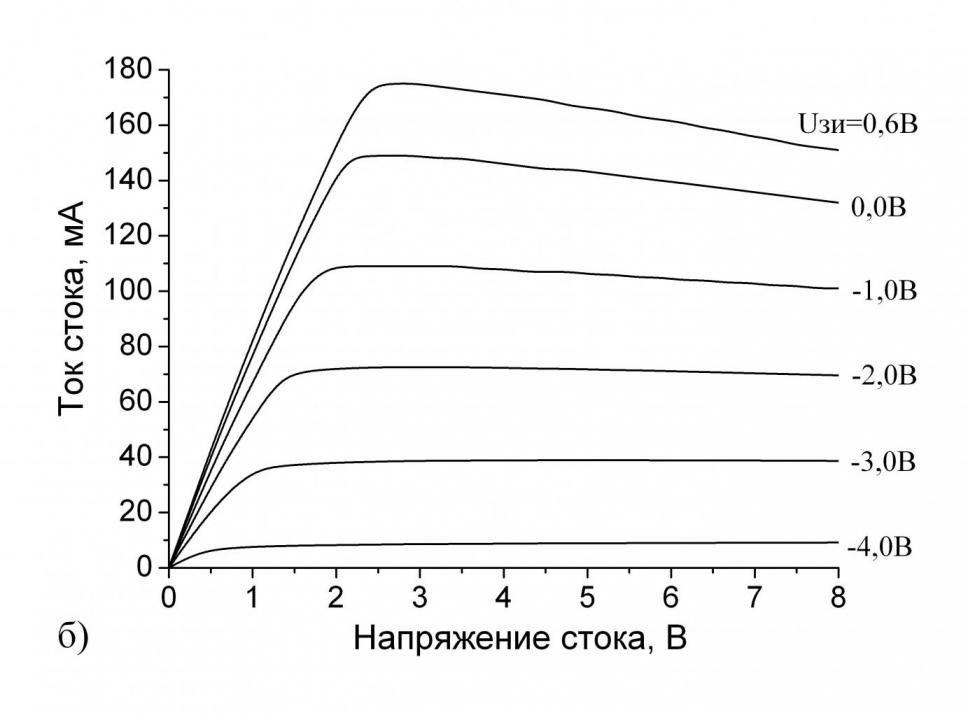
Рис. 10. Сравнение измеренных а) и расчетных б) ВАХ ПТШ Lз=1,7мкм и Lзш=600мкм.
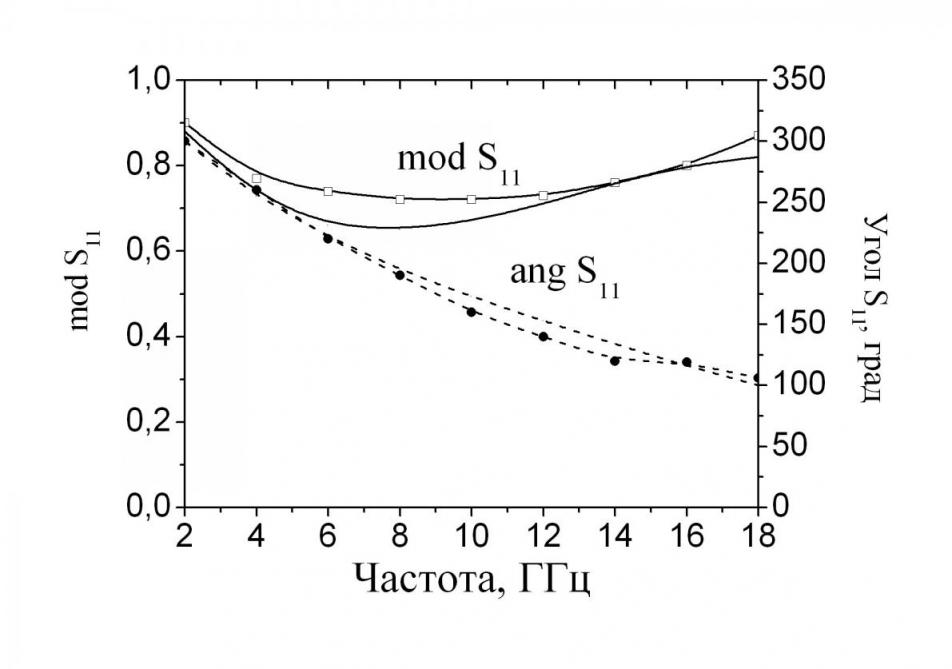
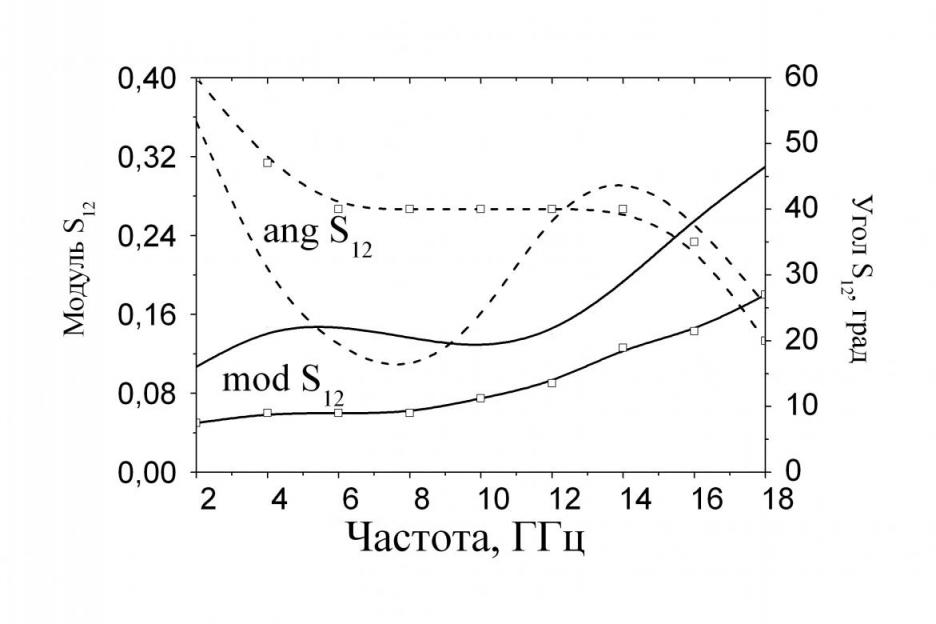
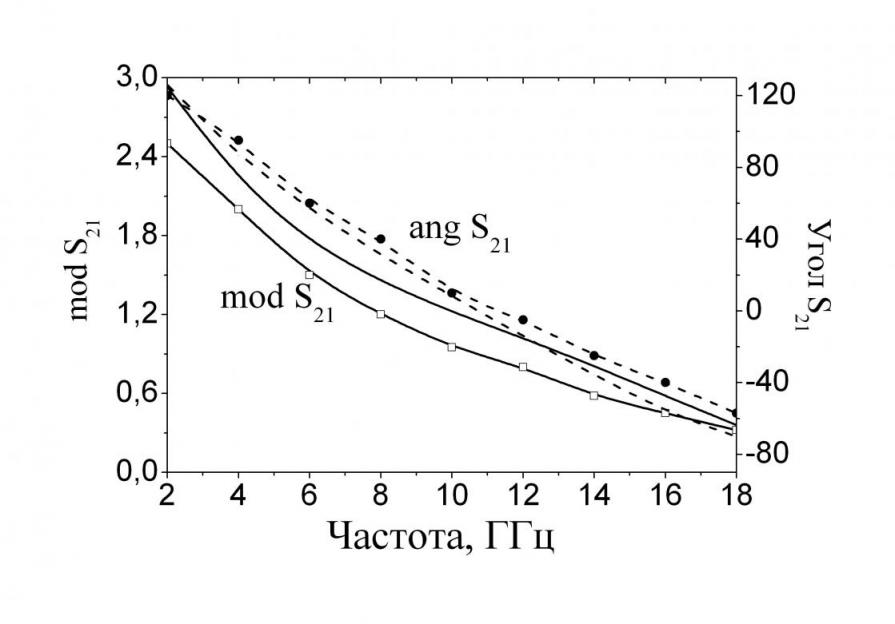
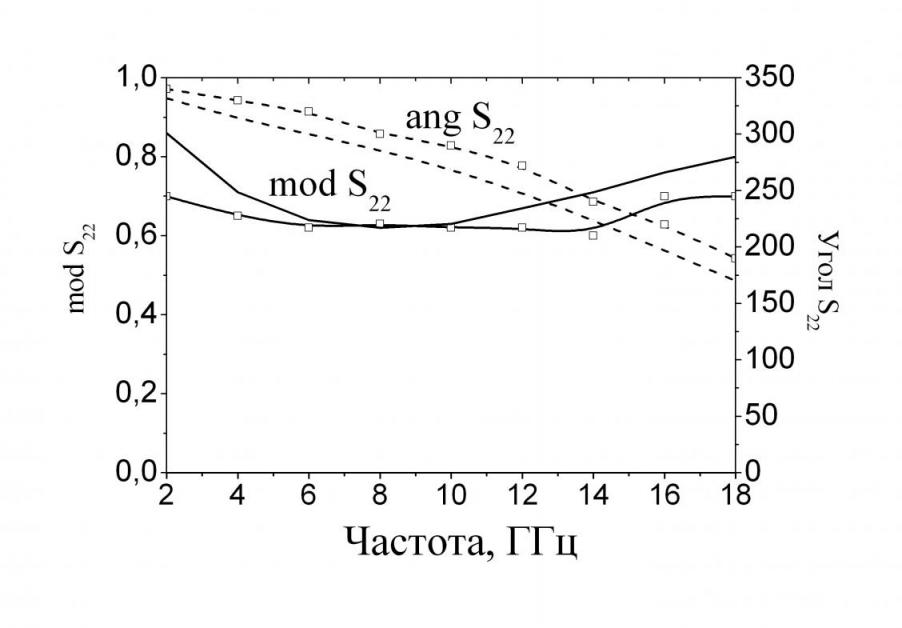
Рис. 11. Сравнение результатов измерения H.A. Rausher et all. (линии, отмеченными точками) и расчета по ФТМ диссертанта S-параметров 600мкм GaAs ПТШ (Uзи=-2В и Uси=6В).
Полученные режимные зависимости элементов ЭС ПТШ подтверждаются работами других авторов. Сравнение измеренных и рассчитанных по ФТМ с учетом саморазогрева канала S-параметров 600мкм ПТШ (рис.11) показывает адекватность модели в диапазоне частот до 18ГГц. Расчеты показали, что влияние Rси на S-параметры ПТШ не существенно в диапазоне частот выше 3ГГц. Также, теоретически и экспериментально исследованы характеристики GaAs ПТШ с затвором 0,61200мкм и Nk=2,81017см-3, посаженного перевернутым монтажом на микрочип GaAs с 50Ом МПЛ и заземляющими отверстиями. Модель отображает экспериментально наблюдаемую степень влияния длины затвора и температуры среды (200 - 400°K) на СВЧ характеристики ПТШ.
В Главе 3 изложены результаты разработки мощных ПТ с применением технологии МЛЭ и разработанной диссертантом методики измерения и обработки профилей концентрации доноров и подвижности электронов [15] (Приложение 2) и методов измерения параметров барьерного и омического контактов (Приложения 3 и 4). Разработанные мощные GaAs ПТШ и ГСПТ применены в квази-МИС УМ диапазона частот 2-18ГГц.
А) GaAs ПТШ на МЛЭ структурах «аналог-САГМК». При изготовлении мощных СВЧ интегральных ПТШ и МИС на GaAs использование промышленно выпускаемых структур n+-n-i GaAs «САГМК» (НПП «Элма») постоянно ставило перед разработчиком проблему выяснения причины несоответствия отличных ВАХ ПТШ, изготовленных на этих структурах, и часто получаемых плохих СВЧ параметров в диапазоне частот 8-18ГГц. Проведенное диссертантом исследование профилей концентрации выборки в 40 пластин показало наличие практически во всех структурах пиков концентрации носителей заряда в буфере структуры (i-слой GaAs) до (0.7-10)1015см-3 на “кажущейся” глубине от границы с затвором в диапазоне 0.5-6,5мкм. В процессе изготовления и анализа статических и динамических параметров ПТШ на свыше 200 пластинах, выращенных на двух различных установках МЛЭ (ИФП СОРАН) и МОС-гидридной эпитаксии (НПП «Элма»), выяснена корреляция положения пиков концентрации в буфере/подложке с уровнем СВЧ параметров ПТШ: чем дальше расположение первого пика от поверхности затвора, тем выше Кур и Руд (=Рвых/Wтр).
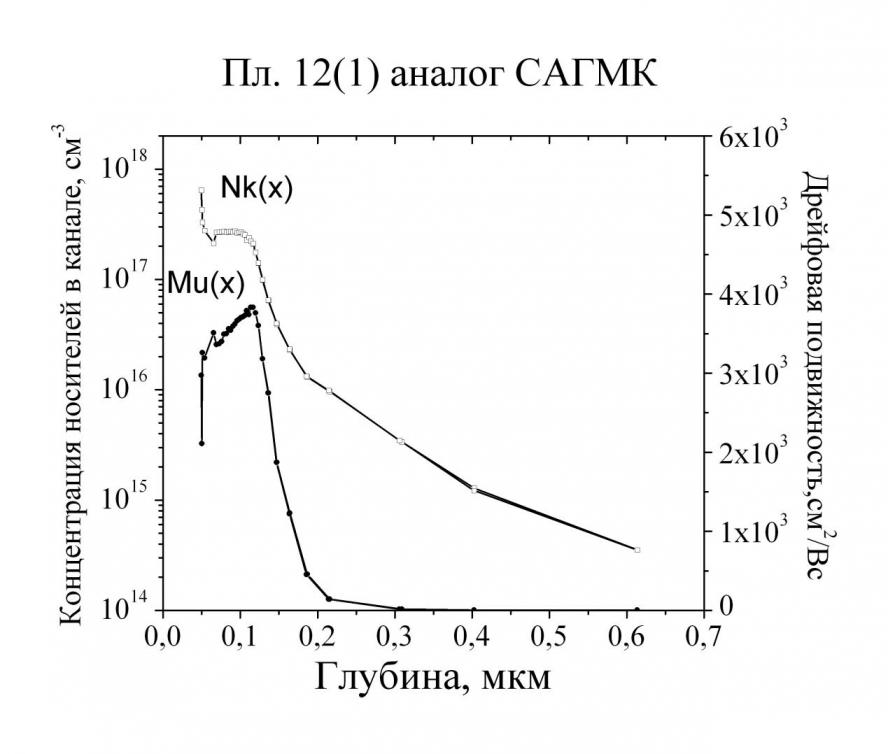
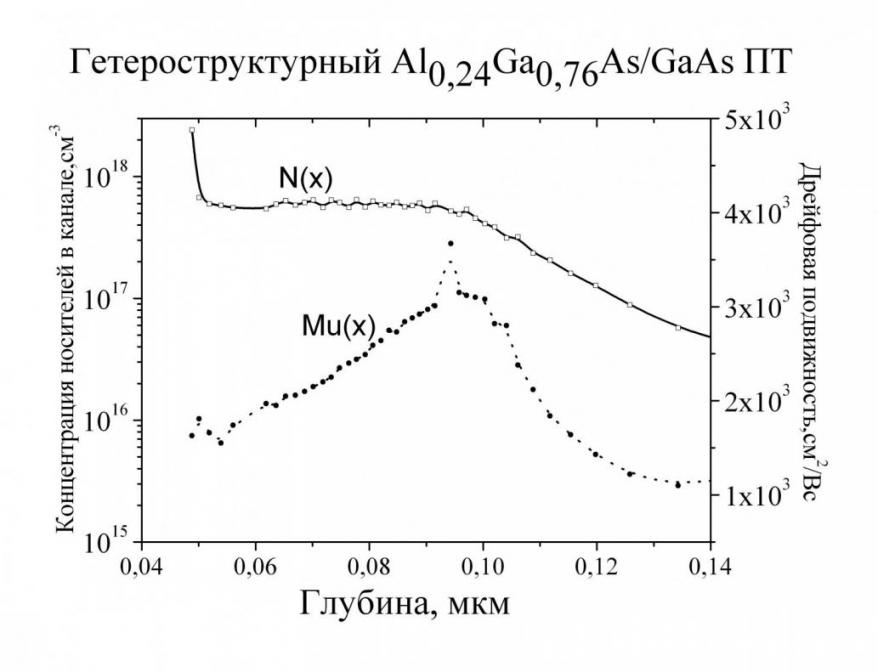
Рис. 12. Профили концентрации носителей и подвижности в структуре «аналог-САГМК».
Рис. 13. Профили концентрации носителей и подвижности в гетероструктуре AlGaAs/GaAs.
В связи с плохим качеством промышленных эпитаксиальных структур разработана структура «аналог-САГМК» с применением метода МЛЭ [12]. На этих пластинах при статических параметрах ПТШ, сопоставимых с параметрами ПТШ на структурах «САГМК», получены более высокие динамические СВЧ параметры, измеренные на зондовой установке «Поляна».На частоте 17,7ГГц получены (Wтр=300мкм) Рнас=0.7-0,8Вт/мм, КПДд=38% и малосигнальный коэффициент усиления Курмс=5,0-6,5дБ. Улучшение СВЧ параметров ПТШ обусловлено, прежде всего, введением сверхрешетки (СР) AlAs/GaAs в буфер структуры и повышением подвижности в канале ПТШ на структурах, выращенных МЛЭ, с 3200см2/Вс (Элма) до 3800см2/Вс (ИФП СО РАН) (рис.12).
GaAs ПТШ с однородно легированным каналом достигли уровня возможной физической реализации. Дальнейшее повышение параметров ПТ реализовано введением ступенчатого профиля легирования структуры (под затвором – низкий, а в канале – высокий) и применением под затвором широкозонных материалов (AlyGa1-yAs и AlyGa1-yN) с низкой концентрацией фоновых примесей, а в канале – узкозонных (InyGa1-yAs, GaAs или GaN) с высокой подвижностью электронов [7-9, 14-17].
Б) Гетероструктурный AlGaAs/GaAs ПТ. Диссертантом предложена гетероструктура n+GaAs-iAl0.24Ga0.76As/nCaAs-iGaAs для ГСПТ (HFET). Профили концентрации носителей в канале и дрейфовой подвижности электронов показаны на рис.13. Раздельное размещение доноров Si в канале и атомов Al позволяет снизить вероятность возникновения DX-центров в слое iAlyGa1-yAs, что при уровне легирования канала Nk=(5-6)1017см-3 обеспечивает n=3200-3750см2/Вс. Квантовая яма гетероперехода удерживает носители в канале и, таким образом, уменьшает токи утечки в подложку и в затвор, причем глубина ее возрастает с ростом количества Al. В буфер ГС включена СР. ВАХ ГСПТ с затвором 0.6900мкм имели следующие статические параметры: Iсмах=550 -650мА/мм, Stмах=117-138мСм/мм и Uпрзс20В. На частоте 12ГГц получены следующие динамические параметры: Курмс=8,5дБ, Рудmax= 1,2Вт/мм и КПДд=47,4%.
| n+ GaAs Si: 61018 см-3 | 400А |
| i – GaAs спейсер | 50А |
| i - Al0.38Ga0.62As псевдодиэлектрик | 350А |
| n+ In0.2 Ga0.8As канал Si: 41019 см-3 | 190А |
| i – GaAs 1-й буфер | 100А |
| i - Al0.38Ga0.62As 2-й буфер | 1000А |
| i - GaAs 3-й буфер | 1000А |
| СР (AlAs/GaAs) 20 пер. | 790А |
| i - GaAs 400 С | 0,1мкм |
| АГЧП-10 подложка | 400 мкм |
На частоте 17,7ГГц получены Курмс= 5,2дБ, Руд=0,87Вт/мм и КПДд=44%. Применение ГСПТ этого типа с Wт=2,4мм и каналом с Nk=2,81017см-3 и толщиной 1000°А в квази-МИС УМ диапазона C, разработанной диссертантом, увеличило Рвых с кристалла УМ с 1,8 до 2,9 Вт.
Рис.14. Структура псевдоморфного ГСПТ.
В) Мощный псевдоморфный ГСПТ с легированным каналом. В ГСПТ на структуре Al0.38Ga0.62As/InxGa1-xAs/ GaAs - Al0.38Ga0.62As вместо квантовой ямы в GaAs используется сильно легированная квантовая яма в псевдоморфном слое InxGa1-xAs (рис.14). Слои между каналом n-InGaAs и подложкой формируют сложный буфер со СР, повышают Rвых и устраняют обратное управление по подложке ПТ. Интегральные псевдоморфные ГСПТ с затвором 0,6450мкм с концентрацией носителей в квантовой яме (0,6-1,0)1019см-3 использованы в квази-МИС УМ с распределенным усилением [14]. При Рвх=150мВт, Uси=7-8В получены следующие параметры УМ в диапазоне частот 1.8-16ГГц: Рвых=250-375мВт, КПДд=12-17%.
В Заключении излагаются выводы, представленные в диссертации, и сделана авторская оценка выполненной работы.
В Приложении 1 приведены формулы для расчета характеристик ПТШ и усилителя на его основе с применением S-параметров ПТШ, заложенные в программу «POLEVM». На фиксированной частоте рассчитываются коэффициент устойчивости, области устойчивости в плоскостях коэффициентов отражения нагрузок по входу и выходу ПТШ на диаграмме Смита, вид и возможность согласования ПТШ, максимальный коэффициент усиления, минимальные Kстv на входе и выходе усилительного каскада и импедансы цепей согласования.
В Приложении 2 отмечается, что при использовании стандартных C-V методов измерение емкости диода начинается при Uзи=0В, когда потенциал БШ к создает область обеднения, которая в сверхтонких структурах не позволяет прописывать профили легирования (ПЛ) в активных слоях. Излагается метод обработки C-V - измерений тестовых структур, как при 0<Uзиk, так и при Uзи0В с использованием сосредоточенной (СМ) и распределенной (РМ) моделей БШ (рис.15). Рассмотрение распределенной Rud-Gud-Cud схемы (Gud, -погонная проводимость утечки БШ) структуры с прямоугольным контактом WTLз в литературе отсутствует. В диссертации и в [15] впервые представлен вывод соотношений, связывающих Gm и Cm с Rud, Gud, Cudю. Для измерения дрейфовой подвижности электронов использовалась тестовая структура «толстого» ПТШ с длиной и шириной затвора Lз=100мкм и WT=400мкм. Алгоритм метода реализован в программе «PROFIL».
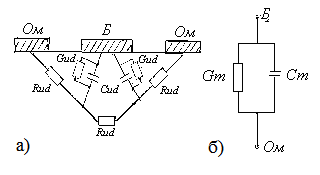
Рис.15. Эквивалентные схемы тестовой структуры: а) разработанная распределенная модель и б) измерительная схема.В Приложении 3 приведено определение параметров БШ Ti/Au-GaAs (встроенного напряжения БШ к, коэффициента идеальности) на основе измерения ВАХ ПТШ, включенного по схеме диода при прямом включении БШ, и C-V измерений. Дано объяснение отличия значений к, полученных по этим методам.
В Приложении 4 изложена разработка нового метода определения удельного сопротивления омического контакта ПТШ с, учитывающего разницу слоевого сопротивления между контактами и под самим контактом. Показано, что по стандартному методу (при равенстве слоевых сопротивлений) получаются заниженные значения с.
В Приложении 5 изложен разработанный диссертантом в [5] метод упрощенных тепловых эквивалентов (УТЭ) для расчета теплового сопротивления (RT) транзистора и элементов ГИС и МИС СВЧ. Конструкции МИС и ГИС с точки зрения задачи отвода тепла, представляют собой многослойную пластину, на верхней грани которой расположены источники тепла (резисторы или многоштыревой ПТШ). Рассмотрен расчет RT бесконечной однородной изотропной пластины толщиной с прямоугольным источником тепла. Получены новые формулы для расчета RT и размеров растекания тепла на выходе из пластины, рассмотрены случаи ограничения бесконечной пластины по сторонам источника, что позволяет учитывать границы микросборок (кристаллов ПТ) и взаимодействие источников тепла (штырей затвора). Расчет RT многослойной пластины выполняется строя УТЭ последовательно в каждом слое. Погрешность метода расчета RT 20%.
В Приложении 6 представлены результаты использования диссертантом разработанных моделей ОМПЛ, СМПЛ, НО Ланге и ПТШ в НИР и ОКР при разработке квази-МИС балансных усилителей мощности на GaAs в диапазоне частот 2-18ГГц.
1. Усилитель X диапазона с выходной мощностью 0,4Вт. На рис.16 представлена конструкция в виде кристальной микросборки «чипы на микрочипе» квази-МИС балансного УМ с Рвых=0,4Вт и Кур=14-16дБ в диапазоне частот 9-12ГГц [13]. Чипы содержат ПТШ с Lз=0.7мкм. Макрочипы, содержащие цепи согласования и подачи смещения, изготовлены по монолитной технологии на подложке АГЧП-2. Конденсаторы МДМ выполнены на Ta2O5. Размеры макрочипа 1.62.9мм2. Заземление
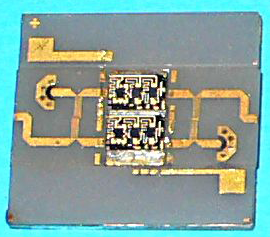
Рис.16. Конструкция квази-МИС балансного УМ диапазона частот
9-12ГГц. Размеры УМ 15164мм3.
нижних обкладок конденсаторов и площадок истоков ПТШ выполнено металлизированными сквозными отверстиями в подложке. Соединение чипов ПТШ и макрочипа выполнено методом перевернутого монтажа. УМ выполнен по 3-х каскадной схеме: в 1-м каскаде применен300мкм ПТШ, во 2-м – 600мкм ПТШ и в 3-м – выполнено сложение мощности с 2-х 800мкм ПТШ.
2. Усилитель диапазона частот 12-18ГГц с выходной мощностью 100 мВт. Конструкция квази-МИС балансного УМ аналогична
предыдущей конструкции. Кристальные микросборки представляют собой 2-х каскадный УМ: в 1-м каскаде использован один, а во втором – два чипа ПТШ с затвором 0,8300мкм. Конденсаторы МДМ Выполнены на пленке SiO2. В расчете малосигнальных характеристик балансного УМ использована ЭС ПТШ, определенная из измеренных S-параметров. Оценка по программе «SAPR» Рвых с кристалла УМ по ВАХ и с ЭС ПТШ, определенной по программе «WAXNEW», составляет 70-120мВт в диапазоне частот 12-14,5ГГц и 110-220мВт в диапазоне частот 14,5-19ГГц (рис.17). При учете потерь на суммирование Рвых(15%) с двух кристаллов УМ максимальное расчетное значение Рвых балансного УМ составит 123 - 204мВт в диапазоне частот 12-14,5ГГц и 187-374мВт в диапазоне частот 14,5-19ГГц. При входной мощности Рвх=50мВт измеренное значение Рвых образцов балансных УМ составило 120-230мВт в диапазоне частот 12-14,5ГГц и 220-320мВт в диапазоне частот 14,5-18ГГц (рис.18).
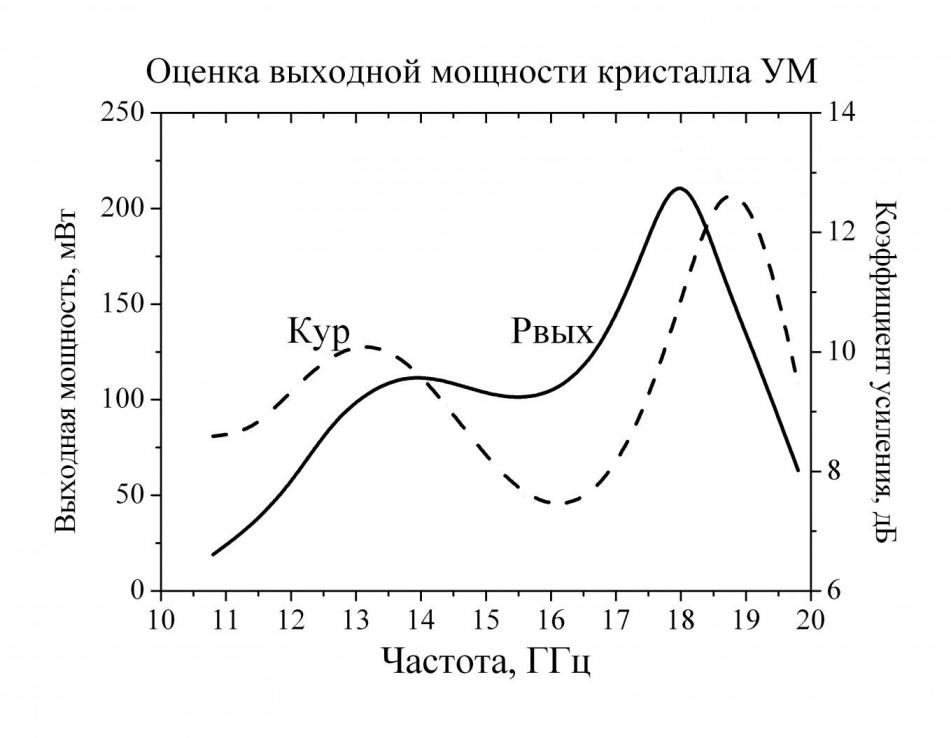
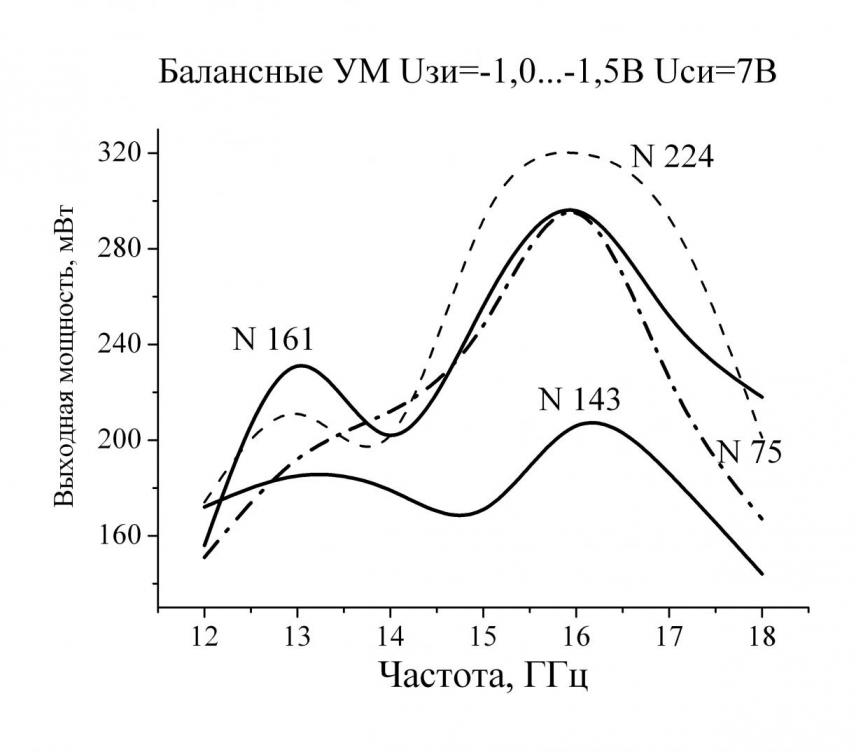
Рис.17. Оценочный расчет Рвых и Кур кристалла УМ в полосе частот при Uзи=-1В, Uси=7В. ВАХ
и ЭС ПТШ определены по ФТМ.
Рис. 18. Измеренная выходная мощность
балансного УМ при Рвх=50мВт в диапазоне
частот 12-18ГГц.
Максимальное измеренное значение Рвых образцов составило 150-280мВт в диапазоне частот 12-14,5ГГц и 275-416мВт в диапазоне частот 14,5-19ГГц, то есть, значения, близкие к полученным с применением ФТМ ПТШ расчетным значениям.
3. Гибридно-монолитный усилитель диапазона частот 8-18ГГц. 2х-ват-тный УМ состоит из 4 блоков: двух подобранных по СВЧ параметрам 2 каскадных балансных УМ и двух НО Ланге [12]. УМ обеспечил в диапазоне частот 8-18ГГц: Кур=8,0-5,7дБ, КCTV входа и выхода УМ 2,5; при Рвх=350мВт в диапазоне частот 8-11ГГц получена Рвых=2,0-2,2Вт и в диапазоне частот 11-18ГГц – Рвых=2,0-1,3Вт.
ЗАКЛЮЧЕНИЕ
1) Разработаны модели ОМПЛ и СМПЛ, НО Ланге на GaAs и подложках ГИС СВЧ, которые позволяют адекватно рассчитывать характеристики СВЧ устройств в диапазоне частот до 18ГГц;
2) Разработана аналитическая ФТМ мощного СВЧ субмикронного ПТШ, которая позволяет рассчитать ВАХ и элементы СВЧ малосигнальной эквивалентной схемы в режимах управления тока канала ОПЗ БШ, прямого включения БШ и запирания канала – при прямом и обратном монтаже кристалла. Впервые в аналитической модели ПТШ учитывается реальная конструкция ПТШ, саморазогрев канала токами стока и затвора и рассчитаны характеристики ПТШ в диапазоне температур окружающей среды.
3) Впервые в России разработаны и применены в квази-МИС УМ диапазона частот 2-18ГГц мощные ПТШ на структуре «аналог-САГМК» и ГСПТ на гетероструктурах AlGaAs/GaAs (HFET) и AlGaAs/InGaAs/GaAs-AlGaAs (PHEMT), обеспечивающие удельную Рвых=0,8-1,2Вт/мм, соответствующую зарубежному уровню.
4) На основе разработанных моделей GaAs ПТШ и МПЛ с использованием балансного сложения мощности кристаллов УМ с помощью НО Ланге разработан унифицированный ряд квази-МИС УМ на GaAs в диапазоне частот 2-18ГГц с уровнями выходной мощности 150-2000мВт и коэффициентами усиления 4-16дБ.
Результаты, полученные в работе, рекомендуется использовать при дальнейших исследованиях физики и технологии ПТШ и ГСПТ, схемотехники и технологии МИС СВЧ на GaAs и других материалах AIIIBV. Разработанную методику измерения профилей легирования и подвижности электронов рекомендуется использовать в производстве эпитаксиальных гетероструктур.
Основное содержание диссертации опубликовано в следующих статьях:
1. Раков Ю.Н. Модель микрополосковой линии в диапазоне СВЧ //Научный вестник НГТУ. – 2007. – № 1. – С. 47 - 58.
2. Раков Ю.Н. Модели двухпроводных микрополосковых линий и направленных ответвителей Ланге //Электронная техника. – Сер. СВЧ-техника. – 1992. – Вып. 1 – С. 11 – 18.
3. Раков Ю.Н., Цаплин Г. И., Шашкевич И.А. Программа расчета динамических характеристик полевых транзисторов СВЧ, работающих в линейном режиме //Электронная техника. – Сер.1. Электроника СВЧ. – 1983. – Вып. 3. – С. 67 – 68.
4. Раков Ю.Н., Зедгенизов В.Д. Программа расчета семейства вольтамперных характеристик полевого транзистора с барьером Шоттки на арсениде галлия //Электронная техника. – Сер.1. Электроника СВЧ. – 1983. – Вып. 5. – С. 58 – 59.
5. Раков Ю.Н. Инженерный метод расчета тепловых сопротивлений мощных транзисторов и элементов интегральных схем //Электронная техника. – Сер. 1 Электроника СВЧ. –1983.– Вып. 11.
– С. 17 – 23.
6. Гуляев В.И., Раков Ю.Н., Скрипникова А.Ф. Система автоматизированного проектирования СВЧ-устройств в диалоговом режиме <<ДИСАПР-2>> // Электронная техника. – Сер. Электроника СВЧ. – 1990. – Вып. 9. – С. 66 - 67.
7. Журавлев К.С., Торопов А.И., Шамирзаев Т.С., Бакаров А.К., Раков Ю.Н., Мякишев Ю.Б. Применение высокочистых слоев AlxGa1-xAs в эпитаксиальных структурах мощных полевых СВЧ транзисторов //Письма в ЖТФ.–1999. –Т. 25. – Вып. 15.– С. 8 -14.
8. Раков Ю.Н., Мякишев Ю.Б., Журавлев К С., Торопов А.И., Шамирзаев Т.С., Бакаров А.К. Применение высокочистых слоев AlxGa1-xAs в структурах мощных СВЧ полевых транзисторов //Электронная техника. – Сер.1. СВЧ – Техника. – 2001. – Вып. 2 – C. 51.
9. Шамирзаев Т.С., Торопов А.И., Бакаров А.К., Журавлев К.С., Раков Ю.Н., Мякишев Ю. Б. Получение твердых растворов AlxGa1-xAs и эпитаксиальных структур для мощных полевых СВЧ-транзисторов //Автометрия. – 2001. – № 3. – С. 89 – 96.
10. Zhuravlev K.S., Kolosanov V.A., Milekhin A.G., Polovinkin V.G., Shamirsaev T.S., Rakov Yu.N., Myakishev Yu.B., Fryar J., McGlynn E., Henry M.O., Infrared light emission from GaAs MESFETs operating at avalanche breakdown condition //Semicond. Sci. Technology.–2004. – Vol. 19. – P. s94 – s95. 11. Раков Ю.Н., Шагабутдинов А.А., Данилов В.С. Расчет ВАХ полевого транзистора с барьером Шоттки на арсениде галлия в режимах управления тока канала ОПЗ и прямого включения затвора
//Доклады АН ВШ РФ. – 2006. – № 1. – С. 93 – 104.
12. Мякишев Ю.Б., Будаков В.Г., Раков Ю.Н., Зыкова Г.С. Состояние и перспективы развития в ОАО “Октава” мощных усилителей диапазона 8-18ГГц на основе монолитных ИС СВЧ//Радиопро-мышленность. – 2004. – Вып. 2. – С. 112 – 122.
13. Rakov Yu.N. 0.4 Watt X-Band Quasimonolithic Amplifier-Design, Results, Comparative Analysis of Simulating Methods //1999 IEEE-Rassian Conf.: MIA-ME’99. – P. I.21 – I.25.
14. Мякишев Ю.Б., Раков Ю.Н., Аксенов Б.Н. Мощные СВЧ гетероструктурные полевые транзисторы //6 Международная научно - техническая конференция “Радиолокация, навигация, связь” – С. 2030 – 2035. – Воронеж, 25 - 27 апр. 2000 г.
15. Раков Ю.Н., Данилов В.С. Метод определения профиля легирования структур ПТШ со сверхтонкими слоями // 5-я Международной конференции «Актуальные проблемы Электронного приборостроения» АПЭП-2000. –Т.4.–Новосибирск. 2000.– С. 231– 236.
16. Zhuravlev K.S., Toropov A.I., Shamirzaev T.S., Bakarov A.K., Rakov Yu.N., Myakishev Yu.B. High purity AlGaAs grow by molecular beam epitaxy //1999 IEEE-Rassian Conf.:MIA-ME’99.
17. Журавлев К.С., Мансуров В.Г., Преображенский Е.В., Галицын Ю.Г., Овсюк В.Н., Раков Ю.Н., Бондарева Т.К., Мончарес Н.В., Мякишев Ю.Б. Полевой транзистор на основе гетероструктуры GaN/Al0,2Ga0,8N, выращенный методом МЛЭ на подложке (0001) Al2O3 из молекулярных пучков Ga, Al и NH3 // III Всероссийская Конференция «Нитриды галлия, индия и алюминия – структуры и приборы». Тезисы докладов. – Физический Факультет МГУ.– М., 2005. – С. 105 – 106.
18. Раков Ю.Н., Данилов В С. СВЧ модель спиральной индуктивности на основе решетки связанных линий //6th International Conference APEIE-2002. – С. 171 – 175.
19. Зыкова Г.С., Мякишев Ю.Б., Раков Ю.Н., Цибаев В.П., Будаков В.Г. Широкополосный двухкаскадный усилитель мощности диапазона 8 – 18ГГц на арсениде галлия //16 –я Международная Крымская конференция. СВЧ – техника и телекоммуникационные технологии. Материалы конференции. 11-15сент. 2006г. Севастополь, 2006. – С. 187– 188.
20. Раков. Ю.Н., Торопов А.И. Мякишев Ю.Б., Журавлев К.С., Цибаев В.П. Мощные псевдоморфные гетероструктурные полевые транзисторы с легированным каналом. 17–я Международная Крымская конференция. СВЧ – техника и телекоммуникационные технологии. Материалы конференции. 10-14сент. 2007г. Севастополь, 2007.– С. 554 – 555.

